[分析]力抗三星 台積電晶圓、封測一手抓
作者\歐敏銓
為抗拒三星和Intel跨足晶圓代工的競爭,以及從三星手上搶下蘋果處理器(A7)的訂單,台積電近年來跨業整合的策略明確,從入股Mapper、ASML等半導體設備商,轉投資創意電子,擴大晶圓代工事業,到佈建逾400人的封測團隊,不斷出手進行一條龍事業體的布局。
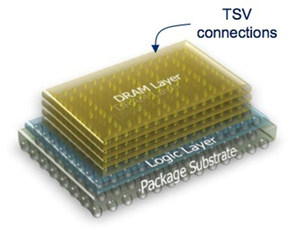 |
| 台積電從2.5D IC切入一條龍服務市場 BigPic:451x346 |
事實上,跨業整合已是台積電維持龍頭地位不得不走的路,因為下一個半導體業競賽的技術已非對晶片集積度進化的追逐,比得是誰能最有效率且最有彈性地實現3D IC產品。目前,三星在這個領域站在領先地位,據分析也是台積電無法吃下蘋果A6晶片的主因之一。
由於3D IC橫跨晶圓及封測業兩端,因而衍生出via-first/via-middle/via-last等不同的TSV製程技術,以及多種不同的業務模式。不過,透過整合從前端製造到後端封測的垂直式整合作業方式,已是三星和台積電很清楚要走的路。
針對3D IC,台積電端出的菜稱為CoWoS(Chip on Wafer on Substrate),就是將邏輯晶片和DRAM放在矽中介層(interposer)上面,然後封裝在基板上,這個架構屬於2.5D IC封裝架構。對於台積電跨足到封測領域,負責「CoWoS」製程研發的台積電資深處長余振華曾經指出:「最重要的理由是,封測業已經跟不上晶圓代工的腳步了。」
余振華這麼說的理由,除了3D IC必須跨領域設計外,對於先進製程的良率控制上,晶圓與封測分家的生產體系,容易造成責任不易釐清的問題。因此希望透過一條龍的服務方式來擔起所有的風險,也能滿足Apple這個潛在大客戶及現有主力客戶包括Xilinx、AMD、NVIDIA、Qualcomm、TI、Marvel、Altera等對2.5D IC的迫切需求。
當然,台積電此舉也對日月光、矽品及力成等一線封測廠造成很大的壓力。為了力掃市場對封測業將流失地盤的說法,日月光及矽品皆強調,在先進高階封測製造不會缺席;力成則決定捨棄2.5D直接跨入3D IC,率先導入應用在記憶體DRAM產品。