为迎接人工智能(AI)与高效能运算(HPC)需求急遽攀升的关键时刻,先进封装已成为决定科技竞争力与产业布局的关键核心技术。国研院半导体中心今(13)日正式发表「晶片级先进封装研发平台」,将协助推动台湾半导体产业从「制程领先」,迈向「系统整合与应用创新领先」的新阶段,为後摩尔时代奠定关键竞争优势。
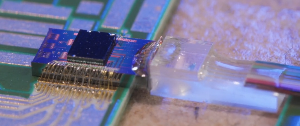 |
| 国研院半导体中心发表「晶片级先进封装研发平台」,图为矽光子EICPIC光纤整合电路模组。 |
国科会主委兼国研院董事长吴诚文表示,因应未来的AI应用需要更高效能、更高密度,以及更低功耗的晶片解决方案,既是挑战也是机会。「先进封装技术」便是串连「晶片到系统、创意到产品」的价值链枢纽,更是推动AI新十大建设中矽光子、量子电脑与智慧机器人等关键技术不可或缺的基石。
相较於目前全球量产最先进的封装技术之一,为台积电的CoWoS(Chip-on-Wafer-on-Substrate),透过中介层晶圆与基板,实现运算晶片与高频宽记忆体的高密度整合。然而,基板层的存在,也带来成本、讯号传输距离与制程复杂度的挑战。
国研院半导体中心发表的「晶片级先进封装研发平台」,则展现具国际前瞻性的关键突破,提出去除基板的 CoCoB(Chip-on-Chip-on-Board)封装架构。该技术省略传统基板,直接将中介层晶片与电路板连接,其难度犹如将一片很大片的钢化玻璃,放置於铺满鹅卵石的地面上,却仍需确保每一个接触点都能精准连接。半导体中心透过在每一微小连接球下方导入可流动介面材料,成功克服不平整问题,使所有连接点皆能可靠接合。
此CoCoB技术具备两大优势:一是大幅缩短讯号传输路径,显着提升整合密度与系统效能;二是降低基板成本与制程复杂度,特别适合学研单位与新创团队进行高弹性、低成本的异质整合实验。产业界认为这种「去除基板」的封装架构,将是下一代AI晶片的重要发展方向,也进一步验证国研院半导体中心CoCoB技术的前瞻性与战略价值。
此一开放式研发平台,不仅能支援HPC所需的处理器与高频宽记忆体整合,也可高度整合生医、环境感测、光电、电源管理等多元异质晶片,特别适合用於雏型验证与前瞻应用开发。未来不仅可为台湾产学研界提供全球独特的晶片级先进封装研发能力,更将催生一个属於台湾的「先进封装创新生态系」,加速前瞻实体AI技术的落地与商业化,带动百工百业升级。
国研院半导体中心表示,透过此平台的建置,台湾将不再仅止於制程与单一晶片的竞逐,而是正式迈向以系统整合与应用创新为核心的新世代半导体竞赛,持续巩固在全球半导体产业中不可或缺的关键地位。