前言
隨著關鍵尺寸逐年縮小,疊對預算變得越來越緊縮。此外,先進刻蝕機的成本成為在非關鍵層上使用最先進的掃描式曝光機的阻礙,導致在不同的層使用不同的刻蝕機;這種做法通常被稱為「混搭」。由於每台刻蝕機各有其獨一無二的特徵,因此混搭成為產生高階疊對誤差的問題根源。與單獨一台刻蝕機作業相比,掃描式曝光機的對準效能在混搭中會降低2個係數級。在45奈米,與實際掃描式曝光機對準效能相比,疊對預算幾乎沒有餘量。
每台刻蝕機在區域失真中均有不同的特徵。即使是完美對準,刻蝕機的特徵差異也會引起疊對誤差。因此,必需採取高階校正來確保匹配。圖一顯示了區域層級匹配,但這種情況對於機台柵格也是相同的。
有鑑於浸沒式光蝕等尖端刻蝕機的成本高昂,晶片製造商需要更好的OEE(Overall Equipment Efficiency;整體設備效率)和更好的COO(Cost of ownership;擁有成本)。因此,浸沒式與乾法刻蝕機混搭的產能必須要高。基於此原因,不採用專門的掃描式曝光機即可實現嚴苛疊對控制的系統成為必備條件。在本文中,將概述混搭誤差的自動表徵方法,以及即時校正的控制系統,這些技術是在混搭掃描式曝光機環境中改善產能的關鍵所在。
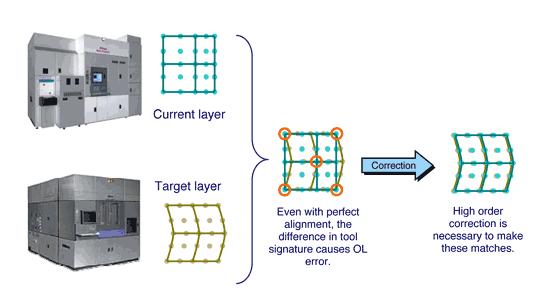
| 《圖一 不同的掃描式曝光機在區域失真中具有不同特徵,即使在一個區域的四個角均已完美對準,高階差異仍可能成為疊對誤差的根源。》 |
|
圖二顯示了混搭中的疊對誤差根源。機台柵格與區域失真的高階誤差以紅色和橘色顯示,從中可見大量誤差源於這些因素。左圖所示為沒有校正的混搭疊對之實際結果。中圖(b)是區域失真差異的範例,此係單獨一個曝光內的失真。右圖(c)是機台柵格差異的一個範例,整個晶圓的形狀誤差是由於個別曝光位置不同而造成的。

| 《圖二 (a)混搭中的疊對誤差根源。 (b)一個區域失真的高階誤差範例。 (c) 機台柵格差異的範例。》 |
|
協作框架
目前挑戰
眾所周知,由於區域失真及機台柵格差異,在混搭中會產生大量疊對誤差。此外,經過證實,GCM與SDM的功能對於校正這些誤差非常有效。然而,這些功能的實施卻有許多限制。因為需要資料收集、GCM與SDM的高階係數計算,以及為曝光機手動設定參數等程序,所以此類校正的手動表徵基線資料需要大量工作。因此,對於固定係數只能使用靜態控制。[6] 此外,手動表徵的程序也會造成人為誤差。目前,市場上尚未提供自動校正系統,尤其是在失真控制方面。
掃描式曝光機的功能
掃描式曝光機具備調整機台柵格及區域失真的若干功能,能與基礎目標層相匹配。目標層通常具有來自目前層的不同機台柵格特徵。GCM(grid compensation for matching)是控制目前層掃描式曝光機之機台柵格的一種功能,如此柵格才能與目標層特徵相匹配。[1-3]此外,SDM(super distortion matching)是控制目前層掃描式曝光機之區域失真的一種功能,如此區域失真才能與目標層特徵相匹配[4-5]。區域失真可藉由機台運動和投射光學系統的象差控制。GCM和SDM使用第三階多項表達式。[4]
協作框架
目前正在開發一種直接掃描式曝光機與度量通訊連結,以實現自動混搭控制。此系統有兩種主要功能。第一種功能是建立自動混搭資料庫。在一般預防維護期間,將自動建立高階區域和柵格失真的資料庫。而第二種功能則是自動混搭的自動曝光前補償。此系統可在生產曝光前先向曝光機發送高階區域與柵格失真。在此系統中,可以控制不同的光照條件。此外,還可控制多台機器的結合。我們將此系統命名為SMM(Scanner Match Maker)。
自動混搭資料庫建立功能
圖三說明了建立自動混搭資料庫的程序。使用一個一般的PM光罩對一個基準晶圓進行曝光。使用疊對度量工具測量晶圓,並收集基線特徵資料。 疊對資料將被發送至資料庫伺服器。此外,掃描式曝光機將發送要與度量資料相關的曝光條件資料。曝光條件資料包括機器名稱及光照條件。具備所有這些資料後,即可自動建立混搭資料庫。
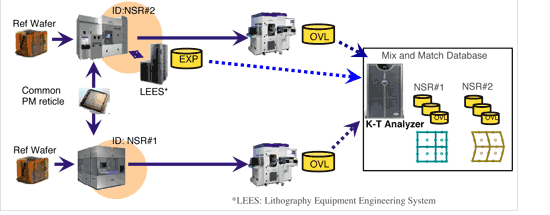
| 《圖三 建立混搭資料庫的程序,在此程序中將收集基線資料。》 |
|
曝光前混搭的系統
圖四為生產中曝光前混搭的程序。當一個生產批次到達目前層掃描式曝光機時,NSR掃描式曝光機將從伺服器要求目標層資訊。伺服器將傳回目標層的失真與柵格特徵。NSR將使用SDM和GCM的功能調整失真與柵格特徵。
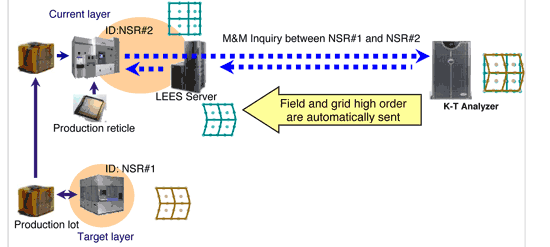
| 《圖四 此圖為生產時的程序。當生產批次到達目前的掃描式曝光機時,曝光機將要求混搭資訊。KT-Analyzer伺服器將把區域失真與機台格柵的特徵資訊傳回至NSR。》 |
|
實驗結果
高階穩定性的分析
為了瞭解資料庫應每隔多久更新一次的頻率,因此對高階可校正誤差的長期穩定性進行了分析。程序如下:
- 1.建立蝕刻的偽差晶圓,並由ArF掃描式曝光機進行曝光。
- 2.由NSR-S206D,即KrF掃描式曝光機曝光第二層。
- 3.為多點內部照射完成疊對度量。
- 4.根據疊對度量資料計算區域高階的係數。
- 5.對程序2~4監測七個月。
且實驗資料顯示,某些區域條件每200天以2奈米的斜度漂移。因此,對於1奈米內的目標誤差,資料庫更新頻率應為100天。

| 《圖五 此圖顯示了第二階可校正誤差的穩定性。某些可校正誤差顯示出漂移。》 |
|

| 《圖六 此圖顯示了第三階可校正誤差的穩定性。多數可校正誤差是穩定的,但某些可校正誤差發生漂移。》 |
|
使用SMM改善疊對
如圖七所示,從真正生產中擷取的圖形資料說明了混搭控制的優點。每個條各代表一台不同的曝光機。不同的顏色顯示了誤差的細目分類。灰色部分是無法控制的隨機誤差。紅色和橘色分別是區域和柵格高階誤差。
左圖是校正前的誤差。右圖是校正後的誤差。從中可見,透過混搭控制,可以顯著降低區域和機台柵格中的系統性高階誤差。
這些資料是從使用諸如SMM等相同概念,使用具備SDM和GCM功能的一個共同的光罩對混搭進行調整的實際結果中擷取出來的。
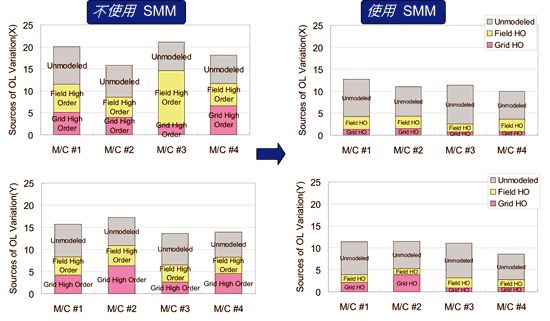
| 《圖七 混搭控制的實際結果。機台柵格與區域失真的高階誤差有顯著降低。》 |
|
混搭控制的價值
實際證明,混搭控制可降低30%以上的高階誤差。因此,有可能考量不嚴格限制刻蝕機的專用而改善微影單元產能。自動資料收集及校正將可排除人為誤差。

| 《圖八 (a)使用GCM的效能。 (b)使用SDM的效能。》 - BigPic:708x165 |
|
結語
由於日益緊縮的疊對預算,高階校正在成為標準要求,因此而開發出SMM方法以做為一種自動混搭控制系統,來符合緊縮疊對預算的要求。對區域失真的長期穩定性分析顯示,對於1奈米內的目標失真誤差,資料庫更新頻率應為100天。資料顯示,使用SMM能夠改善混搭疊對30%或者更高。
參考資料
[1]Yuuki Ishii et. al. “Improving Scanner Productivity and Control through Innovative Connectivity Application”. Proc. Of SPIE Vol. 6152, 615247, Metrology, Inspection, and Process Control for Microlithography XX
[2]Takahisa Kikuchi et. al. “Introduction of new techniques for matching overlay enhancement” Proc. SPIE Vol. 4346, p.1608-1616, Optical Microlithography XIV
[3]Dongsub Choi et. al. “Overlay Improvement by Non-linear Error Correction and Non-linear Error Control by APC”, Proc. SPIE Vol. 6152, 61523W, Metrology, Inspection, and Process Control for Microlithography XX
[4]Ayako Sukegawa et. al. “Overlay improvement by using new framework of grid compensation for matching”, Proc. SPIE Vol. 6152, 61523A, Metrology, Inspection, and Process Control for Microlithography XX
[5]Takuya Kono et. al. “Mix and match overlay method by compensating dynamic scan distortion error”, Proc. SPIE Vol. 5378, p.221-227, Data Analysis and Modeling for Process Control
[6]Stephen DeMoor et. al. “Scanner Overlay Mix and Match Matrix Generation; Capturing all Sources of Variation”, Proc. SPIE Vol. 5375, p.66-77, Metrology, Inspection, and Process Control for Microlithography XVIII
[7]Bernd Schulz et. al. “In-chip overlay metrology in 90nm production” Proc. SPIE Vol. 6152, 615213, Metrology, Inspection, and Process Control for Microlithography XXA.

