裝配技術已不再能夠清晰地劃分為元件、電路板和最終裝配。在產品整合的趨勢帶動下,電路板裝配商正努力取得與半導體相關的專門技術,而元件裝配商則學習如何處理無源元件和焊膏絲印,電子裝配的界線已漸被沖淡。顯然地,由於製造商都全力滿足市場需求,使到不同級別裝配之間的區別變得模糊,這種現象不僅影響技術層面,也對業務營運和品質控制造成衝擊。本文將詳細討論與之相關的挑戰。
由消費性電子產品帶動
與近年來高階運算應用領域的情形相反,消費性電子產品正在推動技術的進步。早期的消費性電子產品用戶熱衷於購買整合電話、個人數位助理、攝影、無線通訊、MP3播放及其它功能的移動設備,但這種趨勢並不僅局限於掌上型設備。實際上,某些綜合導航技術、電話、運算、自動巡航和碰撞偵測功能的新穎汽車電子產品正在不斷湧現。
家用遊戲機是另一個消費性電子產品性能和功能不斷增強的實例,下一代Playstation 3將運用IBM的晶片技術,其運算能力超過深藍超級電腦(據報載運算能力至少達到每秒1萬億次浮點運算)。預計這種新型0.10微米晶片將於2004年開始生產。Sony首席技術官最近稱,摩爾定律(Moore's Law)對於該公司已顯得太慢了,他補充道,大家不能再花費20年時間待性能提升1000倍。
因此,可以肯定,計算、資料、語音和視頻傳輸技術的整合正在促進電子業的發展,必須為變得更小、更快、更經濟的電子產品增加更多功能。
對於CBA的影響
也許您會問,這與電路板裝配有什?關係?由於性能和尺寸的影響,這些最終產品的內在技術也發生了變化。例如,越來越多廠商採用直接晶片附著(DCA)技術,將半導體零組件直接與電路板互連,從而消除了一層封裝。典型的系統級封裝模組(藍牙、GPS、功率放大器)可能有一至三個安裝在有機基底上的覆晶貼片零組件,在0201及其它無源器件的旁邊。電路板裝配商聲稱其擁有裝配這些模組的技術知識,因為這些模組的確與電路板類似(尤其是分割後)。現有的生產設備和技術可以處理無源器件,而靈活的精密機器也可用於處理覆晶貼片工藝。
另一方面,元件裝配商覺得他們具有裝配這些電路板的能力,因為他們一直在製造模組。然而,對他們來說,焊膏印刷、卷帶元件送料和貼片機都非常陌生,而墓碑(tombstoning)等老工藝問題卻變成了新的挑戰。突然之間,傳統半導體裝配廠商開始與CEM競爭來自IC設計或OEM廠商的業務。今天,裝配電路板時,有些晶片堆?應用帶動了處理晶圓的需求,要像處理電路板那樣,帶來一系列新的電路板處理挑戰,而元件的堆?也出現了。
排列封裝正在以多種方式發展。錫球間距為0.4mm的晶片級封裝(CSP)即將出現。有些跡象表明這種精密零組件也許需要在貼裝之前上助焊劑,而不是像我們今天處理0.5mm零組件那樣貼裝到焊膏中。隨著晶圓級封裝和測試技術的出現,一些CSP也許會像無封裝倒裝晶片那樣,直接從晶圓生產出來。
覆晶封裝的出現推動了對底部充填工藝的需求,底部充填設計用於緩解由熱膨脹係數(CTE)的不匹配而造成的應力,提高焊點的可靠性。從這種意義上看,底部充填替代了第一層封裝。最常用的毛細充填方法是在晶片貼裝後進行沉積和固化,通常由獨特的點膠系統和固化爐組成的專用充膠生產線來完成。而新的非流動充填方法則在晶片貼裝前甚至更好的在晶圓級進行沉積,簡化了整個工藝。底部充填與在電路板車間裏常見的處理方法大相逕庭。它需要更強的技術能力支援,從而有效地應用於大批量電路板裝配車間。這種工藝是錯綜複雜的,當控制不嚴格時便會嚴重地影響其可靠性。如(圖一)所示,測試載體,如FA-10和PB-8晶片,被廣泛用於研究和考核這項技術,及更深入地瞭解其性能。
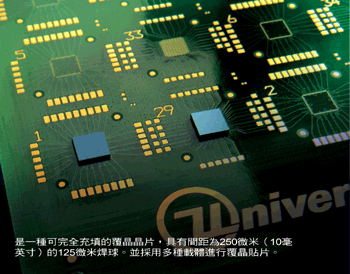
| 《圖一 安裝在環球儀器的測試電路板上的FA-10晶片》 | 註:是一種可完全充填的覆晶晶片,具有間距為250微米(10毫英寸)的125微米焊球。並採用多種載體進行覆晶貼片。 |
|
這種技術通常需要更嚴格的品質控制。隨著人們對焊球高度變化、焊接掩膜定位,以及原材料等參數的重視程度提高,供應商的品質保證也出現變化。在多數情況下,加工車間必須升級為無塵室,還必須擁有最新的實驗設備,無論是即場擁有或由第三方提供。同時必須配備掃描聲學顯微鏡(C-SAM)、X射線工具和熱迴圈設備,最好還能配備掃描電子顯微鏡。由C-SAM掃描獲得的充填材料分層情況,如(圖二)所示。
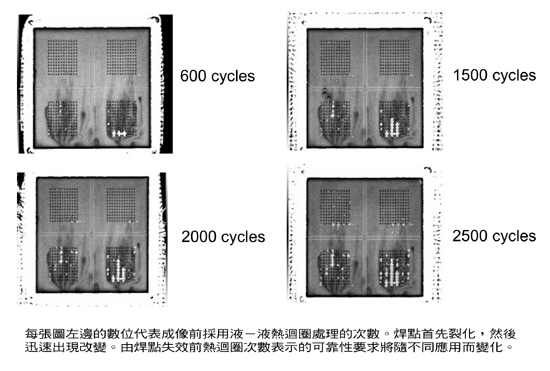
| 《圖二 C-SAM圖像的白色區域是熱迴圈之後產生的充膠分層》 | 註:每張圖左邊的數位代表成像前採用液-液熱迴圈處理的次數。焊點首先裂化,然後迅速出現改變。由焊點失效前熱迴圈次數表示的可靠性要求將隨不同應用而變化。 |
|
個別的裝配機器也與傳統設備不同。在開始時,零組件不再總是卷帶或JEDEC托盤的形式。在某些時候,零組件將直接由晶圓貼裝。通過視覺演算法和相機解析度調整,可實現精密及不對稱焊球圖案解析度。供應商品質保證、生產控制和操作均會受到這種變化的影響。
對於設備供應商的影響
與裝配商類似,設備供應商也需要更快地獲得電子裝配業所採用的諸多工藝知識,而不僅是電路板或零組件裝配方面。設備規格,如精密度和產量也有所不同。尤其是最近幾年,客戶要求其生產線和單台機器具有更大的靈活性。機器必須能夠很好地處理覆晶貼片器件和表面貼裝元件。裝配技術也已開始向3-D轉移,電路板密度已開始採用每立方英寸零組件數,而不是採用每平方英寸零組件數來度量。

| 《圖三 小尺寸線性電機平台及配套的300mm晶圓送料器》 | 註:該設備可以高精度地處理卷帶、晶圓或托盤形式的零組件,還可支援3D裝配。 |
|
結論
傳統的封裝級別定義已不再明晰。因此,裝配商必須學習新技能、掌握新技術,以應付新的競爭對手。同樣地,供應商也必須學習處理跨越傳統邊界的新要求。越來越多的半導體和光學零組件需要在電路板級進行裝配,而離散器件則在元件級進行裝配。裝配商必須處理新的材料,以及隨時改變品質控制方案。在準備迎接下一個成長周期時,只有那些瞭解如何管理整合技術,並與適當的供應商合作的廠商才能取得成功。(作者為環球儀器產品經理)

