由於處理器及其他應用設備對電源與性能的需求均持續增加,而電源供應可用的印刷電路板面積通常與以前的設計相同,這使得電路板面積變得極為珍貴。因此電源供應設計者不斷地尋找增加電流密度的新方式以與增加的輸出電流齊步並進。其中一個創新的方法是採用先進的封裝技術。
新型MOSFET封裝技術──DirectFET
DirectFET 是一獨特的全新 MOSFET 封裝,其中矽晶片直接貼裝在印刷電路板上。晶片構造類似通常用於目前 DC/DC 轉換器內的 FET,其中源極與閘極接地是在晶片的一面上,而漏極接地是在另一面或基板上。(圖一)的粉紅表面是晶片的鈍態層,用於隔絕濕氣。兩個大接頭是源極接地,而小的接頭是閘極接地。貼裝到印刷電路板上的 DirectFET 的側面圖顯示漏極矽透過導電與導熱注銀環氧(silver-filled epoxy)連至一個塗銀的銅金屬外層。銅金屬外層圍繞晶片的兩面以連至印刷電路板,提供漏極接地至線路板。
提供較佳的散熱效果
DirectFET 的結構本身能夠提供較其他表面貼裝封裝更佳的冷卻效果,因為它可從晶片兩面透過源極與漏極接地的寬大平面面積有效散熱。源極墊與印刷電路板的直接接觸,促使晶片能非常有效地把因傳導而在 MOSFET 管中產生的熱,從晶片直接傳至電路板,而無須如黏合電線或焊接點等的中間傳輸方法。據估計,接合點與印刷電路板間的熱阻抗(Rth-jb)每瓦低於攝氏1℃,熱阻抗較目前其他表面貼裝封裝低。
銅金屬外層透過電子接地將熱從漏極傳導至電路板。另外,也可以運用一個散熱片以更有效地冷卻。DirectFET的接合點與外殼間的熱阻抗是每瓦攝氏3℃。這個數值遠低於那些使用塑模的 FET,例如 DPak、SO-8,或任何這些封裝的各種新產物。例如,一個與 DirectFET 佔相同電路板面積 的SO-8,一般而言每瓦有攝氏40℃或更高的 Rth-jc。當散熱片未被使用時,DirectFET 的低Rth-jc便發揮作用。在這種情形下漏極實質上曝露在周遭空氣中或氣流中,因為從漏極而來的熱未受塑膠限制。由於其雙面散熱性,在目前任何MOSFET 中,DirectFET 也具有較低的總熱阻抗。
在同步降壓使用DirectFET封裝
在一個同步降壓轉換器內,上層 FET 源極、下層 FET 漏極,以及輸出電感都被連在一起,如(圖二)所示。由於節點上的電壓在Vin和接地間迅速切換,這個三點接地稱為切換節點。(圖三)顯示使用DirectFET 時切換節點的一個佈局可能性。綠色範圍代表防焊(solder mask)下的印刷電路板線跡,紅銅色的範圍是露出銅線跡的防焊鏤空(solder cutout),圓圈則是有交疊墊的通孔(via)。
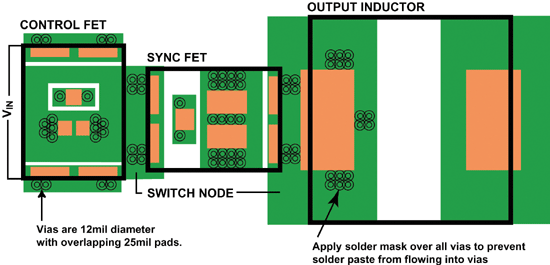
| 《圖三 採DirectFET封裝時之切換節點佈局》 |
|
將防焊用在通孔上以避免焊料從DirectFET 墊上流到通孔內。金屬外層兩面的漏極接地被分為兩個獨立接地,如果該零件在插入期間稍為偏差,DirectFET也可在回流期間進行自動校正。由於 DirectFET 只可在兩面上接觸印刷電路板,同步 FET 的閘極與源極線跡可透過金屬外層每面被垂直運作以進行接地,而不是使用通孔來連結內層。金屬外層下的運作線跡也使裝置的並聯變得容易。
要注意,沒有線跡將上層 FET 源極連結至輸出電感,反而是由下層 FET 的金屬外層提供這個接地,如(圖四),在電路板與DirectFET 側面圖內的紅色箭頭,顯示上面的 FET 在導通時的電流路徑(為了更清楚顯示,左側的 FET 相對於圖三內佈局轉變了90 度方向)。電流從輸入電源流向上層 FET 的金屬外層,穿過上層 FET 晶片,從上層 FET 源極經由印刷電路板線跡接地流到同步 FET ,再經由同步 FET 金屬外層到另一面上的印刷電路板線跡,最後從該線跡到輸出電感。
採用金屬外層之優勢
金屬外層相等於7 盎斯以上的銅,最大電阻(包括溫度上升)為125微歐姆。金屬外層因此可通過更多電流而不會影響熱設計──於30A及10%工作週期下,上層 FET 傳導時於同步 FET外層只額外耗散11毫瓦的功率。事實上,如果金屬外層被安排為在上層 FET 與輸出電感之間的路徑內,它將與印刷電路板的任何線跡平行。由於在這個情形下,金屬外層為沈重的銅並擁有更低的電感,大量電流將從線跡被移除。
由於不需要提供印刷電路板線跡,因此節省了不少電路板空間並得出了一個更高密度的設計。節省了的電路板面積也可被用於增加下層 FET 源極與印刷電路板間的接觸面積,為同步 FET 提供更好的冷卻效果,並為印刷電路板溫度提高而加強散熱效能。
結語
DirectFET 透過多種途徑以助達到更高的電流密度。首先,漏極的熱曝露使封裝的總熱阻抗較低,因此 FET 能加強印刷電路板上的散熱效率;第二,使用DirectFET 的金屬外層以消除上層 FET 與輸出電感間的印刷電路板線跡,結果是用於既定設計的電路板面積更小,因此增加密度;第三,因使用 DirectFET 以進行接地所節省的電路板面積可被用於更多印刷電路板銅以冷卻下層FET的源極或漏極,再次加強印刷電路板的散熱效率(以及更高的輸出電源)。在以IC設計的角度思考讓電子產品內的電源元件更節省空間之餘,先進的封裝技術亦是加速實現高整合度電源管理設計的有效率方法之一。
(作者任職於International Rectifier)

