儘管語音仍是消費者使用行動電話的主要功能,但純語音手機的時代已經過去。目前的3G手機已具備彩色螢幕、遊戲、音訊、視訊、相機、藍芽、GPS、無線網路、高速廣域資料服務和其它先進功能的多媒體系統,功能比純語音的2G電話複雜程度高達5至10倍,應用處理需求的成長幅度更是驚人。
即便如此,消費者仍期望這些新功能是由外形精巧且價格合理的手機提供,電池壽命至少不能輸給消費者早已熟悉的精簡型手機。研究顯示消費者不願接受通話時間少於兩小時的手機,而且體積精巧的手機能具備更大的螢幕。這些的要求已對手機零件供應商形成莫大壓力,迫使他們得積極將各種電子零件整合在一起。系統級封裝 (System-in-Package;SiP)和系統單晶片(SoC)是能夠滿足這些要求的方法。系統單晶片能減少所需的電路板面積、節省系統成本並降低耗電量,廣為無線通訊製造商及半導體元件供應商所採用。SiP封裝則能將採用不同製程技術的半導體元件整合至單一封裝,行動電話目前已經開始採用這種封裝技術。
以上兩種方法各有優缺點。本文將說明手機元件整合的技術挑戰,同時探討在整合記憶體、類比功能和射頻電路至手機時,SiP封裝和系統單晶片之間的取捨為何。
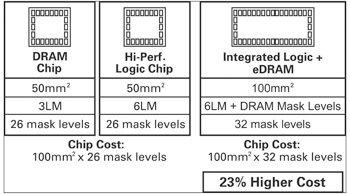
| 《圖一 嵌入式DRAM不符成本效益的系統單晶片整合例子》 |
|
記憶體整合
行動電話處理器需要容量大的RAM記憶體支援處理器核心運行,讓處理器的等待時間減到最低。這表示晶片必須包含足夠的第一層和第二層快取記憶體,讓處理器核心的管線隨時保持忙碌狀態,避免執行過多的外部存取動作。
為了大致瞭解系統單晶片應用所需的記憶體容量,我們不妨以功能豐富的2.5G手機應用為例,這類應用最多會有16MB(128Mb)的NOR快閃記憶體以及同樣容量的NAND快閃記憶體和DRAM記憶體。這麼龐大的記憶體容量並不適合嵌入式解決方案,因為它們會佔用很大的空間,對於電路板面積和成本也有負面影響。
手機應該將記憶體內建至晶片或使用外部記憶體,關鍵就在於嵌入式解決方案提供的價值是否超過晶片整合記憶體的成本。這表示任何嵌入式解決方案都應從架構的角度來發揮功能整合的優勢,譬如需要極高記憶體頻寬的繪圖等應用就是很好的例子,滿足這類需求的最佳方法是使用很寬的記憶體匯流排來提供所需的額外頻寬。這類應用的匯流排寬度可能是256或512位元,只不過這種匯流排寬度對外部記憶體並不切實際,唯有晶片內建記憶體才有實現可能;換言之,嵌入式記憶體解決方案除了降低成本外還能提供許多其它優點。
整合式晶片的製程複雜性若遠超過獨立晶片,系統單晶片的整合就不符成本效益。以(圖一)所示的6LM邏輯晶片和3LM DRAM晶片為例,假設它們的面積皆為50平方毫米,光罩層數都是26層,那麼它們以光罩層數表示的總成本就等於100平方毫米乘上26層光罩,也就是2600光罩平方毫米。但若將邏輯功能和DRAM晶片整合在一起,光罩層數就增加為32層,使得成本上升23%而達到3200光罩平方毫米。這是大多數系統設計都無法接受的成本增幅。
系統單晶片記憶體整合還會延誤上市時間,因為若要嵌入某種製程技術,就必須在其CMOS版本發展完成後另外投入9到12個月的研發時間。這表示複雜的嵌入式記憶體解決方案要等到標準CMOS實作完成後大約一年才會出現。
SiP封裝是解決嵌入式記憶體困境的一種低成本解決方案,例如堆疊晶粒SiP封裝的體積就和系統單晶片解決方案相同。這種封裝技術會在系統單晶片邏輯元件上方堆疊一顆或多顆記憶體晶粒,然後用低成本的打線接合(wirebond)組裝技術,將這些晶粒連接在一起,再將它們封裝到低成本的晶片級BGA封裝。(圖二)就是打線接合式堆疊晶粒SiP封裝的顯微照片。
堆疊晶粒不會增加高效能CMOS通訊處理器的製程複雜性,又能利用最具經濟效益的商品記憶體,故能兼具系統單晶片和SiP封裝的優點。堆疊晶粒通常不需要客製晶片,這對加快新產品的上市時間極有幫助。堆疊晶粒還能往垂直方向而非水平方向擴充,因此它能整合到小型封裝以滿足電池供電的消費產品需求。
類比和電源管理整合
類比和電源管理功能目前多半採用類比製程技術,和數位基頻晶片所採用的深次微米CMOS技術有很大區別。深次微米CMOS技術若能在不增加製程複雜性的前題下實作類比和電源管理功能,系統單晶片就能為類比和電源管理功能的整合提供一條低成本路徑。
數位CMOS的低電源電壓是利用數位CMOS技術實作高速和高精準度類比功能的最大挑戰,其它限制還包括小型元件匹配不良、1/f雜訊過大以及電阻、電容和變容器等晶片內建的多半被動零件無法提供良好的類比特性。受到這些影響,設計人員通常無法將現有類比功能直接複製到數位CMOS製程,他們必須將整個系統重新最佳化才能發揮CMOS的製程優點,同時發展新架構以利用低電壓和低成本數位邏輯的好處。在多數情形下,這些架構早已為人熟知,但在低電壓下的優缺點卻各自不同。
- * Flash轉換器的耗電量在低電壓下會大幅減少,這對Flash架構極為有利;
- * Flash轉換器的耗電量很小,因此多通道Σ-Δ轉換器架構比單通道架構更佔優勢;
- * 超快速邏輯在不到一個取樣週期的時間內就能完成偏移補償,還能用來實作小型低功耗比較器;
- * 數位類比轉換器和類比數位轉換器已能在低電壓下執行超取樣,能減少kT/C雜訊和簡化類比濾波器需求;
- * 數位自我校準式動態元件匹配在微小電路結構和低電壓設計中更能發揮優勢。
(圖三)是設計在最佳化的例子,其中12位元Δ-Σ類比數位轉換器充份發揮90奈米CMOS製程技術的邏輯和高速開關能力,這類轉換器的高解析度和取樣速率能讓系統以數位方式執行更多的無線電通道訊號處理作業;相較於依賴類比技術的設計,數位處理更能增加彈性並降低成本。
越來越多電源管理功能採用分佈式設計,低功耗應用尤其如此,因為它們要讓閒置中的邏輯功能和記憶體進入待機或休眠模式以節省待機功耗。設計人員通常只要利用開關元件啟動或關閉邏輯電路方塊即可實現這類電源管理功能。此外,晶片內含的本地穩壓功能也很重要,它們大都由晶片內建的低壓降穩壓器提供。設計人員通常要讓電路在電壓高於Vdd的位置操作,才能設計出電壓很接近Vdd的低壓降穩壓器或啟動某個開關,達成這項要求的方法是使用Drain Extended(DE) CMOS電晶體,它能讓汲極電壓高於正常MOSFET電晶體的BVdss電壓。
過去幾年,類比和電源管理功能的深次微米CMOS製程實作已有極大進步,手機所需的許多類比功能目前都能以低成本利用深次微米數位CMOS技術完成設計,讓系統單晶片整合與數位基頻晶片成為最佳搭檔,為類比與電源管理電路的結合提供一條絕佳路徑。
無線電整合
目前的手機無線電必須面對許多嚴苛的效能要求。必須在充滿強大干擾源的環境裡接收強度只有幾微伏的訊號、產生高輸出功率(約30dBm)來驅動天線,以及為手機所含的多種無線電功能提供最佳的隔離效果;此外,無線電設計還需要精確的高頻濾波,訊號路徑上的所有電路也要良好匹配。這些要求讓無線電整合變成一項艱鉅的挑戰,無線電功能究竟應該選擇SiP封裝或系統單晶片也成為一項困難決定。
(圖四)是現代GSM無線電常用功能的高階方塊圖,其中的無線電接收器功能包含將資料訊號升頻和降頻轉換到傳送頻帶所需的小訊號射頻電路,功率放大器模組則會將收發器輸出訊號放大以產生適當功率的輸出訊號來提供可靠傳輸能力。前端模組通常包含射頻訊號開關功能(負責分開時間多工的傳送和接收訊號)以及由SAW元件擔綱的射頻訊號預選濾波器(還有其它多種模組功能分割方式)。採用全雙工無線傳輸界面的CDMA等行動電話標準也採用類似的功能方塊圖,只不過它們會以雙工器取代原來的開關功能。
圖四兩個很大的橢圓形代表無線電功能的可能分割方式。第一個標示為SoC的橢圓形,代表射頻收發器與基頻處理元件的整合方式,第二個橢圓形則說明SiP封裝技術如何將收發器與功率放大器和前端功能整合在一起,創造出功能完整的類比無線電模組。將模組技術用於無線電功能是目前極為常見的做法,產品手機使用功率放大器模組和前端模組也已好幾年。類比功能通常需要匹配電路做為它們之間的無線電訊號界面,這表示無線電設計必然會用到各種被動零件,此時較好的設計方法是儘可能將被動元件整合到功率放大器模組和前端模組。設計人員通常會將功率放大器和前端功能分為不同的模組,避免功率放大器產生的熱量造成SAW濾波器的熱穩定性惡化。現在也有許多設計將所有無線電功能整合為單一封裝。
下文也將討論SiP與系統單晶片用於射頻電路實作的優缺點,同時說明無線電收發器最好是透過封裝技術與前端模組和功率放大器模組整合在一起,或者應將收發器與基頻處理元件整合至同一顆晶片。
SiP封裝可以使用傳統的類比射頻收發器,因此不需要新的收發器架構或特殊的半導體技術。這種無線電收發器功能早已成熟,而且除了焊墊配置和元件長寬比等模組整合有關的佈局考量外,SiP整合過程幾乎不會有任何困難。但利用SiP封裝整合收發器對於系統整體的改善卻沒有太大幫助,這是由於電路板面積雖可能縮小,耗電量卻不會降低,而且系統總成本還可能增加。
利用系統單晶片技術整合無線電收發器時,最常見的做法是透過深次微米CMOS技術把這些功能整合成單顆晶片。另一種方法是採用BiCMOS(SiGe)晶圓製程,這種技術可直接實作傳統無線電架構,只不過SiGe晶圓所需的額外光罩會造成系統邏輯功能和記憶體成本升高,SiGe製程缺少的先進微影技術支援也會導致邏輯功能佔用更多晶片面積。除此之外,傳統無線電架構還會導致系統邏輯與無線電功能無法緊密耦合,因此BiCMOS或SiGe製程的單石整合並不是理想方式。
根據上述分析,無線電收發器的系統單晶片整合必須透過CMOS技術達成。還好深次微米CMOS電晶體提供非常良好的射頻效能,又能輕易滿足整合式收發器的設計需求,例如同時提供低雜訊係數和高轉換頻率(transition frequency)。但傳統射頻收發器設計不僅會用到許多類比元件,還需要高效能被動零件,這些要求使得這類採用CMOS製程技術的設計需要執行更多製程步驟才能製造出所需的電阻、電容和電感。
深次微米邏輯製程提供極大的邏輯密度和很高的時脈速度,設計人員當然想透過系統單晶片發揮這項製程技術的優勢。這表示雖然他們可能要針對深次微米CMOS製程發展新的無線電架構,但此製程也會帶來許多重大好處,其中最重要的就是隨著CMOS晶圓製程技術進步而導致開關速度加快,這些元件也能提高它們的取樣速率。輸入訊號超取樣能減少雜訊疊頻現象(aliasing)和放寬輸入電路設計要求,設計人員可以採用更複雜的濾波技術,並且在更靠近天線的位置執行類比數位轉換。除此之外,系統單晶片整合也能提高系統生產良率,這是因為將有更多的功能改由邏輯電路實作,不像類比射頻電路會受到參數良率損失的拖累。採用更精密的先進製程技術設計無線電功能,還可以減少電路板空間和矽晶片面積。
(圖五)所示的GSM裝置就是採用整合式收發器,這個射頻收發器功能佔晶粒總面積還不到一成。這個設計就能以極低的成本、耗電量和電路板面積提供完整的GSM相容性。
結論
對於複雜度與3G手機相同的系統,結合SiP封裝和系統單晶片技術或許是最理想的實作方式。例如系統單晶片整合可能需要執行額外光罩步驟才能完成系統記憶體實作,因此成本效益就不如SiP晶粒堆疊技術。但另一方面,採用CMOS技術的系統單晶片整合,卻能實作高效能的類比數位轉換器和數位類比轉換器以及強大的電源管理功能。
射頻整合則以SiP與系統單晶片的混合搭配最理想,其中功率放大器、SAW濾波器、射頻開關和相關被動元件可用SiP模組實作,採用深次微米CMOS製程的系統單晶片整合則能為射頻收發器功能與系統基頻功能帶來許多優點。射頻功能的系統單晶片整合不但能減少功耗、成本、電路板面積和測試成本,並可提高效能、手機可製造性和生產良率。
(作者任職於TI德州儀器)
|
 |
這一全新的平臺將大大降低半導體廠商在開發3G SoC解決方案時的工程難度並加快產品上市時間。TTPCom將向半導體廠商提供一套集成了基於ARM技術的子系統以及TTPCom的多制式3G基頻的解決方案,幫助半導體廠商以更快的速度、更低的費用以及更小的風險。相關介紹請見「
3G 聚焦」一文。 |
 |
諸如JPEG、MPEG、3G、GSM/EDGE、IEEE 802.11/a/b/g WLAN、藍芽和UWB等標準,都是現代電子產業獲得商業成功所必需的。本文討論電子系統級(ESL)設計和驗證方法學在系統單晶片(SoC)設計中的應用。你可在「
在SoC設計中採用ESL設計和驗證方法
」一文中得到進一步的介紹。
|
 |
核DSP最重要的應用領域之一就是3G數位移動通信。其中包括基站和移動終端兩方面的應用。基站所使用的DSP更注重高性能,對成本和功耗不是非常敏感。
在「
淺析SoC時代的多核DSP產品」一文為你做了相關的評析。 |
未來智慧手機的電源管理技術
|
|
 |
|
|
 |
許多公司,特別是無晶圓IC設計公司,正針對RF應用推廣其all-CMOS SoC解決方案。 儘管某些性能較低的特定應用目前可以採用SoC解決方案,但這些都不可能會成為最佳化的解決方案。相關介紹請見「SiP成為通訊應用SoC的另一種選擇」一文。
|
 |
除了在傳統上結合現有LSI(SoC)裝置,瑞薩更設計用於SiP產品的新式SoC裝置,且在SoC 研發階段,相當了解SiP的需求。由於瑞薩認為SiP不只是將多重SoC裝置結合於單一封裝中, 因此瑞薩在SIP(Solution Integrated Product)類別中,定位了完整的SiP產品線。你可在「
瑞薩科技率先全球銷售一億組SiP」一文中得到進一步的介紹。 |
 |
其實,應用在行動電話的微機電非常廣泛,包含矽晶麥克風、3D加速器、RF被動與主動元件、相機穩定與GPS的迴轉儀、小型燃料電池與生化晶片等。在「
MEMS對於行動電話的影響分析」一文為你做了相關的評析。
|
|
|
 |

