越来越多电子制造商在设计中采用最新的覆晶封装技术,为了成功地使用这项技术,制造商必须对其表面黏着制程(SMT)装配设备、材料和制程进行部分改进,以及需要解决与制造相关的问题,包括助焊剂和底部充胶。此外,还要特别关注产量和品质等问题。随着技术的发展,并对装配设备和制程进行适当的调整之后,覆晶技术已成功地整合到许多电子产品中。
覆晶装配制程
要将覆晶技术整合到现有的产品设计中,必需对标准SMT制程作出许多改进。覆晶元件的贴装通常可利用现有的贴片机来完成,而覆晶的充胶制程的确需要专门的设备。典型的覆晶生产线通常由助焊、置放和回焊部分构成,以及独立的充胶和固化部分。
助焊剂步骤所采用的材料和方法会对生产的可靠性和产量产生很大的影响。浸渍和喷涂助焊是最常用的两种方法。喷涂所采用的大部分助焊剂都是称作「无残渣液体」助焊剂,其酒精含量达98~99%。在置放之前将助焊剂喷到基板上,由于酒精在室温下会迅速挥发,在电路板处理和回焊的过程中,剩余助焊剂的黏性不足以固定覆晶,会导致晶片移位。因此,可以采用浸渍法为覆晶元件涂上黏性助焊剂。通常浸渍法用刮胶刀将免洗助焊剂涂敷到可以旋转的平台上,形成一层薄膜。这样晶片锡球就可以浸泡在助焊剂中,并贴装到基板上。
与不能为晶片提供黏着性的液体助焊剂相比,黏胶助焊剂可在加工时确保晶片不移位,因而出现问题的可能性不大。助焊剂和底部充胶剂的选择应根据晶片钝化、锡球冶金、基板、焊锡掩膜和焊盘冶金等来决定。在确定浸泡助焊制程的制程窗口时,详细了解锡球高度分布和可能的锡球缺陷非常重要。
助焊剂膜的最小厚度取决于晶片内锡球高度的变化。要确保晶片上的良好焊接状况,所有的锡球都必需浸泡到助焊剂中。要建立适合涂敷助焊剂的制程窗口,可以利用裸板先进行试验。
贴装阶段
覆晶元件的处理可在托盘外进行。当考虑在贴片机上装配覆晶时,需要进行数项配置选择,包括光学解析度、照明几何结构、加工能力、贴片工具和基板支架工具。由于覆晶的连接介面是焊球,仅采用简单的晶片边缘技术并不足以对覆晶进行定位和贴装。
要避免覆晶贴片的方向错误,应采用不对称的可编程锡球图样以兹识别。贴片机必须具有足够的光学解析度、照明结构和处理能力,能将锡球图样定位在覆晶的底部。贴片机还须具有固有的精确度,以便将晶片精确地贴装在基板上。此外,吸嘴必须具备合适尺寸,并采用适当的材料制成,确保当晶片浸泡到助焊剂中时(黏性助焊剂),晶片不会落入助焊涂胶机,并且协助晶片与吸嘴在贴片时的脱离过程。
最后,基板支架必需牢牢地固定住基板,确保不会因为贴片而产生位移。印刷时,良好的支架装置不仅能支撑基板,还能简化操作,避免基板在回流和固化炉中由于倾斜而产生翘曲和变形。在选择贴片配置时,还需要考虑其他与特定制程相关的问题。
贴片制程的产量取决于许多参数,包括电路板的容差(焊锡掩膜、铜层)、焊垫设计和贴片精度等。焊接掩膜的容差是影响覆晶装配产量的重要因素之一。因此有必要进行不同的参数试验,使焊接掩膜的效应降至最小。例如,由于所要求的焊垫设计不同,间距越小,焊锡掩膜的配准效应越明显,因此,对贴装精度和焊锡掩膜容差的要求也越高。
底部充胶阶段
《图一 影响充胶制程之参数综述》  |
如(图一)所示,为影响充胶制程的参数综述,各种不同材料间的多种相互作用清楚地表明,所采用的材料必需作为一个系统来对待,一旦某种材料或设备发生变化,则整个系统必须进行重新评估。
特别是流动温度、点胶路径和时间的制程视窗必须根据各个特定的应用和材料来建立。更重要的是,与所选的材料一样,这些参数会对元件的可靠性产生重大影响。
在加工过程中,基板和晶片上的污染物也会对充胶制程和总体可靠性产生重要影响。由于焊接的工序非常严谨,并不需要使用清洁室,但仍需操作人员使用手套来装卸电路板,避免在充胶固化前,电路板会受到灰尘颗粒和化学物质的污染。
应避免在发生印刷错误后清理过程中或在维修时沾污电路板。在充胶前将元件暴露在潮湿的环境下,会影响其可靠性。不幸的是,暴露于潮湿环境下的容限取决于基板的设计和材料,以及对可靠性的要求。
要确保高产量以及获得良好的可靠性,便需对材料进行检查,并在生产过程中进行测试。正如之前所述,装配产量和必要的制程参数乃由基板和晶片品质决定。因此,需要监控这些材料的品质。
影响制程的因素
假使影响制程的因素发生任何变化,例如采用新的清洁工序或加工流程处理基板,以及凸块形成技术和充胶材料发生任何变化,都必需加以考虑,以评估其对制程的影响。
此外,基板的容差必须密切监控,以确保在装配生产中达到高产量。为了保证品质,必须了解凸块形成制程及监控锡球的高度分布。另外,可以对锡球进行剪切力测试,以找出锡球的系统性介面弱点。根据采用的锡球凸块形成技术,失效模式的变化或剪切力,可以指出晶圆批次中存在的系统性问题。这些变化可表明晶片或焊球的底部锡球金属化(UBM)的缺点和可能存在的介面问题。
材料
底部充胶剂属性的批次变化通常难以察觉。底部充胶要求的储存温度为-40°C以下,如在室温下则会迅速老化。运输和存储时的温度变化会对充胶材料的性能造成很大影响。通过简单的标准化测试可以监控底部充胶剂批次的变化。可能进行的测试是流动测试和基底润湿角度的测量。
材料的选择是元件可靠性和制程能力的最关键因素之一。例如,热质低的材料易于实现均匀的加热在回流、底部充胶和固化过程中。
离线X光测试设备会用来进行焊接品质的常规测试。由于采用了带接触轨道的圆形焊垫设计,在这种情况下,采用一个二维X射线已足以检测焊接的品质。 (图二)所示为焊垫几何形状产生的可见焊点构造。因为锡球在回流过程中不会变形,所以可以轻易地探测基板上的不浸润焊垫。
《图二 焊点几何形状产生的可见焊点构造》 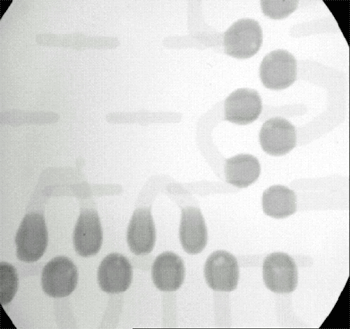 |
其它可观测的失效形式还包括虚焊和搭接。产生搭接的原因是挤压出来的焊剂填塞了焊球间的空隙。由焊球的间距所决定,这些空隙能够将两个焊点连接起来,从而在热回圈或附加回流时造成搭接。
(图三)和(图四)所示为一些典型的失效情况。由于焊球间距较大,达到400μm,在这种特定的应用领域中出现失效的风险很小。
《图三 典型的失效情况》 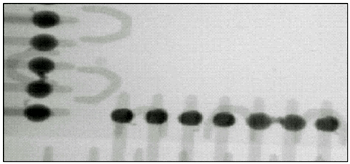 |
《图四 典型的失效情况》  |
充胶制程的品质是通过声学显微镜来监控的。由于不希望所有的配件都浸没到水里来测试,因此采用了抽样的方法去检测虚空和不完善的充胶过程。另外也可进行破坏性的测试,用磨削方法将晶片从配件上取下,以检查充胶层的状况。
结论
将覆晶技术整合到标准SMT制程流程中有许多的问题亟待解决。助焊剂和充胶剂的材料选择,受到晶片钝化、锡球冶金、基板、焊接掩膜和焊垫冶金等因素影响。制程窗口和稳定性的要求使浸渍助焊制程成为首选。电路板设计和元件间距会对装配的产量产生重要影响。对于充胶制程而言,必须因应个别的应用和材料,建立流程温度、点胶路径及时间的制程视窗。在生产过程中,尤其是在充胶工序中,存在着多种相互作用,因此必须对进入生产线的材料进行监控,如锡球高度分布和充胶流程性能,以及电路板品质。在加工过程中,电路板和晶片上的污染物也会对充胶制程和整体可靠性造成重大影响。此外,为了保证可靠性和良好的充胶性能,有时还需要对电路板进行额外的烘干处理。
新型材料和制程的使用,使得覆晶技术难以维持高产、优质和高竞争力。这项技术还需要得到与特定应用相关研发组织的持续支援和相互合作。尽管如此,针对保守的间距和可靠性要求应用的标准解决方案还是可行的。
材料系统的选择是导致所要求可靠性和装配产量的关键因素。与其他技术有所不同,覆晶装配的技术可因应设施、设备和培训的投资情况,采用进阶的方式实现。但覆晶在特定应用中的引进,必需根据个别的具体情况来决定。 (作者为环球仪器中国/香港区总经理)

