台灣半導體產業結構完整,以其緊密延伸的晶片製造合作模式,在過去數年間已建立起完整的半導體製程供應鏈,並持續朝向高附加價值的高階製程發展。而基於成本效益與縮短產品上市時程的考量,12吋晶圓廠已成為晶圓代工下一波的競爭主力。
在國際整合元件大廠紛紛將產能委外代工的趨勢下,造就了台灣晶圓代工的亮麗表現。為了建立台灣半導體產業的競爭優勢,國內晶圓代工兩大龍頭台灣積體電路及聯華電子在新竹科學園區及台南科學園區皆開始投資興建12吋晶圓代工製造廠,並進行小部份產能試產,加上國際級的整合元件大廠也都朝12吋晶圓的發展趨勢前進,使得後段的封裝製造廠為提供整合性一元化服務,也必須強化製程技術,以滿足晶圓尺寸增加後,對於封裝測試產業的多元需求。
12吋晶圓的優勢
綜觀今日IC技術提昇的關鍵因素,主要在於「製程線幅微縮」以及「晶圓尺寸加大」兩方面。在「製程線幅微縮」方面,線幅每縮小一半,晶粒便增加4倍以上,故能大幅提高生產效能、降低生產成本並且提昇IC功能。
而在「晶圓尺寸加大」方面,則是反應在降低生產成本與提高產能兩大部分,相較於8吋晶圓,12吋晶圓的優勢可直接表現於兩方面,為下一波半導體發展的必然趨勢!
1. 降低生產成本:
根據最基本的數學運算,12吋晶圓的表面積為8吋晶圓的2.25倍,也就是如果IC產品在8吋晶圓上平均可產出100顆IC,在相同良率的12吋晶圓廠,每片晶圓可產出225顆IC。而在生產成本不需提高兩倍的前提下,卻可產出多於兩倍的晶粒,大幅降低生產成本。
2. 增加產能,提高良率:
12吋晶圓具備較大的尺寸面積,所產出的數量勢必提昇,不但可增加產能更能提高產品良率。
晶圓尺寸的應用趨勢
就晶圓尺寸的應用趨勢而言,6吋晶圓大多應用在中低階的產品,特別是消費性電子產品的應用最為廣泛。而8吋與12吋晶圓則應用在包括中央處理器(CPU)、繪圖晶片與通訊晶片等高階產品,尤其是12吋晶圓,還可應用在256M DRAM、1G DRAM、集積度高的嵌入式晶片或整合晶片之生產上,應用範圍相當廣泛。然而以目前國內外晶圓製造廠而言,仍以8吋晶圓為主流,但積極朝向12吋晶圓量產。
12吋晶圓的後段製程發展
因為12吋晶圓的競爭優勢與對晶片應用朝向高階發展的趨勢,目前全球前段晶圓製造廠皆積極邁向12吋晶圓的發展方向,而對後段封裝製造廠商而言,除積極研發先進技術以跟進製程腳步,在產線機台上也需一併配合調整。從上膠膜(Taper)、晶片研磨(Grinder)、黏片(Mounter)以至於晶片切割(Dicing Saw)等步驟,皆需進行機台的調整以配合12吋晶圓的加大尺寸。同時,負責確保整體製作流程順暢及運輸晶片於每個機台間的晶舟載入台(Load Port)也需加以調整,以協助台灣半導體產業建立起由前端至後端完整的12吋晶圓生產線。
除了晶圓尺寸的不斷前進,隨著產品輕薄短小的需求及可攜式產品的推陳出新,IC晶片的效能與高度整合的需求越加擴大,對於半導體封裝產業而言,目前正從晶片級尺寸封裝延伸至晶圓級封裝方向發展,發展出的封裝技術包括晶圓級封裝技術(wafer-level package)、晶圓凸塊技術(Bumping),以及目前各家廠商積極開發的覆晶技術(Flip Chip)等。並透過標準半導體製程設備所具備的快速調機時間,因應晶片縮小的調整彈性,以及晶圓級的高溫篩選(burn-in)與測試能力,大幅降低製程成本,成為封裝產業中極具革命性的發展趨勢。而其中隨著覆晶技術在全球導體市場的重要性日增,對於晶圓凸塊技術的需求相對增加,使得晶圓凸塊技術,已成為晶圓級構裝中相當主流的技術,且對於未來整體高科技產業發展具有關鍵性的影響。
晶圓級封裝技術發展的重要性
由於覆晶技術相較於傳統封裝方式面積縮小約30%-60%,電性表現較為優異,可提高抗雜訊干擾能力,適合應用在針對CPU、晶片組及繪圖IC等高階產品。而覆晶的關鍵技術 - 晶圓凸塊,也因為覆晶技術市場的逐步起飛,在封裝產業的重要性與日俱增,廣泛應用在0.13um銅製程、CPU、電腦與繪圖晶片、Switching與藍芽產品等需要高容量、高速率功能的高階邏輯晶片上,更可應用於各項輕薄短小的無線通訊產品與先進的電子產品,為現階段晶圓級封裝的重要發展技術。
12吋晶圓凸塊技術與覆晶封裝的發展現況
以目前晶圓級封裝的發展現況而言,覆晶技術仍有IC設計門檻高、基板來源不足與成本高昂等問題亟待解決,但對於晶圓凸塊技術的發展腳步卻快速前進。由於現階段整合元件大廠(IDM)對於晶圓凸塊的需求明顯提昇,使得各家封測大廠的8吋晶圓廠皆進入穩定量產階段。以日月光來說,因應上游需求量的增加,目前8吋晶圓產出已逾10萬片,而12吋晶圓廠也進入試產階段,預估12吋晶圓凸塊將在近期內大量量產。
基於目前6吋和8吋晶圓之印刷技和電鍍技術各擅勝場,因此12吋晶圓凸塊技術的發展也導向印刷技術(printing)及電鍍技術(plating)。其中12吋晶圓的印刷技術之基礎則延繼6吋及8吋晶圓之印刷技術,另一方面也發展具獨特優勢的電鍍技術。就這兩項晶圓凸塊封裝技術來比較,印刷技術成本較低,較具有彈性,適用於大量與小量的生產。而若未來將朝向無鉛化的封裝趨勢,印刷技術將較為適用。但就High Thermal與線寬(fine-pitch)能力而言,電鍍技術則明顯優於印刷技術。未來各家廠商可針對產品製程需求而選擇適用之凸塊封裝技術。
雖然各家封裝大廠積極朝向先進的晶圓級封裝技術前進,但仍有許多的研發挑戰尚待克服,以覆晶技術來說,由於與傳統打線封裝比較下多了underfill製程與reflow製程,推翻了過去傳統封裝技術,因此困難度增加,良率問題仍待考驗,加上關鍵材料與製程無法掌握,使得發展過程面臨困難重重。因此對目前封裝廠商而言,當務之急即是掌握關鍵技術與投資基板的開發,以日月光為例,從基板製造、封裝、前後段測試、模組與系統整合,提供一元化的解決方案,不但對於後段製程技術的掌握度高,更能因為掌握封裝原料的來源,而大幅降低封裝的高額成本。
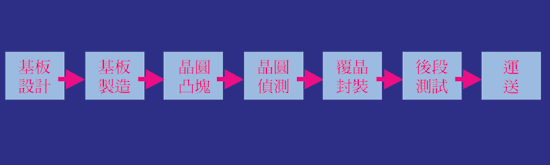
| 《圖一 完整一元化覆晶封裝服務流程〈資料來源:日月光〉》 |
|
台灣半導體供應鍊與機會點
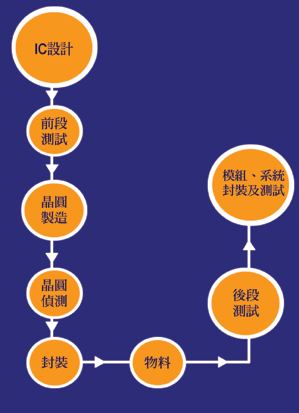
| 《圖二 完整一元化半導體製造服務流程〈資料來源:日月光〉》 |
|
對於產品的高度整合性、低成本與完整系統結構的需求,使得半導體產業必須不斷創造技術與製程上的革新,以順利完成市場目標並帶動資訊科技的發展潮流。台灣半導體產業的發展在歷經多年的努力耕耘後,已發展出完整的上中下游產業鏈,更擁有全球前兩大晶圓代工廠與封裝測試廠商。以目前市場預估,至2005年,全球約有50%的12吋晶圓廠將位於台灣,足見台灣在12吋晶圓廠發展中扮演舉足輕重的地位。
在目前台灣半導體前段製程不斷加速建立12吋晶圓廠之際,需面臨成本、設備和上市時程等方面的挑戰,然而,後段的封裝測試產業仍積極因應這股趨勢提出解決方案。目前包括日月光、矽品及Amkor等封裝測試大廠,皆積極推動12吋晶圓封裝測試服務。以日月光為例,已率先提供12吋晶圓完整封測服務,在2002年第一季之產能可達十萬片;此外,也提供完整一元化覆晶封裝技術解決方案,更掌握12吋晶圓處理、檢驗及針測方面技術,以協助台灣半導體產業加速12吋晶圓發展腳步。
然而,效能與價格一直是電子製造業的兩項發展動力。當半導體製造服務商持續改良製程之際,這兩項議題仍將是重要的關鍵。12吋晶圓的發展,將是未來高科技產品在品質與價格上能致勝的關鍵發展,但在發展的過程中仍面臨高額建廠成本與研發技術鴻溝的困境與挑戰,台灣半導體產業應把握目前擁有接近全球80%晶圓製造市佔率,以及40-50%全球委外測試市佔率之既有競爭優勢,突破現階段的製程瓶頸與挑戰,打造台灣為全球12吋晶圓之發展重鎮。
(作者為日月光半導體研發副總經理)

