前言
去年PC市场较不兴旺,使DRAM(动态随机存取记忆体;Dynamic Random Access Memory)连带受到影响。事实上,DRAM不只是应用在电脑设备的记忆模组上,许多电子产品也需要使用到DRAM记忆元件,针对各别商品的不同特性,对DRAM的封装型式也有不同的要求。
DRAM于市场上的应用情形仍以资讯性商品为主。从(图一)得知2001年DRAM所应用的产品类别,桌上型电脑、高阶伺服器、笔记型电脑及电脑周边产品(如扩充卡)等,合计已占市场半数以上。
预估2005年情形大致上仍维持相同态势,比较大的变动在于消费性商品比重的增加,由原先的4%成长至12%,之所以能有如此成长,有很大的驱动力在于市场看好未来家庭资讯化商品,如电视游乐器、视讯转换器(Set-Top Box)等。
另外,通讯、网路技术的发展及使用者普及的情况下,高阶伺服器产品于2005年的预估比重,也呈现成长态势。综合上述所言,消费性及高阶电子产品这两大「沃土」,将是日后影响DRAM市场最主要关键。
TSOP封装
IC制程最后都须使用封装来达成线路保护及媒介IC与PCB讯号传递功能。综观DRAM产品,其中有许多高阶封装型式如BGA、CSP等适合高I/O或封后体积小的技术出现,然目前使用最多的的封装型式还是以打线接合的TSOP(Thin Small Outline Package)为主,尤其是用在资讯产品类(如印表机、PC等)为什。究其原因,一方面这类型产品较无体积上限制,其所适用的PCB线距较宽(120-150 L/S);二来有成本考量,使用传统TSOP封装是最适合的选择。
传统封装瓶颈
然而随着消费性电子产品市场走向高速化、轻薄短小化,这类型产品不仅需要封后体积小的技术,而且讯号传递距离也要短,因此就须使用高阶封装技术来满足产品特性的需求。
轻薄短小化
从应用面来看,DRAM的元件最终会组装至应用产品的PCB电路板上,因此DRAM的封装尺寸大小影响到产品的组装后体积大小。所以当应用产品往高集积密度发展时(如手机、数位相机、PDA等携带式商品),除了PCB的线路制程提升外,元件封装技术也要往轻、薄、短、小发展,以达成产品体积的有效缩小。
高速化
网路通讯由于不断地追求更高的频宽,因此需要极高速的DRAM,如目前的OC-192所需的路由器之网路处理器,其记忆体传达速度需达到5Gbps的水准。下一代的极速OC-768所需则是OC-192的4倍以上,因此需要更高速的DRAM。
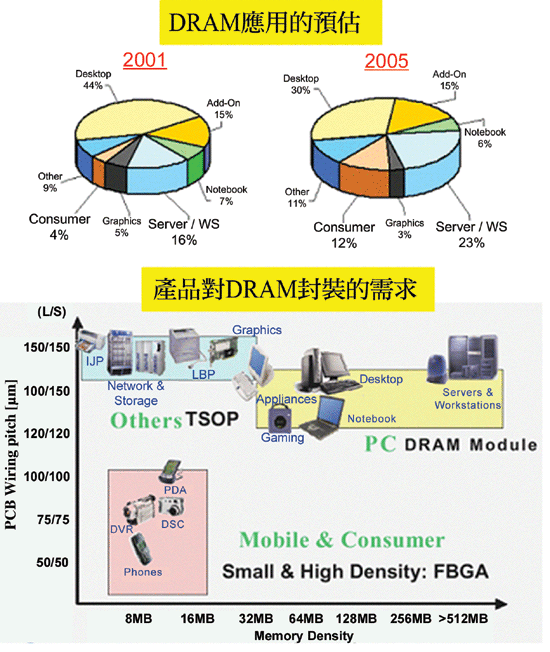
| 《图一 DRAM应用的预估与产品对DRAM封装的需求〈数据源:Source:威盛电子,2002,DDR333内存论坛会议〉》 |
|
DRAM的演进
在电脑产业中,DRAM始终是不可或缺的关键零组件。在电脑的功能不断提升下,DRAM的技术也出现世代交替的现象,以下针对各种不同技术的DRAM再做更详细的介绍:
FPM
FPM(Fast Page Mode)将记忆体内部隔成许多页数(Pages),其特色为不需等到重新读取时,就可读取各页数内的资料。
EDO
EDO(Extended Data Output)的读取速度比FPM快12到30倍。因为它会记取前一次动作的位址,可更快延伸资料的有效性。
SDRAM
SDRAM(Synchronous DRAM)是DRAM架构的改良技术;它运用晶片内的clock使输入及输出能同步进行。所谓clock同步是指记忆体时脉与CPU的时脉能同步存取资料。 SDRAM能节省执行指令及资料传输的时间,故可提升电脑效率。 SDRAM是由早期的66MHz(PC66),发展到目前常见的100MHz(PC100)、133MHz(PC133)三种标准规格。某些记忆体厂商为了满足一些超频爱好者的需求还推出了PC150和PC166记忆体。
DDR
DDR(Double Data Rate)双倍资料传输记忆体,是由SDRAM记忆体(SDR;Single Data Rate)延伸出来的技术。由于在时脉Rising Time和Falling Time都能传输资料,因而工作速度是标准SDRAM的两倍,所以即使在133MHz的汇流排频率下,其频宽也能达到2.128GBytes/sec。如今DDR266已全面普及,DDR333、DDR400以及DDR-II也开始进入实用阶段。
DRDRAM
Direct Rambus DRAM(Direct Rambus DRAM),或称为DRDRAM,由Rambus公司所设计发展出来。鉴于传统DRAM在传输资料时的瓶颈,Rambus则提出以封包方式将位置、资料与控制指令包裹起来传送,至信号线另一端再打开,使能有效拓展频宽。其主要的规格为400MHz的速度,并且在一个Clock工作时脉下,可以在正缘及负缘触发动作,故一个Clock工作时脉的速度会是800MHz(PC800,400MHz×2),但是Rambus属于串列资料传输模式,一般情况下只能提供到2Bytes(16-bits)的资料传输宽度,所以Rambus真正的速度就会是1.6 GBytes/sec的速度。而在Rambus在2002~2003年的Roadmap中,要将Rambus模组的时脉速度推进到1200MHz(PC1200,600MHz×2)。
从(表一)与(图二)归纳分析,新世代的DRAM为了朝向高速发展,以增加资料传送的频宽,工作电压将不增降低,这会使得信号传送过程更容易受杂讯影响,因此提升封装的技术也是必然的要件。
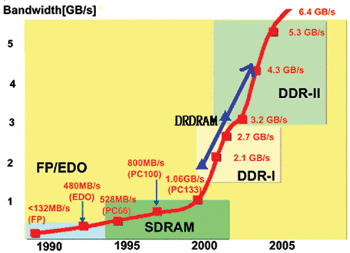
| 《图二 各世代的DRAM带宽发展趋势〈数据源:Source:Samsung〉》 |
|
DRAM超频风潮
缘起-PC150
我们常听过CPU超频,那DRAM的超频又是怎一回事?
一般DRAM的规格标准,会以全球各DRAM业界所组成的JEDEC(Joint Electronic Device Engineering Council电子元件评议会)正式通过为主,我们以PC133的时代为例,当时国际DRAM颗粒大厂所推出的产品,最新DRAM颗粒规格也仅不过是到PC133,根本没有所谓经由DRAM模组业者本身所推出的PC150、PC166产品。对于国际DRAM颗粒大厂而言,应都属于非正统规格商品,我们即称为超频产品。
一般DRAM晶圆制造商在出货前会进行晶圆后段测试,主要为寿命测试、筛选良品与不良品。在筛选良品与不良品之间会进行工作时脉的测试,如PC133 SDRAM模组所需的晶粒,其时脉速度应该能上133MHz,但后续还须进行封装,工作效能会减少。因此为了安全考量会将工作时脉定高一点,如定在140MHz,则会把140MHz以下时脉速度的晶粒当作不良品淘汰。
筛选通过的良品就以JEDEC的封装规格进行封装,目前PC133的封装标准是TSOP的封装型式,而模组厂商将此封装完后的DRAM,进行PCB的组装即成为PC133的模组(Module)。
我们知道一批PC133的晶圆除了可能是工作时脉无法到达133MHz而被淘汰,但也有晶粒是良率较好,而使工作时脉可能达到150MHz或更高,而这种晶粒即可拿来封装而成为可超频的DRAM,但这一切都是需要从成本考虑,因为要用相当精良的测试机台才能将可超频的晶粒挑出。而除了测试仪器设备本身是亿元的成本,还须花费测试的时间,所谓时间是金钱,这些成本的代价可能只是找出5%可进行TSOP封装的超频晶粒,因此采用传统的TSOP封装在超频的市场上是否具有竞争力呢?这是需要评估的。
DRAM颗粒封装
目前国内几家DRAM模组厂商,纷纷推出自有品牌DRAM颗粒,这些自有品牌DRAM颗粒工作频率可以高于JEDEC协会所制定的规格。自有品牌DRAM颗粒最大优点,在于这些DRAM颗粒都是DRAM模组厂以自己较高的封装技术来提升可超频的颗粒数目与良率,这样一来在价格竞赛过程中会较具竞争优势。
为了提高产品表现,DRAM元件也将逐渐转向以晶片尺寸封装(Chip Scale Package;CSP)的技术,虽然至今只有少数几家厂商以BGA方式封装DRAM颗粒,但我们可发现以超频为主的产品大都是采用模组厂自家的BGA封装技术,如胜创科技最早在2000年推出PC-150超频模组,采用TinyBGA封装、群翼科技采用SIM BGA封装、宇瞻科技采用联测Window BGA封装技术的DRAM模组、劲永国际推出新款BGA封装DRAM模组其名称为Power BGA。
DRAM的晶粒与封装基板的连接方式采用打线连接式(Wire-bonding),基板与模组板的连接方式为BGA(球型栅状阵列)组装方式,其能够达成超频的特性,主要是因为CSP BGA的封装体积比TSOP缩小60%,使BGA基板的线路比传统导线架来的短,因此减小讯号传递路径的距离。
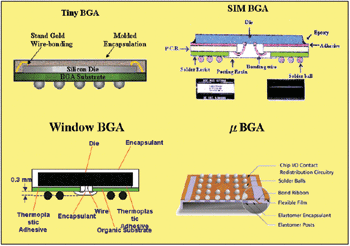
| 《图三 Tiny BGA、SIM BGA、Window BGA、μBGA的封装结构〈数据源:Source:胜创科技、群翼科技、联测、Tesssera〉》 |
|
DDR超频
超频的现象一样在DDR世代交替时发生,在JEDEC刚通过将DDR的速度提升至DDR333不久,已有模组厂商抢先开发号称支援到400MHz的DDR333模组。而这些可超频的DDR400晶粒与DDR333非常相似,包括工作电压、工作方式完全一致 ,只是对封装技术要求更严格。但JEDEC已有意将DDR的下一代标准定为DDRII,并预定工作频率从400MHz起跳,也规划相关规格,包括工作电压采用SSTL_18(1.8V)低电压、封装方式为BGA封装,这与第一代DDR完全不相同。因此,在尚未通过JEDEC标准的DDR400时,市面上号称DDR400记忆体模组,只能算是厂商技术上的宣示,提供来为新世代晶片组提供了验证之用,或满足超频玩家的超频需求而已。
寄生参数效应
半导体封装本身除了保护晶片外,也负责将晶片的信号传递出去,但这个传递路径并非完美的传导体。封装的路径相当是一个电阻(R)、电感(L) 、电容(C)等元件组成的等效电路,所以当高速的数位信号在传递过程中,会因为封装所产生的寄生参数效应影响,造成信号工作不正常称为:出现信号整合(Signal Integrity , SI)的问题。
当讯号频率增加将使时脉Rising Time和Falling Time的边缘速率上升,时序问题首先暴露出来,因为传输线效应造成的阻尼振荡(Ringing)、正尖峰(Overshoot)和负尖峰(Undershoot)有可能超过规定的杂讯容限(Noise Margin),而使信号判断错误。
在低速系统中,互连延迟和阻尼振荡可以忽略不计,因为在这种系统中信号有足够的时间达到稳定。但是当边缘速率加快,系统时脉(Clock)速率上升时,信号在元件之间的传输时间缩短了,封装的等效电路将产生高频阶振现象。其它可能遭遇的一些电性问题与杂讯现象有:串音(Cross-talk Noise)、反射(Reflection Noise)、接地反弹(Ground Bounce Noise)、讯号不对称(Signal Skew) ,而这些信号整合性问题都可利用先进的封装技术,减少了晶片和封装互连的寄生感应来改善。
各种解决方案
CSP封装
随着DRAM产品走向高频、高速,对传统TSOP封装方式而言,将形成挑战。封装厂商评估,TSOP仍可勉强用于封装DDR DRAM,但未来DDRⅡ架构形成后,为了符合产品的电性表现,走向CSP封装是必然的道路。 (图四)
分析一个DRAM的封装方式,采用TSOP封装的完整信号传递路径包括:晶片与导线架的金线连接、导线架的线路、导线架至PCB的引脚长度。而BGA的封装方式则将导线架引脚改为BGA锡球阵列的方式,并且锡球直接设计在晶片的下方,可大大降低封装体积,也缩短导体线路的距离。
覆晶接合
由于连接晶片与封装基板的连接,仍采用打线连接的方式,因为金线连接两者仍有一段距离且金线本身相当细,因此也含有相当大的寄生参数,若将此连接的方式再改为覆晶接合(Flip-Chip),以覆晶凸块连接晶片与封装基板,对电气特性的效能也会有所帮助。
传统覆晶
覆晶的特色是以凸块连接晶片与基板,不过使用凸块有许多因应力而造成可靠度不佳的现象,业界于是想到于凸块间灌入底胶(Underfill)来改善。但是,灌入底胶就是一道繁琐的程序,再加上封后成本的始终居高不下,是目前覆晶封装所面临到的瓶颈。
无凸块式覆晶
另一种无凸块式覆晶技术(Bumpless Flip-chip)的连接方式,一样没有打线方式的金线长度,也减少了覆晶凸块的高度,除了在电气特性的效能会有更明显的改善外,也符合未来产品走向轻、薄、短、小的趋势。
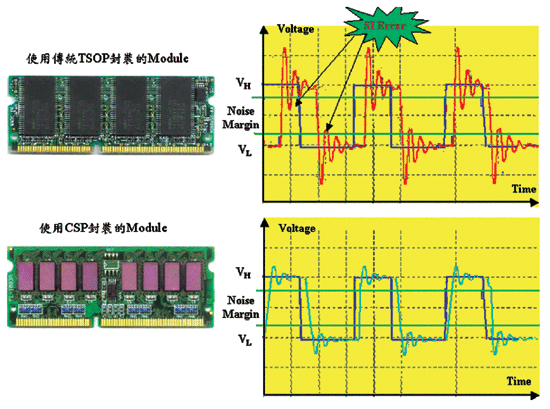
| 《图四 传统TSOP与CSP在高速数字信号对噪声抑制能力的比较》 |
|
晶圆级封装
在目前覆晶封装技术仍存在许多问题的同时,为了要决解高速记忆在封装时所遇到电性效能问题,一些厂商将希望寄托在晶圆级封装(WLP , Wafer Level Package)上。但晶圆级封装存在一个与晶片发展相冲突的现象,因WLP的线路只能在晶片区域内设计,即所谓Fan-In,由于晶片的发展方向是将晶片的面积不断缩小(Die Shrink),但晶片的I/O接脚数目却反而会因为功能不断提升,不减反增。
如(图五)所示,当晶片从Die 0的尺寸往Die 1与Die 2的尺寸缩小,但I/O的脚位间距必须为了下游组装电路板的成本与组装良率考量,不可相对的缩小脚位间距,所以只能Fan-In的封装,I/O接脚数目想必受到限制,因此只适合于较低I/O数的产品。
其他DRAM封装趋势
堆叠式封装
利用先进的封装技术打破传统封装的极限,可以将多颗IC封在一起,这种技术称为堆叠式封装(Stacked Package)技术。运用这项技术不但能轻易生产出1Gb的DRAM元件产品,更可以节省厂商生产成本。以目前国内主要IC厂,其生产主力在0.18微米制程生产设备,为了要生产高记忆容量的DRAM产品,必须投资一座更先进的(如0.16微米或0.13微米)制程设备,而一座新工厂资金花费都在10亿美元以上。如果使用堆叠式封装技术将可以延长0.18微米制程生产设备使用时间,并大幅降低投资风险。

| 《图六 Stacked Package产品〈数据源:Source:Samsung高密度 DDR Module〉》 |
|
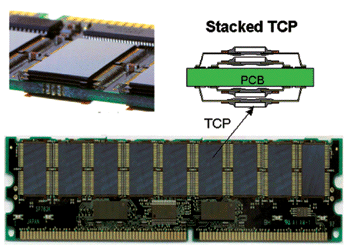
| 《图七 DRAM Stacked on Module〈数据源:Source:ELPIDA〉》 |
|
多晶片封装
随着大哥大等携带式商品的发展,利用晶片堆叠式的封装,来?到缩小电子产品体积的方式也开始出现,而这种将多颗IC封装成一颗IC就是所谓的多晶片封装(Multi -Chip Package,MCP)封装,现行的手机Flash与SRAM记忆体就是采用堆叠二颗IC的堆叠型多晶片封装(Stacked/MCP)。未来堆叠型封装技术更朝向SiP系统整合型封装(System in a Package)技术发展,则可将系统中不同功能的晶片整合于一颗封装产品中,大幅缩小PCB板面积。
结论
DRAM在整个半导体产业中,无论是产值的比重、制程技术或元件的设计上,都具有举足轻重的深远影响力。随着非PC领域产品对DRAM质和量的要求,以及PC用产品的差异性将逐渐提高,这些可携式行动上网等资讯产品,已开始朝轻、薄、短、小四大趋势积极发展,未来几乎所有的资讯性产品势必将走到高效能、低耗电量以及散热性佳的方向。面对目前DRAM模组市场激烈竞争局面,唯有利用先进的封装技术,才可提升DRAM的竞争力。 (作者任职于钰桥半导体)

