最近幾年應用現金支付功能、行動電話數位電視(One Segment)收訊功能、GPS定位功能、觸感式電子遊樂器功能的攜帶型數位電子終端機器急遽高性能化,這類電子裝置大多要求輕薄短小,然而構成電子電路的玻璃環氧樹脂基板,與可撓曲基板等印刷佈線基板,只允許在上、下面作平面性電子元件封裝,面臨高功能化市場要求時,傳統封裝技術已經出現小型、薄型化的物理極限。
在此背景下射出成形整合元件(MID: Molded Interconnect Devices,以下簡稱為整合成形立體基板或MID)的應用與發展,立即成為全球注目的焦點。
整合成形立體基板(MID)是在樹脂材質射出成形元件表面製作銅箔圖案,接著將電子元件高密度封裝在銅箔圖案表面,形成所謂多次元封裝模組,大幅縮減電子電路的外形尺寸,有效提高封裝精度。
發展延革
如圖一所示整合成形立體基板利用模具製作陶瓷或是樹脂射出成形元件,接著在成型元件表面製作銅箔圖案,由於此機構整合機械特性與印刷電路導線基板電氣特性,因此可以削減功能複合化與電子元件小型化時,引發的模組元件數量以及電路模組基板組立的作業時數。
傳統印刷電路導線基板通常是在上、下或是基板內部封裝電子元件,如果改用MID,就可以在理想位置高精度、多次元封裝電子元件,同時還可以有效抑制電氣性噪訊對周圍環境的影響。
MID對醫療機器的小型化也很有貢獻,例如鼻腔型醫療用相機、一次丟棄型吞服膠囊相機,都可以減輕病患就診時的痛苦。
一般認為未來高輝度LED照明市場,與車用照明燈具可望大幅成長,高輝度LED封裝要求高散熱、高反射、長壽命等基本特性。
由於MID可以在高散熱陶瓷表面製作圖案,具有極高的形狀自由度,因此它的未來應用備受高度期待。
目前已經實用化的人體感測器,透過多次元電子元件的封裝實現小型化宿願,未來如果應用在其它領域,例如應用在感測人體的點燈照明系統,可望獲得減碳、省能源等多重效果。
隨著汽車電子化的發展,各種感測器的使用數量急遽增加,典型的加速、溫/濕度、壓力感測器模組,透過MID的導入,同樣可以實現小型化等目標。
行動電話使用的電子元件之中,相機模組是最不易小型化的光學電子元件,不過市場對行動電話用相機模組的超薄型化、高畫素化卻越來越強烈,透過MID的使用,未來行動電話的超薄型、高畫素化、高功能化,勢必出現全新的風貌。
實例應用
人體檢測感測器
圖二是利用MID封裝的小型化人體檢測元件應用範例,該人體檢測模組實現小型化與可靠度提升等多重目標。
本模組使用的MID利用後述一行程雷射(One Shot Laser)技術製作高精度圖案。
如圖所示它是將IC、晶片、紅外線感測器等電子元件,高密度封裝在整合成形立體基板的六個表面上,驅動電路則收容在外徑ψ9mm的TO-5CAN封裝體內部,整體體積是傳統人體檢測封裝模組的1/10。
具體結構是將紅外線感測器、特殊應用晶片(ASIC)等九種晶片元件,封裝在整合成形立體基板相異的三個表面上,另外3個表面則當作檢查用墊塊的側邊通孔,或是接頭封裝用接地板使用。
如圖所示IC封裝面呈凹凸狀,結構上它可以防止保護IC與固定導線的密封樹脂流動,紅外線感測器封裝表面同樣呈凹凸狀,它可以支撐元件兩端,受光部位懸浮在空中,同時兼具良好的電氣性接合與熱絕緣性。
相機模組
圖三是內嵌於行動電話的相機模組,應用MID的代表性範例。一般相機模組是由對焦的鏡片、光圈、消除紅外線的IR濾波器、取像元件(CCD或是CMOS感測器)、處理取像元件信號的數位信號處理器,以及封裝這些元件的基板構成。
圖三(a)是使用傳統封裝基板的相機模組斷面結構,使用傳統印刷佈線基板的相機模組會有以下問題,分別是:
- 要求光軸調整作業:支撐鏡片模組的筐體與印刷佈線基板的設置精度不足,容易發生光軸偏異,必需進行調整作業,特別是取像元件與鏡片透過許多微細元件組立,因此很容易發生光軸偏異現象。
- 要求光路長度調整作業:對焦鏡片至取像元件之間的距離,亦即光路長度非常重要,然而實際上受到鏡片模組、鏡胴、印刷佈線基板三元件精度的影響,必需進行光路長度調整作業。
- 不易降低模組高度:調整光軸時受到取像元件的固定導線等影響,模組低厚度化有結構上的極限。
圖三(b)是使用MID的相機模組範例;圖四是鏡頭模組用MID時的實際外觀。
如圖所示MID的上方設有鏡片與紅外線濾波器,形成可以發揮光學功能的結構;MID的下方設有封裝覆晶(Flip Chip)的電子電路單元;取像元件的內側電路基板表面收容覆晶封裝的數位信號處理器;MID的中心部位設有取像元件受光開口部。
鏡片支撐部位與電子元件基板呈一體化設置,不需要作光軸調整,可以大幅簡化組裝製程,電路基板則與連接端子呈三次元佈線,可以有效應用空間實現小型化。
整合成形立體基板整體結構,對小型化與低厚度化非常有利,它與傳統印刷佈線基板(PCB: Printed Circuit Board)最大差異如下:
- 鏡片單元與取像元件一體化,有效削減元件使用數量實現小型化。
- 透過高精度電路圖案,確保鏡片與取像元件的光學性位置精度,實現光軸調整簡易化的目標。
行動電話用小型相機模組,隨著終端客戶的要求越來越多元化(高畫質、變焦、輕巧等等),圖五是高功能化的整合成形立體基板應用範例。
傳統印刷佈線基板(PCB)如果置換成整合成形立體基板(MID),可望大幅削減材料、提高抗噪訊特性、產生其它附加功能與特性,尤其是不增加元件數量的全面覆膜(Coating)噪訊遮蔽(Shield)效果,與閃光燈用高輝度白光LED的封裝,還可以充分發揮MID的優勢。
IC封裝大多使用環氧樹脂等熱硬化性樹脂,相較之下傳統相機模組則使用聚醋酸乙烯酯(PPA: Polyphthalamide)等熱可塑性樹脂,因此對高畫素化後越來越嚴苛的元件內部粉屑管理具有一定的效益。
使用整合成形立體基板的小型相機模組,除了擁有小型化、薄型化、高附加價值化之外,還可以提高封裝組裝的可靠性與複合化等革命性特徵。
應用領域
磁器感測器與加速感測器的應用
圖六是利用MID封裝的磁器感測器與加速感測器應用範例,如圖六(a)所示傳統印刷佈線基板封裝的場合,預定檢測的馬達位置幾乎不在容易檢測的位置上,因此設計上必要利用輔助基板,將檢測物封裝、固定在最佳感度可以檢測的位置、角度上。
然而感測器依照此狀態封裝,輔助基板與主基板作電氣性連接,必需使用跳線與連接器,輔助基板還需要使用筐架固定,此時如果改用MID,就不需要使用固定輔助基板的筐架與輔助基板。
由於製程上可以在MID表面鋪設銅箔圖案,因此能夠與主基板作面封裝,大幅省略筐架、輔助基板、跳線、連接器等元件,實現使用元件削減、模組小型化、工程削減等多重目標。
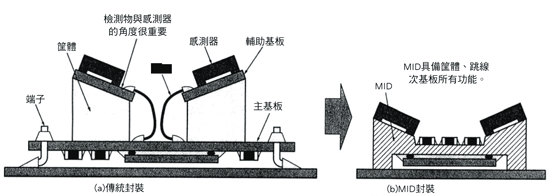
| 《圖六 利用MID封裝的磁器感測器與加速感測器範例》 |
|
指紋辨識模組的應用
圖七是利用MID封裝的指紋認證感測器範例,指紋辨識系統為消除手指的靜電,通常都設有金屬遮蔽物,封裝靜電容量感測器的輔助基板,則利用軟性印刷電路板(FPC: Flexible Printed Circuit)與主基板連接。
傳統封裝方式要求消除手指靜電的金屬遮蔽物,元件的追加與組裝工程的增加,經常成為困擾的課題。
此外指紋認證感測器使用軟性印刷電路板(FPC)連接,信號處理容易受到外部噪訊影響,此時如果改用MID,封裝靜電容量感測器的部位周邊射出成形元件可以鋪設電鍍覆膜,不需使用金屬遮蔽物,同樣可以獲得噪訊遮蔽效果。
由於結構上不需使用軟性印刷電路板(FPC),因此可以將指紋認證感測器的資料傳遞給主基板,同時降低元件使用數量與模組的耐噪訊特性。
此外封裝在傳統主基板的元件可以封裝在輔助基板,對模組的小型化具有直接助益。
MID的製作方法
整合成形立體基板的製作方法,分成二行程法(Shot)與雷射法兩種,代表性的四大工法製作流程如圖八所示。
接著介面4大工法的製作流程。
製程
二行程法-1
- 首先利用射出成形模具製作MID的外形結構。
- MID進行蝕刻,利用無電解電鍍技術使塗佈觸媒析出金屬。
- 接著製作圖案以外的形狀(光罩化),進行最終成品的加工。
- 最後進行無電解電鍍,表面形成觸媒露出圖案。
2行程法-2
- 首先利用射出成形模具,製作最終MID的外形結構。
- 接著使用溶融素材進行第2次成形,使圖案以外的部位光罩化。
- 在MID表面塗佈觸媒,該觸媒同樣進行電解電鍍析出金屬。
- 去除2次成形材料部位
- 最後再進行無電解電鍍,觸媒塗佈部位的表面形成圖案。
雷射直接成型(LDS: Laser Direct Structuring)
- 首先利用射出成形模具,製作最終MID的外形結
- 構。
- 圖案部位照射雷射,使射出成形品含有的觸媒浮出表面。
- 最後接著進行電解電鍍形式圖案。
一行程雷射法
- 首先利用射出成形模具,製作最終MID的外形結構。
- 利用金屬噴敷(metalizing)製程,在MID外表製作銅膜。
- 接著使用雷射將銅箔圖案與非銅箔圖案部位分離確保絕緣。
- 銅箔圖案部位進行電氣電鍍,增加銅膜厚度。
- 利用軟蝕刻(Soft Etching)製程,使整體變薄均勻溶解去除銅箔圖案以外的銅膜。
- 最後進行鍍鎳、鍍金形成銅箔圖案。
加工方法比較
模具使用數量
由於二行程法要求二次成形(光罩化),必須使用更多的模具,因此二行程法除外,其它工法都可以在一個表面製作封裝外形。
材料
射出成形品必需使用MID專用材料,而且材料隨著製作工法不同。
尺寸精度
封裝尺寸精度取決於射出成形模具的精度,不論使用哪種製作工法,要求尺寸精度都是±50μm。
銅箔圖案的微細度
導線的寬度與間距隨著製作工法不同。
銅箔圖案的修正容易性
雷射成型法必需製作雷射加工CAD程式再進行圖案製作,圖案變更時只需修改雷射加工CAD程式即可,雷射成型法因此比2行程法更方便。
表面粗糙度
表面粗糙度會影響導線固定性,一般認為表面粗糙度越小,對導線固定性比較有利。
一行程雷射法的MID製作技術
目前MID大多採用雷射法製作。接著要深入介紹一行程雷射法的MID的製作技術。
使用一行程雷射法製成的MID應用元件,已經進入量產化階段,具體範例例如上述的相機模組,與人體檢測感測器模組等等。
日本電子元件封裝業者已經正式採用MID技術,並將此工法稱為「微細複合加工技術(MIPTEC: Micro Integrated Processing TEChnology)」。
到目前為止MID大多是在射出成形元件表面製作銅箔圖案,使印刷佈線基板形成3次元結構。
由於市場要求薄型化、小型化,因此具備封裝功能的MID逐漸成為主流,在此背景下開始突顯一行程雷射法的優點。圖九使用聚醋酸乙烯酯(PPA: Polyphthalamide),等熱可塑性樹脂材料的MID,封裝貫通晶片(Via Chip)後的實際外觀。
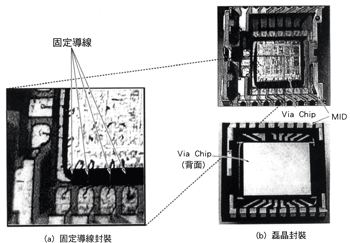
| 《圖九 半導體晶片(Via Chip)的MID封裝》 |
|
貫通晶片的封裝是一般導線固定技術封裝面積小型化的改良版,非常適合覆晶封裝。貫通晶片封裝MID具有以下兩大特徵,分別是:
適合導線固定獲得銅箔圖案表面
固定導線時銅箔圖案表面太粗糙,導線的接合會非常不穩定,利用射出成形元件表面的錨點(Anchor)效果,可以確保射出成形元件與銅箔圖案的密著力,因此一般MID製程,為了使射出成形元件表面粗糙化,必須將銅箔圖案表面粗化,它相當於上述圖八的二行程法與雷射直接成型法(LDS)。
一行程雷射法利用長膜時表面圖案活性化處理形成化學結合,確保射出成形元件與銅箔圖案的密著力。
使用覆晶晶片封裝材料
一般樹脂材料會隨著溫度變化膨脹、收縮,XYZ方向的變形量彼此不均勻。如
圖十一所示覆晶晶片封裝受到溫度變化的影響,膨脹收縮(線膨脹率)與膨脹收縮時的XYZ方向變形量差異(異方性)很大時,受到加熱爐與實際使用環境的溫度循環影響,經常變成與貫通晶片出現線膨脹率差異主要原因,進而造成接合不穩定,嚴重時還有接合完全迸裂之虞。
如圖十二所示微細複合加工技術(MIPTEC),透過材料內部填充物(Filler)種類、配合量、配合比的最佳化,使用比一般線膨脹率與異方性更低的材料,因此可以確保溫度循環時的接合穩定性,實現適合封裝覆晶晶片用整合成形立體基板。
一行程雷射法的MID,利用雷射圖案化技術製作銅箔圖案。圖十三是雷射圖案化設備的概要,如圖所示為支援製作各式各樣微細圖案,雷射焦點高精度描準射出成形元件表面非常重要。
一般認為組合可以使射出成形元件傾斜的5軸加工台、同步描繪動作的高速控制系統,以及即使高低差異很大的基板,也可以進行對焦的動態焦點鏡片等技術,銅箔圖案的寬度、間距可以獲得±30μm的精度。
陶瓷的圖案製作
如上所述1行程雷射法利用射出成形元件與銅箔圖案界面的化學結合,確保銅箔圖案的密著力,不過對化學特性很穩定的陶瓷表面圖案製作卻很困難。
經過反覆試驗研究人員發現部份銅薄膜長膜製程的改良,同樣可以在陶瓷表面製作銅箔圖案,獲得其它MID製程沒有的特徵。
如圖十四所示有關陶瓷表面製作銅箔圖案,理論上多層陶瓷基板也可行,不過受到銅箔圖案位置精度與形狀自由度有落差影響,此時MID反而可以突顯它的優勢。
有關銅箔圖案位置精度,由於製作陶瓷基板時必需經過燒結製程,燒結後的基板會收縮,尤其是陶瓷基板銅箔圖案製成後必需經過燒結製程,其結果造成銅箔圖案本身也會收縮,因此射出成形元件銅箔圖案的位置精度大幅降低,一般只有±50μm左右的精度。
多層陶瓷基板是由綠帶(green sheet,陶瓷粉末薄片)堆積製成,製程上不易製作凸狀與變形元件,相較之下MID的陶瓷,大多是在壓製技術或是陶瓷射出成形(CIM: Ceramic Injection Molded)技術製成,接著再利用雷射加工法製作銅箔圖案,因此不論是凸狀或是3次元形狀都可以製作銅箔圖案,換言之陶瓷MID的銅箔圖案位置精度比比多層陶瓷基板優秀,而且可以取得很大的形狀自由度。
陶瓷具有高熱傳導率、低線膨脹率、高耐熱性等特徵。圖十五是包含聚醋酸乙烯酯在內,各種材料與陶瓷的熱傳導率比較。
以陶瓷材料而言,一般氧化鋁的熱傳導率是樹脂的85倍,陶瓷材料如果使用氮化鋁,可以獲得比氧化鋁高6倍的熱傳導率。
陶瓷材質的MID,適合應用在要求高散熱、高加熱爐耐熱特性等高輝度LED的貫通晶片封裝。
圖十六是使用陶瓷MID技術的3晶片LED封裝範例;圖十七是陶瓷MID的直角方向發光LED封裝範例。
上述兩範例都是利用Au-Sn膠將貫通晶片,在陶瓷MID進行晶粒固定(Die Bonding)封裝,接著作導線固定與樹脂密封,形成所謂的LED封裝,本封裝技術也支援覆晶封裝。
使用陶瓷材質的MID,具備以下特徵分別是:
圖十六的3晶片LED封裝範例,是將三個超高輝度、數W等級的LED,封裝於5mm正方的MID,實現數百流明(lm)超高照明輝度目標,未來該技術還可以應用在建築用、照明用(Illumination),等要求多色度照明的領域。
可以複數封裝貫通晶片的複晶片型陶瓷材質MID,在小型化、熱傳導性、成本、功能面非常有利,一般認為未來可望成為微電子元件封裝主流。
今後展望
感測器與半導體等封裝市場要求高度微細化、小型化、模組化,整合成形立體基板(MID)必需充分反映市場需求,持續改善加工技術追求更微細化銅箔圖案。
最近幾年封裝技術的變革浪潮中,多層陶瓷與MID的融合,已經成為全球注目焦點,特別是以往MID,只能在射出成形元件的表面製作銅箔圖案,如果改用多層陶瓷MID,內層也可以製作銅箔圖案。
圖十八的整合多層陶瓷基板與陶瓷MID技術的複合式基板,具備以下特徵分別是:
- 以往斜面與側面無法製作銅箔圖案的多層陶瓷,透過MID技術獲得實現,而且還兼具噪訊遮蔽效果與高密度化等多重特性。
- 實現±30μm銅箔圖案位置精度:傳統多層陶瓷基板製作銅箔圖案後才進行燒結,該燒結製程受到陶瓷特有收縮率影響,出現銅箔圖案位置精度不良等問題,此時如果應用MID技術,可以有效克服上述問題。
- 今後隨著貫通晶片的微細化,勢必要求封裝的銅箔圖案高位置精度,MID技術變成非常有效封裝工法
- 多層陶瓷基板可作微細銅箔圖案:業者已經開發Line/Space=70/70μm與Line/Space=30/30μm微細銅箔圖案製作技術。
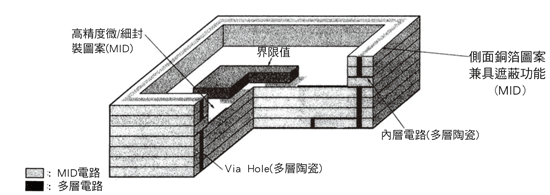
| 《圖十八 整合多層陶瓷基板與陶瓷MID技術的複合式基板》 |
|
結語
傳統玻璃環氧樹脂基板與可撓曲基板等印刷佈線基板,只能在基板上、下面作平面性電子元件封裝,面臨電子機器小型化、薄型化、多功能化時,傳統印刷佈線基板面臨物理極限。
整合成形立體基板是在樹脂材質射出成型元件表面,製作銅箔圖案高密度封裝電子元件,形成所謂多次元封裝模組,因此大幅縮減電子電路的外形尺寸,有效提高封裝精度。
一般認為隨著整合成型立體基板技術的普及與周邊技術的建立,未來可望成為小型攜帶型電子機器的主流封裝方式。