现阶段国内封测产业,虽针对市场上不同的应用产品发展出各式各样的封装型态,但实际作为晶粒与外界电路连接的方法,仅有焊线(wire bonding)、卷带式自动接合(TAB)以及覆晶(flip chip)三种封装技术。其中焊线封装,为目前最主要的产品采用技术;卷带式自动接合技术,其应用范围较为有限,主要在薄膜电晶体显示面板(TFT LCD)的产品使用。至于近年来极受瞩目的覆晶封装技术,虽然目前仅占总产能的5%以下,但预计在2005年后便可望超越焊线封装成为市场主流,也因此吸引了许多国内外的封装业者投入研究及开发相关技术。
根据市场调查机构TechSearch所做的调查资料显示,全球采用覆晶封装技术的晶片出货量于2001时仅10亿多颗,但预估至2003年将倍增到20多亿颗,2005年更可突破35亿颗,显见覆晶技术的高度发展潜力与成长速度,并充分点出覆晶技术在所有封装型态中的重要性。
覆晶封装技术发展背景
覆晶封装技术始于1960年代,当时IBM为了大型电脑的组装,而开发出了所谓的C4(Controlled Collapse Chip Connection)技术,随后进一步发展成可以利用熔融凸块的表面张力来支撑晶片的重量及控制凸块的高度,并成为覆晶技术的发展概念。
所谓的覆晶封装技术,即是指将晶粒(Die)之接合垫上生成锡铅凸块(solder bump),而于基板上的接点与晶片上凸块相对应,接着将翻转之晶粒对准基板上之接点放置于基板上,经由回焊(reflow)制程将凸块融化,待凸块冷却凝固之后,便形成晶片与基板之间的信号传输通路。
这样的封装型态将可符合新兴的电子产品在效能表现提高及体积小型化的发展需求,因而逐渐受到重视;如(图一)。
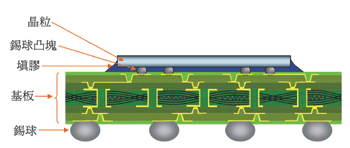
| 《图一 Flip chip BGA切面图〈数据源:图片提供:日月光〉》 |
|
覆晶封装技术之优势与应用趋势
重要性与优势
1.解决电磁相容(EMC)与电磁干扰(EMI)等问题
当电子产品功能日益提升,而电压却被要求降低时,IC设计人员便面临了如何控管晶片内晶体耗电量,以及解决电磁相容(EMC)与电磁干扰(EMI)和串音干扰( cross talk)等问题。一般而言,采用焊线封装技术的晶片,其信号传递是透过具有一定长度的金线来进行,这种方法在高频的情况下,会产生所谓的阻抗效应,形成信号行进路线上的一个障碍;但覆晶技术可以提供最短的对外连接距离,不仅提供优异的电性效能,同时可以减少元件互连间的损耗及电感,降低电磁干扰的问题,并承受较高的频率。
2.适用于1000组以上I/O的装置
当IC设计人员在相同的矽晶区域中嵌入越来越密集的电路时,I/O与针脚的数量就会迅速增加,而覆晶技术的另一项优势是可提高I/O的密度。一般而言,采用焊线技术的I/O接脚都是排列在晶粒的四周,但采用覆晶技术,I/O接脚可以阵列的方式排列在晶粒的表面,提供更高密度的I/O布局,产生最佳的使用效率,也因为这项优势,覆晶技术相较于传统封装方式面积缩小30﹪到60﹪,提高单一晶圆的晶粒产出数,进而大幅降低成本。因此,覆晶技术在需要细间距的I/O需求之晶片上,即拥有特别的应用优势,对于许多超过1000组以上I/O的装置,覆晶技术已成为最优先的选择。
(3)散热问题获得解决
在各种新世代的高时脉运作与高度整合之晶片中,散热问题亦是一大挑战。基于覆晶封装独特的封装型态,采用覆晶技术的IC之背面可接触到空气,能直接排散热量,同时基板亦可透过金属层来提高散热效率,或于IC背部加装金属散热片,更进一步强化晶粒散热的能力。
应用趋势
覆晶封装技术由于具备优越的电性效能、直接散热管道及更小的封装尺寸等特性,因此适用于高速元件,目前最常应用于中央处理器、晶片组、绘图晶片、记忆体、网路微处理器等高阶产品。
覆晶封装技术解析
覆晶封装流程
封装业者在接获完成前段制程工作的晶圆后,采用覆晶封装技术的制程大致如下:先于晶片上植入金属凸块,随后进行测试、研磨、晶圆切割成晶粒,再将晶粒放置到基板上,以高温溶化凸块,并进行填胶、烘烤、雷射标示等流程,之后于基板的另一面植球,再进行清洗、外观检查、锡球检查、最终测试等步骤,待各项流程完毕后,便加以包装出货,完成所有覆晶封装制程。参考(图二)。
综观采用覆晶技术的封装流程,我们可以发现金属凸块、基板、填胶等流程是覆晶封装过程中的关键环节。其中制作覆晶用凸块的技术包括有印刷、打线成型、电镀、喷射成型与蒸镀等,而印刷技术因具备成本低廉、生产弹性的优势,为目前最主要的制作方式之一,但若以电性(electrical)与线宽(fine-pitch)能力评估,电镀技术将是未来重要的制程方向。
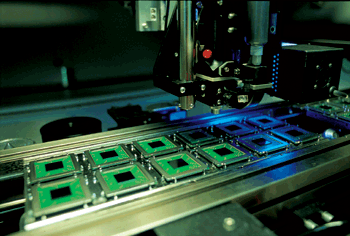
| 《图二 Flip chip制程之点胶〈数据源:图片提供:日月光〉》 |
|
覆晶封装发展方向
覆晶封装技术之所以受到重视,主要关键在于可满足新世代电子产品对轻薄短小的高度需求,并能充分发挥晶片应有的效能表现,因此覆晶技术的未来发展方向,也同样持续受到这两项因素的趋动,形成了覆晶技术朝向多脚化及薄型化的方向发展。
在脚数方面,目前采覆晶封装所能达到的I/O脚数约为1600只(42.5mm×42.5mm),预计至2003年可增加至2500只(50mm×50mm);而在晶圆的尺寸方面,目前约4mm×4mm,封装完成后的厚度为1.2mm,并将透过晶粒研磨的方式,朝1.0mm的产品厚度迈进。
一元化覆晶封装服务之优势
此外,虽然全球已有多家厂商表示可支援覆晶封装技术,但在面对此一持续演进的先进技术时,仍存在着许多的制程风险,而如何让制程中的各环节运作顺利,在在考验着客户与封装业者间的互动关系。以日月光为例,除积极强化覆晶技术之外,更整合集团整体资源,提供客户涵盖晶圆凸块、晶圆针测、覆晶组装、材料供应与后段测试的一元化覆晶解决方案,以单一的服务窗口,缩短与客户的往返沟通时间,不但提升服务品质,并以相较其他竞争厂商缩短10至20天的交货时间,协助客户降低总体成本,并掌握快速上市的市场竞争利基。参考(图三)。
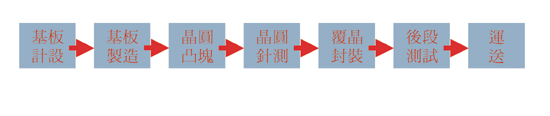
| 《图三 一元化覆晶封装服务流程图〈数据源:图片提供:日月光〉》 |
|
结论
毫无疑问的,覆晶封装技术因具有最短连接长度与最高I/O接点密度,适合应用于电性及散热效能极佳的高速元件,加上覆晶技术相较于传统封装方式面积缩小30﹪至60﹪,可相对提高单位晶圆的产能,因此被视为未来最具潜力的封装技术,也成为许多封装业者现阶段的研发重心。但在面对广大的市场需求时,专业封装服务厂商需寻求突破现阶段技术瓶颈的解决方案,致力降低作业成本,并在基板的供应稳定度,以及供应链环节的完整串联等部分持续改进,不但可提升客户对覆晶技术应用的信赖感,更使覆晶技术能以最快的发展脚步成为封装主流。
(本为作者为日月光半导体研发部副总经理)

