RoHS是来自欧洲议会(European Council)所公布的电气与电子设备废弃物(Waste from Electrical and Electronic Equipment;WEEE)指导准则,倡议在2006年後在电子产品上限制使用铅(Pb)。在日本,国际贸易与工业部已经为汽车(电池除外)设定了铅的最大使用量限制。此时日本虽然尚未立法限定在电子元件上削减铅的使用量,但在日本的电子产业已经主动选择无铅的电子元件。
依据这些建议与准则,透过与封装厂的共同努力,IC供应厂商评估了为导线架采用纯锡(Sn)与/或锡━2%铜(Cu)的导线焊料涂层的封装方式,以及为球式栅格阵列封装采用锡━3~4%银(Ag)━0.5%铜焊接球。此外还完成了测试预先电镀镍(Ni)/??(Pd)的焊料涂层。封装对热量的抵抗强度也透过选择了适当的材料与制程来加以强化,以允许在组装电路板时使用无铅(Pb-free)锡膏时需要较高温度的??焊温度适应力。
这些合格的资料证明IC供应商具有因应制程与/或材料上的改变,并能够生产大量元件的技术能力,某些经过测试的元件具有非常大的晶片尺寸,也需要面对某些独特的挑战,并非所有来自封装厂的现有可用封装程序与材料策略都可以轻易地转移,因为一般高效能元件有非常大的晶片尺寸,不同的作法可用於让零件在无铅??焊温度下更稳定,包括使用新的材料与变更制程。
对湿气敏感层级的验证
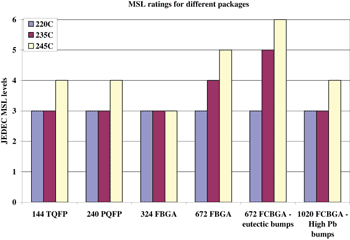
| 《图一 标准的锡-铅零件在J-STD-020标准下以不同的尖峰回焊温度下测试的MSL等级》 |
|
标准的锡、铅零件不需任何额外的修改便可在不同的湿气敏感层级(Moisture Sensitivity Levels;MSL)上符合标准的JEDEC表面黏着模拟测试,零件会在不同的尖峰??焊温度━━220℃、235℃、245℃下测试,几??所有的零件都可在220℃时符合MSL 3的标准,一些较大的零件则只可符合MSL 4标准或在较高温度时的表现较差,如(图一)。
大型零件(且有较大的晶片尺寸)的245℃尖峰??焊温度测试,在MSL 3标准下时将会造成晶片表面脱层,如(图二)。在湿气敏感度降低後便可观察到每种封装形式对应不同宽度时的变化,较小的TQFP、PQFP与细密球式栅格阵列(FBGA)封装将可以抵抗245℃的??焊,在这个例子的覆晶(flip-chip)BGA(FCBGA)则产生底胶脱层与焊锡膏渣,如(图三),可观察到锡膏接点产生熔解的现象,当使用较高的铅焊点时,在35mm与更小尺寸下的所有零件在245℃时都没有产生底胶脱层的现象。想要增进可生产性,期??所有零件都可以达到MSL 3等级,想要达到这个目标,则每种封装形式都有必要为达到不同的目标而做一些修改,不同的厂商会根据零件的尺寸,需要零件能够达到245℃到260℃的尖峰??焊温度的标准。
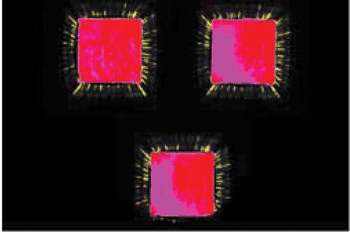
| 《图二 在未经过材料/制程修改之下,大型的QFP与FBGA封装中的芯片表面脱层观察》 |
|

| 《图三 在245℃尖峰回焊温度的条件下,组合低熔点焊锡时观察到底胶脱层与焊锡延展/膏渣的现象》 |
|
对QFP封装来说,新的铸造混合方式与晶片连接材料可用於避免接囗处表面脱层与爆裂导致封装失败,部分的增强来自於新材料有较低的湿气吸收程度,并且机械模拟模型也指出这些材料让零件在经过整个??焊温度范围下有较低的翘曲,因此也可对所有的介面处产生较小的压力。在JEDEC MSL 3条件下使用新的材料可以完成所有的TQFP与PQFP封装,如(图四)。在所有的例子中,都使用标准的导线架,无铅的电镀层都是使用纯锡(Matte Sn)或锡━2%铜。
以所有FBGA封装的例子来看,铸造混合方式与晶片连接可以使用一些较小变化的标准锡/铅组合,在245℃??焊温度之下,所有的元件在19mm或更小的FBGA封装之下测试,可以符合JEDEC MSL 3的标准。然而,较大的FBGA封装与当尖峰??焊温度高於245℃时,则可观察到晶片表面脱层,并需要额外的修改过程。所有的元件都在晶片表面有聚??涞(polyamide)涂层,因为在非常大的晶片尺寸之下,是不可能没有采用聚??涞涂层还可通过MSL等级的。
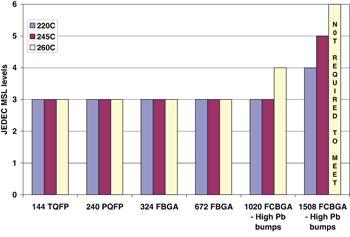
| 《图四 经过材料与组合流程增进的MSL等级排名,大多数零件都可符合MSL 3达到260℃尖峰回焊温度》 |
|
这两种制程更动都有助於铸造混合到晶片表面的黏着性,最隹化的预先铸造方式与晶片表面电浆清除步骤,也可用於增进铸造混合到晶片表面的黏着性。可确定的是表面粗糙性必须被最隹化以确保有好的黏着性,如(图五)。有了这些增进,大部分元件在FBGA封装时都有可能达到JEDEC MSL 3等级。这边有一些公开的报告指出AUS5防焊绿漆(solder mask)在无铅封装下无法达到尖峰??焊温度的要求,为了这个原因,在基板上对AUS5、AUS303与AUS308防焊绿漆进行验证,在测试中,所有测试的组合中并没有观察到失败是跟防焊绿漆有关。

| 《图五 从供货商得到的数据显示在铸造混合方式到粗糙芯片表面的黏着性(具有聚酰胺涂层)强化,是由于固定时间进行电浆清洁所带来的作用》 |
|
FC-BGA显然是想要达到JEDEC MSL 3标准的最困难的封装方式,就算是在预先处理过的状况下并没有发现失败的现象,但零件通常会在周期性条件B的压力下在500次温度周期之後发生失败,典型的失败模式是在晶片的角落发生底胶脱层,如(图六),其使用了20mm与更大的晶片尺寸,并具有6000个或更多的焊接点,以增加额外的复杂性。
正确的材料选择是达到MSL需求的重要关键,将在可制造层级下保持零件的共面度,在最初的测试中,很明显的熔点低的锡/铅焊接点是不能用於超过225℃的??焊温度。在底胶中的流体静力压力在??焊温度下将会造成焊锡熔解,并沿着晶片表面溢出,这对零件是个严重的问题,它只能在乾燥的条件下才能在??焊时存活,为了这个与其它的理由,选择为产品使用高铅凸块与预先焊接,整体的焊接凸块组合可符合欧洲要求在焊接交界处采用大於85%的铅。更软的高铅凸块意味着焊接点之间的承载张力将会最小,不同的是,环式承载将在高铅到熔点低的锡/铅介面之间造成抽运效应(pumping effect),造成失效与焊接点交接处开启。

| 《图六 芯片角落脱层常见于采用旧型材料做大型芯片覆晶封装时,其失败模式在220℃与245℃回焊时都可见到》 |
|
想要在焊接点交界处最小化张力与减低压力,一组新的材料被选用於底胶、散热膏与胶黏剂,模拟模型也被用於辨识出最隹的材料特性,用於建构无铅(仅有外部)覆晶所选择的材料,可将大多数的FC-BGA列入JEDEC湿气层级3,针对非常大的晶片(单边就有23mm)与封装尺寸(实体有40mm),在此时就算有所增强也只能在245℃达到JEDEC层级5A。

| 《图七 用于780个接脚FC-BGA封装表面黏着的回焊配置文件》 |
|
<图注:尖峰??焊温度是236℃,元件是在大气中黏着,达到熔点的时间为70秒,断面图显示了焊接点的状况>
除了标准零件等级测试之外,每个零件的每种封装形式都可被黏着到PC电路板以验证焊接点是否稳固,元件是使用10区生产??焊炉来焊接到PC电路板上,在??焊过程中??焊炉都有使用氮气来加以净化,并且??焊的设定档都是个别为每个元件进行最隹化。Kester 256-LF是硷性免清洗焊剂,用於黏着所有的元件。零件同时都有采用或不采用氮气的环境来评估出零件可以被黏着的最低温度,其代表的设定档如(图七)所示。
除了标准的电路板组装之外,重工(rework)组装也在无铅零件中被加以研究,大型零件电路板组装的尖峰温度需求,就算在大气中黏着也可以低到235℃,焊接点的断面图如(图八)所示,从断面图可以清楚地看到大型零件可以在温度低到235℃时被黏着,就算大型电路板温度在15℃之间变动,在电路板上的任何点上,不超过250℃的尖峰温度,零件仍然有很大的机会可以黏着上去。依据我们的见解,所有的零件都用260℃来??焊,对零件供应商带来过大且没有必要的负担。

| 《图八 780个接脚FCBGA组件的断面图显示在以235℃尖峰回焊温度下很好的无铅焊接点形状》 |
|

| 《图九 PQFP组件采用纯锡焊料涂层导线的高放大倍率视图》 |
|
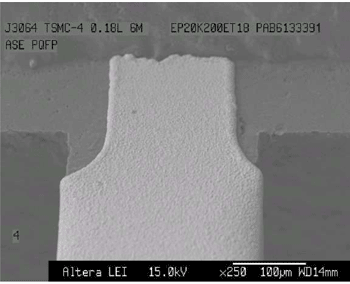
| 《图十 PQFP组件采用锡-2%铜焊料涂层导线的高放大倍率视图》 |
|
无铅??焊的零件翘曲
零件翘曲在非常大的BGA零件的制造能力上扮演着关键性的角色,从某些研究上显示出进入的湿气是更进一步增加翘曲的因素,在例子中,所有大型的BGA是使用覆晶的方式互联,研究大型覆晶元件在有与没有湿气进入封装中导致翘曲的行为特性,FC-BGA在室温中天生便有最高的翘曲特性,并在??焊温度时会有弄平的倾向,因此在室温与乾燥及湿气进入元件之间量测翘曲的程度,可以观察到大约有10%差异,若元件进入湿气到??焊温度时则翘曲现象会持续增高,随後的C-SAM分析显示封装并没有脱层,并且元件在烘烤时有减少翘曲,与乾燥的元件相较几??不易察觉出翘曲现象。
然而,没有一个例子的翘曲会超过8密尔(mils,千分之一英寸)的规格,在乾燥与湿气进入元件时,以室温与在尖峰??焊温度所做的翘曲量测如(图十一)与(图十二)所示。量测是在一个33mm的封装上完成,相似的结果也可以在27mm接合线FBGA封装中观察到。
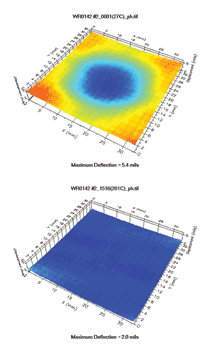
| 《图十一 在30℃与60%RH(相对湿度)下,在湿气进入192个小时之后,对一个33mm封装进行量测》 |
|
结论
经过数年的无铅研究得出在电子产业并没有单一解决方案可以取代铅━锡焊接的结论,然而,产业已经接受使用低熔点的锡━银━铜做为焊锡球,以及纯锡用於导线焊料涂层。以这些焊料涂层来测试零件,以确定大多数的零件都可以稳定地被制造,并组装到电路板上。
另外,对零件组装程序与材料的适当修改,已经可以稳定地以TQFP、PQFP、FBGA与FC-BGA封装系列来制造,而260℃??焊温度的需求是太过度了,并且电路板可以被组装与重工而不会超过250℃的尖峰??焊温度,此外,完成在大型覆晶BGA的翘曲研究,显示湿气进入对零件的湿气等级排名扮演着决定性的角色。(作者任职於Altera)
|
 |
欧盟国家於2002年11月8日完成电气及电子设备废弃物处理法,并於2003年1月27日公布《报废电子电气设备指令》(WEEE-2002/96/EC)和《关於在电子电气设备中禁止使用某些有害物质指令》(RoHS-2002/95/EC),其主要目的是减少电气及电子设备的废弃物并建立回收及再利用系统。相关介绍请见「
有关COSEL电源符合电子产品有害物质限制指令」一文。 |
 |
自从欧盟於2003年2月13日公布废电子电机设备(WEEE)及电子电机设备中危害物质禁用(RoHS)二个指令後,国内外各大厂商莫不全神贯注於後续之发展,唯欧盟各国之国内法律、规则及行政规定须於2004年8月13日(指令公布後18个月)方制定完成并生效,是故目前各国之立法进度不一,有的国家已完成草案阶段,部份国家正立法讨论中。你可在「
RoHS介绍
」一文中得到进一步的介绍。
|
 |
对於欧盟有关环保的指令,只会要求愈来愈多,且愈来愈严格。而仿效欧盟的国家也会愈来愈多,如中国大陆就完全比照欧盟RoHS之要求,并与欧盟同步实施;至於日本,要求则更甚於欧盟。在「
RoHS、WEEE指令引爆绿色竞争力」一文为你做了相关的评析。 |
未来智慧手机的电源管理技术
|
|
 |
|
|
 |
2005年08月在全球愈来愈重视绿色工业的环境保护观念之下,许多国家开始逐渐实施RoHS指令,PQI的DOM(DiskOnModule)矽碟机模组产品为符合RoHS指令的标准,已於2004年第三季在生产线上导入新制程,在今年第二季所生产的DOM产品陆续达成该指令的要求。相关介绍请见「PQI重视绿色工业? 积极推动DOM矽碟机模组符合RoHS,并推出高速DOM产品」一文。
|
 |
欧盟即将实施「废电机电子设备指令」(WEEE)与「危害物质禁限用指令」(RoHS),以管制电机电子产品对地球环境造成的负面影响。你可在「
经济部「RoHS服务团」协助产业因应欧盟环保新指令」一文中得到进一步的介绍。 |
 |
欧盟将从今年8月中起陆续实施WEEE及RoHS等环保指令,直接冲击我国每年输欧电机电子产品约2500亿元,经济部工业局调查国内已有约63%厂商进行WEEE因应,但有37%厂商尚未因应;另有87%厂商已因应RoHS,13%厂商尚未因应,目前因应较不理想的第三及第四线供应商将是辅导协助重点。在「
欧盟实施WEEE及RoHS等环保指令87%厂商已因应RoHS」一文为你做了相关的评析。
|
|
|
 |