RoHS是來自歐洲議會(European Council)所公佈的電氣與電子設備廢棄物(Waste from Electrical and Electronic Equipment;WEEE)指導準則,倡議在2006年後在電子產品上限制使用鉛(Pb)。在日本,國際貿易與工業部已經為汽車(電池除外)設定了鉛的最大使用量限制。此時日本雖然尚未立法限定在電子元件上削減鉛的使用量,但在日本的電子產業已經主動選擇無鉛的電子元件。
依據這些建議與準則,透過與封裝廠的共同努力,IC供應廠商評估了為導線架採用純錫(Sn)與/或錫-2%銅(Cu)的導線焊料塗層的封裝方式,以及為球式柵格陣列封裝採用錫-3~4%銀(Ag)-0.5%銅焊接球。此外還完成了測試預先電鍍鎳(Ni)/鈀(Pd)的焊料塗層。封裝對熱量的抵抗強度也透過選擇了適當的材料與製程來加以強化,以允許在組裝電路板時使用無鉛(Pb-free)錫膏時需要較高溫度的迴焊溫度適應力。
這些合格的資料證明IC供應商具有因應製程與/或材料上的改變,並能夠生產大量元件的技術能力,某些經過測試的元件具有非常大的晶片尺寸,也需要面對某些獨特的挑戰,並非所有來自封裝廠的現有可用封裝程序與材料策略都可以輕易地轉移,因為一般高效能元件有非常大的晶片尺寸,不同的作法可用於讓零件在無鉛迴焊溫度下更穩定,包括使用新的材料與變更製程。
對濕氣敏感層級的驗證
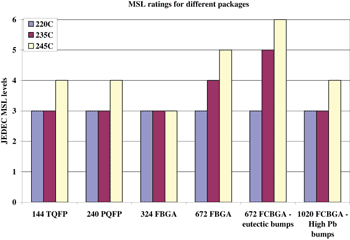
| 《圖一 標準的錫-鉛零件在J-STD-020標準下以不同的尖峰迴焊溫度下測試的MSL等級》 |
|
標準的錫、鉛零件不需任何額外的修改便可在不同的溼氣敏感層級(Moisture Sensitivity Levels;MSL)上符合標準的JEDEC表面黏著模擬測試,零件會在不同的尖峰迴焊溫度──220℃、235℃、245℃下測試,幾乎所有的零件都可在220℃時符合MSL 3的標準,一些較大的零件則只可符合MSL 4標準或在較高溫度時的表現較差,如(圖一)。
大型零件(且有較大的晶片尺寸)的245℃尖峰迴焊溫度測試,在MSL 3標準下時將會造成晶片表面脫層,如(圖二)。在濕氣敏感度降低後便可觀察到每種封裝形式對應不同寬度時的變化,較小的TQFP、PQFP與細密球式柵格陣列(FBGA)封裝將可以抵抗245℃的迴焊,在這個例子的覆晶(flip-chip)BGA(FCBGA)則產生底膠脫層與焊錫膏渣,如(圖三),可觀察到錫膏接點產生熔解的現象,當使用較高的鉛焊點時,在35mm與更小尺寸下的所有零件在245℃時都沒有產生底膠脫層的現象。想要增進可生產性,期望所有零件都可以達到MSL 3等級,想要達到這個目標,則每種封裝形式都有必要為達到不同的目標而做一些修改,不同的廠商會根據零件的尺寸,需要零件能夠達到245℃到260℃的尖峰迴焊溫度的標準。
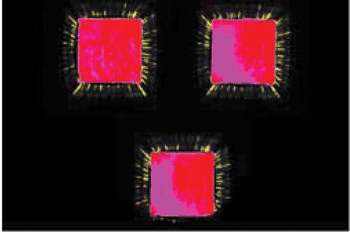
| 《圖二 在未經過材料/製程修改之下,大型的QFP與FBGA封裝中的晶片表面脫層觀察》 |
|

| 《圖三 在245℃尖峰迴焊溫度的條件下,組合低熔點焊錫時觀察到底膠脫層與焊錫延展/膏渣的現象》 |
|
對QFP封裝來說,新的鑄造混合方式與晶片連接材料可用於避免接口處表面脫層與爆裂導致封裝失敗,部分的增強來自於新材料有較低的溼氣吸收程度,並且機械模擬模型也指出這些材料讓零件在經過整個迴焊溫度範圍下有較低的翹曲,因此也可對所有的介面處產生較小的壓力。在JEDEC MSL 3條件下使用新的材料可以完成所有的TQFP與PQFP封裝,如(圖四)。在所有的例子中,都使用標準的導線架,無鉛的電鍍層都是使用純錫(Matte Sn)或錫-2%銅。
以所有FBGA封裝的例子來看,鑄造混合方式與晶片連接可以使用一些較小變化的標準錫/鉛組合,在245℃迴焊溫度之下,所有的元件在19mm或更小的FBGA封裝之下測試,可以符合JEDEC MSL 3的標準。然而,較大的FBGA封裝與當尖峰迴焊溫度高於245℃時,則可觀察到晶片表面脫層,並需要額外的修改過程。所有的元件都在晶片表面有聚醯胺(polyamide)塗層,因為在非常大的晶片尺寸之下,是不可能沒有採用聚醯胺塗層還可通過MSL等級的。
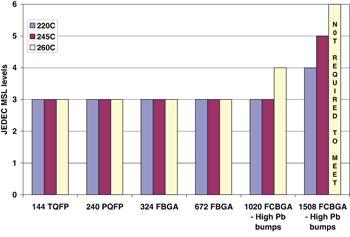
| 《圖四 經過材料與組合流程增進的MSL等級排名,大多數零件都可符合MSL 3達到260℃尖峰迴焊溫度》 |
|
這兩種製程更動都有助於鑄造混合到晶片表面的黏著性,最佳化的預先鑄造方式與晶片表面電漿清除步驟,也可用於增進鑄造混合到晶片表面的黏著性。可確定的是表面粗糙性必須被最佳化以確保有好的黏著性,如(圖五)。有了這些增進,大部分元件在FBGA封裝時都有可能達到JEDEC MSL 3等級。這邊有一些公開的報告指出AUS5防焊綠漆(solder mask)在無鉛封裝下無法達到尖峰迴焊溫度的要求,為了這個原因,在基板上對AUS5、AUS303與AUS308防焊綠漆進行驗證,在測試中,所有測試的組合中並沒有觀察到失敗是跟防焊綠漆有關。

| 《圖五 從供應商得到的資料顯示在鑄造混合方式到粗糙晶片表面的黏著性(具有聚醯胺塗層)強化,是由於固定時間進行電漿清潔所帶來的作用》 |
|
FC-BGA顯然是想要達到JEDEC MSL 3標準的最困難的封裝方式,就算是在預先處理過的狀況下並沒有發現失敗的現象,但零件通常會在週期性條件B的壓力下在500次溫度週期之後發生失敗,典型的失敗模式是在晶片的角落發生底膠脫層,如(圖六),其使用了20mm與更大的晶片尺寸,並具有6000個或更多的焊接點,以增加額外的複雜性。
正確的材料選擇是達到MSL需求的重要關鍵,將在可製造層級下保持零件的共面度,在最初的測試中,很明顯的熔點低的錫/鉛焊接點是不能用於超過225℃的迴焊溫度。在底膠中的流體靜力壓力在迴焊溫度下將會造成焊錫熔解,並沿著晶片表面溢出,這對零件是個嚴重的問題,它只能在乾燥的條件下才能在迴焊時存活,為了這個與其它的理由,選擇為產品使用高鉛凸塊與預先焊接,整體的焊接凸塊組合可符合歐洲要求在焊接交界處採用大於85%的鉛。更軟的高鉛凸塊意味著焊接點之間的承載張力將會最小,不同的是,環式承載將在高鉛到熔點低的錫/鉛介面之間造成抽運效應(pumping effect),造成失效與焊接點交接處開啟。

| 《圖六 晶片角落脫層常見於採用舊型材料做大型晶片覆晶封裝時,其失敗模式在220℃與245℃迴焊時都可見到》 |
|
想要在焊接點交界處最小化張力與減低壓力,一組新的材料被選用於底膠、散熱膏與膠黏劑,模擬模型也被用於辨識出最佳的材料特性,用於建構無鉛(僅有外部)覆晶所選擇的材料,可將大多數的FC-BGA列入JEDEC溼氣層級3,針對非常大的晶片(單邊就有23mm)與封裝尺寸(實體有40mm),在此時就算有所增強也只能在245℃達到JEDEC層級5A。

| 《圖七 用於780個接腳FC-BGA封裝表面黏著的迴焊設定檔》 |
|
<圖註:尖峰迴焊溫度是236℃,元件是在大氣中黏著,達到熔點的時間為70秒,斷面圖顯示了焊接點的狀況>
除了標準零件等級測試之外,每個零件的每種封裝形式都可被黏著到PC電路板以驗證焊接點是否穩固,元件是使用10區生產迴焊爐來焊接到PC電路板上,在迴焊過程中迴焊爐都有使用氮氣來加以淨化,並且迴焊的設定檔都是個別為每個元件進行最佳化。Kester 256-LF是鹼性免清洗焊劑,用於黏著所有的元件。零件同時都有採用或不採用氮氣的環境來評估出零件可以被黏著的最低溫度,其代表的設定檔如(圖七)所示。
除了標準的電路板組裝之外,重工(rework)組裝也在無鉛零件中被加以研究,大型零件電路板組裝的尖峰溫度需求,就算在大氣中黏著也可以低到235℃,焊接點的斷面圖如(圖八)所示,從斷面圖可以清楚地看到大型零件可以在溫度低到235℃時被黏著,就算大型電路板溫度在15℃之間變動,在電路板上的任何點上,不超過250℃的尖峰溫度,零件仍然有很大的機會可以黏著上去。依據我們的見解,所有的零件都用260℃來迴焊,對零件供應商帶來過大且沒有必要的負擔。

| 《圖八 780個接腳FCBGA元件的斷面圖顯示在以235℃尖峰迴焊溫度下很好的無鉛焊接點形狀》 |
|

| 《圖九 PQFP元件採用純錫焊料塗層導線的高放大倍率視圖》 |
|
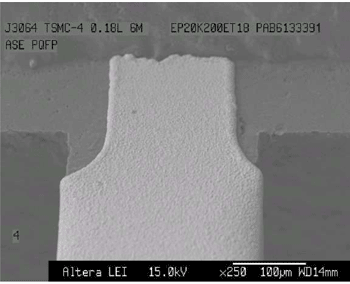
| 《圖十 PQFP元件採用錫-2%銅焊料塗層導線的高放大倍率視圖》 |
|
無鉛迴焊的零件翹曲
零件翹曲在非常大的BGA零件的製造能力上扮演著關鍵性的角色,從某些研究上顯示出進入的溼氣是更進一步增加翹曲的因素,在例子中,所有大型的BGA是使用覆晶的方式互聯,研究大型覆晶元件在有與沒有溼氣進入封裝中導致翹曲的行為特性,FC-BGA在室溫中天生便有最高的翹曲特性,並在迴焊溫度時會有弄平的傾向,因此在室溫與乾燥及濕氣進入元件之間量測翹曲的程度,可以觀察到大約有10%差異,若元件進入濕氣到迴焊溫度時則翹曲現象會持續增高,隨後的C-SAM分析顯示封裝並沒有脫層,並且元件在烘烤時有減少翹曲,與乾燥的元件相較幾乎不易察覺出翹曲現象。
然而,沒有一個例子的翹曲會超過8密爾(mils,千分之一英吋)的規格,在乾燥與溼氣進入元件時,以室溫與在尖峰迴焊溫度所做的翹曲量測如(圖十一)與(圖十二)所示。量測是在一個33mm的封裝上完成,相似的結果也可以在27mm接合線FBGA封裝中觀察到。
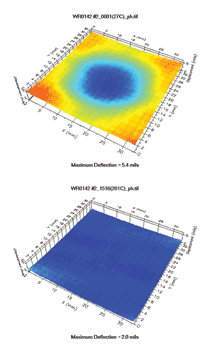
| 《圖十一 在30℃與60%RH(相對溼度)下,在濕氣進入192個小時之後,對一個33mm封裝進行量測》 |
|
結論
經過數年的無鉛研究得出在電子產業並沒有單一解決方案可以取代鉛-錫焊接的結論,然而,產業已經接受使用低熔點的錫-銀-銅做為焊錫球,以及純錫用於導線焊料塗層。以這些焊料塗層來測試零件,以確定大多數的零件都可以穩定地被製造,並組裝到電路板上。
另外,對零件組裝程序與材料的適當修改,已經可以穩定地以TQFP、PQFP、FBGA與FC-BGA封裝系列來製造,而260℃迴焊溫度的需求是太過度了,並且電路板可以被組裝與重工而不會超過250℃的尖峰迴焊溫度,此外,完成在大型覆晶BGA的翹曲研究,顯示濕氣進入對零件的溼氣等級排名扮演著決定性的角色。(作者任職於Altera)
|
 |
歐盟國家於2002年11月8日完成電氣及電子設備廢棄物處理法,並於2003年1月27日公佈《報廢電子電氣設備指令》(WEEE-2002/96/EC)和《關於在電子電氣設備中禁止使用某些有害物質指令》(RoHS-2002/95/EC),其主要目的是減少電氣及電子設備的廢棄物並建立回收及再利用系統。相關介紹請見「
有關COSEL電源符合電子產品有害物質限制指令」一文。 |
 |
自從歐盟於2003年2月13日公佈廢電子電機設備(WEEE)及電子電機設備中危害物質禁用(RoHS)二個指令後,國內外各大廠商莫不全神貫注於後續之發展,唯歐盟各國之國內法律、規則及行政規定須於2004年8月13日(指令公佈後18個月)方制定完成並生效,是故目前各國之立法進度不一,有的國家已完成草案階段,部份國家正立法討論中。你可在「
RoHS介紹
」一文中得到進一步的介紹。
|
 |
對於歐盟有關環保的指令,只會要求愈來愈多,且愈來愈嚴格。而仿傚歐盟的國家也會愈來愈多,如中國大陸就完全比照歐盟RoHS之要求,並與歐盟同步實施;至於日本,要求則更甚於歐盟。在「
RoHS、WEEE指令引爆綠色競爭力」一文為你做了相關的評析。 |
未來智慧手機的電源管理技術
|
|
 |
|
|
 |
2005年08月在全球愈來愈重視綠色工業的環境保護觀念之下,許多國家開始逐漸實施RoHS指令,PQI的DOM(DiskOnModule)矽碟機模組產品為符合RoHS指令的標準,已於2004年第三季在生產線上導入新製程,在今年第二季所生產的DOM產品陸續達成該指令的要求。相關介紹請見「PQI重視綠色工業? 積極推動DOM矽碟機模組符合RoHS,並推出高速DOM產品」一文。
|
 |
歐盟即將實施「廢電機電子設備指令」(WEEE)與「危害物質禁限用指令」(RoHS),以管制電機電子產品對地球環境造成的負面影響。你可在「
經濟部「RoHS服務團」協助產業因應歐盟環保新指令」一文中得到進一步的介紹。 |
 |
歐盟將從今年8月中起陸續實施WEEE及RoHS等環保指令,直接衝擊我國每年輸歐電機電子產品約2500億元,經濟部工業局調查國內已有約63%廠商進行WEEE因應,但有37%廠商尚未因應;另有87%廠商已因應RoHS,13%廠商尚未因應,目前因應較不理想的第三及第四線供應商將是輔導協助重點。在「
歐盟實施WEEE及RoHS等環保指令87%廠商已因應RoHS」一文為你做了相關的評析。
|
|
|
 |