诺发系统(Novellus)日前宣布开发出一种创新的DirectFill化学气相沉积氮化钨(WN)线性阻隔膜,取代传统的物理气相沉积(PVD)金属钛及有机化学气相沉积法(MOCVD)氮化钛堆积成线性阻隔薄膜用于先进内存组件的钨接触传导和铜线互连传导应用。氮化钨(WN)薄膜沉积使用诺发系统的ALTUS多平台序列沉积(MSSD)架构及脉冲成核(PNL)专利技术。该 DirectFill制程沉积超薄,20埃氮化钨(WN)比传统的物理气相沉积厚200埃氮化钛和钛堆栈,拥有更薄更好的膜电阻率和阻隔性能。这种超薄膜降低了钨电阻高达百分之三十,并扩展钨技术超越3Xnm的技术节点。
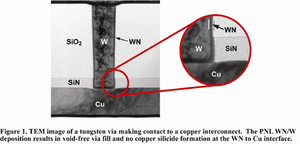 |
| 图为使用诺发系统的ALTUS多平台序列专利技术缩小尺寸到3Xnm技术节点以下的局部显示 BigPic:500x240 |
随着更快、更节能的存储元件功能和组件体积收缩方面的需求日益增加,进而导致要求将铜连接线制程整合到闪存(FLASH)和易失存储器(DRAM)装置。但是对于第一金属层还是沿用传统的铝制程之整合钨接触的链接信道使从第一层到铜及铝层。但若进而缩小尺寸到3Xnm技术节点以下,此一气相沉积钨的接触信道整合技术就会受到传统钛/氮化钛线兴隔绝层堆积产生的瓶颈效应的挑战。物理气相沉积钛在信道口的突起沉积减少了通过开放口的面积,可导致不完整的化学气相沉积钨填充,造成信道中间有不完整充填的空隙。金属有机化学气相沉积氮化钛TiN薄膜必须沉淀到的最小厚度,以防止硅烷气体(钨塞填充过程中使用的气体)扩散并在信道接口形成高电阻率铜硅化物。

