中國半導體產業計畫讓IC產值在未來5~6年占到全球的三分之一,而這一點若想實現,必須依賴於半導體製造行業的崛起。2019年10月22日,大基金二期成立。基金總裁丁文武曾指出,大基金二期將對於刻蝕機、薄膜設備、測試設備和清洗設備等領域已佈局的企業傾力重點支持,以推動龍頭企業,形成系列化、成套化裝備產品。更加快開展光刻機、化學機械研磨設備等核心設備及關鍵零部件的投資佈局,保障產業鏈安全。
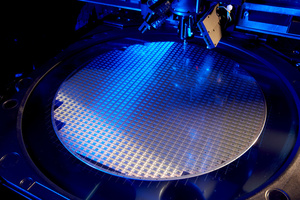 |
| 盛美半導體近期發佈適用於晶圓級先進封裝應用的無應力拋光解決方案。 |
半導體和晶圓級封裝設備供應商盛美半導體近期發佈新產品,是適用於晶圓級先進封裝應用(Wafer Level Advance Package)的無應力拋光(Stree-Free-Polish)解決方案。先進封裝級無應力拋光(Ultra SFP ap)設計用於解決先進封裝中,矽穿孔(TSV)和扇出(FOWLP)應用金屬平坦化製程中,表層銅層過厚引起晶圓翹曲的問題。
先進封裝級無應力拋光技術來源於盛美半導體的無應力拋光技術(Ultra SFP),該技術整合了無應力拋光(SFP)、化學機械研磨(CMP)、和濕法刻蝕制程(Wet-Etch)。晶圓通過這三步製程,在化學機械研磨和濕法刻蝕制程前,採用電化學方法無應力去除晶圓表面銅層,釋放晶圓的應力。此外,電化學拋光液的回收使用,和先進封裝級無應力拋光技術能顯著的降低化學和耗材使用量,保護環境的同時降低設備使用成本。
盛美半導體設備有限公司董事長王暉博士說,我們在2009年開發了無應力拋光技術,這一技術隨著先進封裝矽穿孔和扇出制程的高速發展,對於環境保護和降低制程運營成本的需求日益增加,為我們先進封裝級無應力拋光制程提供了理想的應用市場。
盛美半導體在2019年第四季度已交付一台先進封裝級無應力拋光設備至中國晶圓級封裝龍頭企業。在2020年度這台設備將在先進封裝用戶端進行測試和驗證,該公司期待在2020年中完成設備的首輪測試驗證,並進一步進入用戶端量產生產線進行量產驗證,完成客戶驗收。
無應力拋光技術可以被認為盛美半導體的電化學電鍍技術的一個反向技術,均基於電化學原理,晶圓被固定在夾具上旋轉,並與拋光電源相連接作為陽極;同時電化學拋光液被噴射至晶圓表面,在電流作用下金屬離子從晶圓表面被去除。在矽穿孔和扇出制程應用中,先進封裝級無應力拋光技術通過三步制程,有效的解決其他制程所引起的晶圓應力。
在矽穿孔制程中,首先採用無應力拋光制程去除表層的電鍍沉積後的銅層,保留0.2μm厚度;然後採用化學機械研磨制程進行平坦化將剩餘銅層去除,停止至鈦阻擋層;最後使用濕法刻蝕制程將暴露於表面的非圖形結構內鈦阻擋層去除,露出阻擋層下層的氧化層。在扇出制程中的再佈線層(RDL)平坦化應用中,同樣的制程能夠被採用,用於釋放晶圓應力,去除表層銅層和阻擋層。
基於電化學拋光液和濕法刻蝕液能夠通過化學回收系統即時回收使用,先進封裝級無應力拋光制程能夠顯著的節省制程使用成本。此外化學回收系統也能夠集中收集從銅層中提取的高純度金屬,可以再次利用于其他應用中,提供可持續發展的環保解決方案。

