IGBT由初始的Planar演进至第四代的Trench,现在又有人提出第五代Thin Wafer制程。随着制程及设计的进步,IGBT的触角正逐渐深入高频及高功率的领域,扩张其版图。可预见的是,IGBT的性能将会继续改进,成为功率组件的主流。
在讲求高效率及节省能源的今天,如何有效的运用生活中不可或缺的电,成为一个新的课题。现代的社会对电的依赖性越来越高,从小型的收音机、电视机至大型的空调冷却系统、高速火车,都需用到电力。如何利用输入的电力,加以控制,并有效率的将之转换为我们所需要的输出形式,实有赖于功率组件(Power Device)的技术。(图一)显示半导体功率组件已被广泛的用在许多的用途中,包括电源供应器、汽车、显示器、通讯电子、照明、工厂自动化、马达控制等等。
我们可以看到功率组件应用的范围相当广,电压由数十伏特至数千甚至上万伏特,而电流则可从数个毫安至数百或上千安培。当然,不可能有一个组件可以适用所有的用途。因此根据不同的功率要求就有不同结构的组件被发明。(图二)显示不同功率及频率的要求下,所适用的组件结构。除了一些超高功率的应用外,其余的应用几乎被IGBT与MOSFET所涵盖。在分类上,IGBT适用于较低频及较高功率的应用,而MOSFET则适合用在高频与低功率的范围。当然MOSFET也可以用在高功率的地方,不过其效率会急剧的下降。同理,IGBT也不适合用在低功率的地方。
值得注意的是,我们可以看到以前盛行的功率双载子晶体管,已经被IGBT(高功率区)与功率MOSFET(低功率区)所取代了。这是因为功率双载子晶体管是由电流驱动,控制电路太过复杂,不易设计。而IGBT及MOSFET则是由电压控制,可大幅简化控制电路的设计。所以IGBT与MOSFET已成为目前功率组件应用的主流。本篇文章的重点是讲解IGBT操作原理,与设计时应注意的事项,适合想发展IGBT技术的读者。文末则以离散组件的市场预测说明IGBT是有前途的功率组件。
IGBT与Power MOS之比较
(图三)为传统IGBT与Power MOS的剖面图。依组件的结构来看,IGBT与Power MOS非常相近,两者的差别是在底部的N+与P+。Power MOS的操作与一般的MOS并无二致。为了增加耐高电压的能力,N-这一层需增厚,同时浓度也需变淡。但N-层一增厚,从D至S的串联电阻就变大,所以这限制了Power MOS导通电流的能力,因此一般Power MOS是用在高频但低功率的地方。
为了要克服此一缺点,就有IGBT的出现。在结构上,IGBT可说是结合了Bipolar与MOS(但在原理上并不完全是)。在正常操作下,P+与N-的Junction会顺向偏压,因此会有大量的电洞注入N-,使得N-的电阻降低,因此大大的减少从C至E的串联电阻,所以IGBT可以应用在高电流的地方。但这也正是IGBT的缺点。
因为电洞在N-是属于少数载子,组件关闭时需完全被移走,否则组件无法关闭。当G(闸极)关闭时,电子不再从E注入,因此电洞的移走必须靠Recombination,这是一个费时的过程。所以IGBT的操作频率要比Power MOS低,以上可说是两者的最大不同,先给读者一个基本的概念。另一个有趣的地方是,既然P+与N-是顺向偏压,那P+应为Emitter才是。这是因为IGBT在设计之初是为了取代Bipolar,因此在接脚的命名上要与Bipolar相同,这样替换时才方便,因此就有这种看似与操作原理相反的命名法。
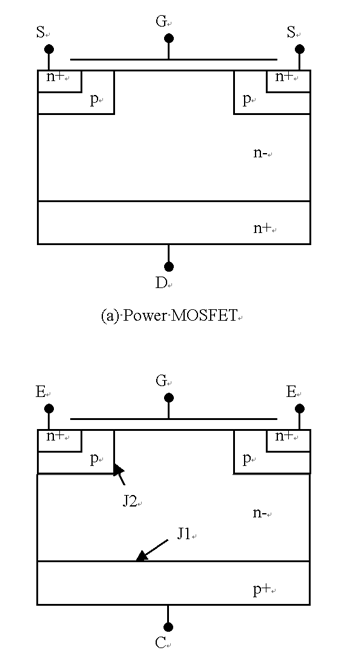
| 《图三 传统IGBT与Power MOS的剖面图》 |
|
IGBT的操作要求
在正常的导通状况下,IGBT的电流是受MOS的电压所控制的。下面各小节将叙述IGBT的一些操作上的专有名词与要求。
Forward Blocking Voltage
当闸极关闭时,C、E间所能承受的最大顺向电压(VCE〈0)即为Forward Blocking Voltage。此时,J2是处于逆向偏压,因此崩溃电压(Breakdown Voltage)由它决定。
Reverse Blocking Voltage
当闸极关闭时,C、E间所能承受的最大逆向电压(VCE〈0)即为Reverse Blocking Voltage。在DC的环境操作时,这种现象是不会发生的。但如果应用在交流的环境,就需考虑这种特性。此时崩溃电压由J1决定。
Forward Conduction
即IGBT导通时的特性。IGBT导通电流有两个路径:一个是电洞由P+跑到N-中与由MOS Channel跑来的电子结合产生电流。另一个路径是电洞由P+穿过N-,直接跑到P-Base,而把流经MOS的电流当作是Base电流。实际上,IGBT的特性应是由这两种效应来决定,无法分离。在导通时,最重要的就是导通电阻(或电压)。因为此时IGBT承受很大的电流,若导通电压大,则IGBT本身所消耗的功率也大,这不仅影响能源利用效率,同时散热也是一大问题。只要能够尽量降低这些压降,就可减少IGBT本身的功率消耗。
Forward Biased Safe Operating Area(FBSOA)
这是在某一闸极电压下(导通的情况),IGBT所能承受的最大电压与电流之作图。FBSOA受两个因素所限制:(1)Avalanche breakdown,情形与Forward Blocking相似;(2)Latch-Up,由于电流高,IGBT的温度会上升,使得上层寄生之NPN Bipolar导通(由于Gain增大及P-Base电阻增大),进而产生Latch-Up。其中,以Latch-Up为FBSOA的主要决定因素。
Reverse Biased Safe Operating Area(RBSOA)
这主要是由transient的效应所引起的。当闸极刚关闭时,电子电流会停止,但Collector的电流却不会马上停止,这是因为需要提供电洞与N-的电子结合,所以此时的电流全部是电洞电流。这会产生两个影响:(1)电洞带正电,会增强N-内的电场,而产生Breakdown;(2)大量的电洞电流,会触发Latch-Up。降低PNP Bipolar的Gain有助于电洞电流的减少。
Short-Circuit Safe Operating Area(SCSOA)
这也是由Transient的效应所引起的。当闸极刚打开时,此时Depletion Region仍然存在,因此IGBT上跨着极大的电压。同时电流急剧上升,使得IGBT同时承受大电压、大电流,温度上升的极快,进而造成组件的损坏。SCSOA就是表示IGBT能够忍受这种情况多久,而不会损坏。
IGBT之设计重点
导通电阻
当然,首要的重点是降低导通电阻。由于IGBT需耐高电压,N-都相当厚,因此电阻相当大。所幸IGBT在底部有一PN Junction,在导通时会顺向偏压,向N-注入大量的载子,进而降低N-的电阻。但此多余的载子并不会永久停留在N-内,它会藉由Recombination的过程慢慢的消失。如此的注入、消失,维持一个动态平衡。
当载子的Lifetime长时,表示它可以跑较长的距离才消失,因此载子所能影响的N-区域变大,所以导通电阻较低。Lifetime长也表示PNP Bipolar的Gain增大(因为电洞由P+跑至P-base的机会增加),MOS电流所占的比重因而降低,这样可以使MOS的压降降低。但电洞电流的增加对FBSOA、RBSOA、Latch-Up及Leakage均有不利的影响。相反的,如果载子的Lifetime较短,那所能影响的N-区域缩小,因此导通电阻较大。
控制载子Lifetime的方法很多,如利用Diffusion的方式植入像金、白金之类Deep Level的杂质,但此种方式的均匀性并不好,同时会有污染的问题。另一种方式是使用高能的电子撞击,使得Wafer内产生Defect。此种方式的好处是简单,且均匀性佳,但高能电子的来源是一问题,对成本的增加亦是一项考虑因素。
操作速度
操作速度对Lifetime的要求正好与导通电阻的要求相反。Lifetime越短,Recombination的速度越快,多余载子的消失速度也就越快。除了Recombination快的好处外,缩短Lifetime会使导通电流中,电洞电流的比例降低,因为电洞较不易由P+跑到P-Base。所以相同的导通电流的情况下,Lifetime低的IGBT,其电子电流的成分增加,关闭后电流的Tail较容易消失。
Punch-Through(PT) or Non-Punch-Through(NPT)
对NPT IGBT而言,顾名思义就是P-Base不会与P+接触,因此N-必须足够长,且浓度要淡,以承受所需的崩溃电压。NPT的好处是,它可以承受双向的电压,也就是说它的Forward Blocking电压与Reverse Blocking电压都很高。但由于它的N-区域很长,因此导通电阻与操作速度都受到影响。
另一方面,PT IGBT的N-区域相当短,在组件关闭时,这一区域是完全空乏的。但PT有一N Buffer层来阻挡Depletion Region与P+接触。通常PT IGBT会有Lifetime Killing的步骤,因为N-短,载子的Lifetime不需太长,即可影响整个N-区域。PT的好处是,导通电阻小,操作速度快[4][5]。虽然PT IGBT有一些优势,但就成本上来考虑,PT IGBT的成本较高。因为PT IGBT需使用Epi Wafer及Lifetime Kill Process。由于Epi Wafer的花费问题,PT的结构不常被使用在1200V以上的IGBT。
Latch-Up
Latch-Up是IGBT的一个重要问题,它是决定IGBT能够导通多少电流的一个考虑。不只如此,Latch-Up也关系到FBSOA及RBSOA,即IGBT所能操作的区域(注三)。IGBT有一寄生的Thyristor,如果让它导通的话,那电流就会相当大且不受闸极的电压控制,组件可能因此而烧毁。要抑制Latch-Up可以由降低PNP或NPN Bipolar的Gain着手。
温度
当IGBT的电流低时,导通电阻(或压降)主要是由PN Junction的压降决定。因此当温度升高时,导通某一电流所需的电压就会下降。若IGBT的电流大时,MOS的Channel电阻就会主导IGBT的导通电阻。温度升高,电阻就会升高。因此最好是将IGBT操作在电阻正温度系数区,这样就不用担心电流会集中在某些区域。同时也可将IGBT并联,而不需特别的设计。在操作速度上,升高温度会使得操作速度减慢,这是因为少数载子的Lifetime变长的缘故。温度对Latch-Up的抑制是一不利的影响。温度会增大寄生Bipolar的Gain,同时也会使得P-Base的电阻增大。这些都会降低触发Latch-Up所需的电流。
Termination
一个PN Junction,在内部可看成是平面的,但是在边缘则会成为弧形。由电学得知,曲率越大,在相同电压下,其电场越大。因此边缘的电场要比内部来得大。所以光做好组件本身是不够的,必须考虑到如何减低组件边缘的电场。一般主要是使用Floating Field Ring与Field Plate。
Planar IGBT与Trench IGBT
Planar IGBT虽然经过多年的发展,但仍有一些基本问题有待改进与克服。最明显的是JFET效应。当两个Cell太接近时,它们所产生的Depletion Region会压缩到中间电子流通的路径,使得N-电阻变大。因此两个Cell间有其最小的距离。但增大Cell间的距离代表着Channel密度的降低,会使MOS Channel的电阻增大,同时也会引发崩溃电压降低的问题。所以如何决定Cell间的距离,对Planar IGBT是一重要的问题。除了Cell之间的距离之外,Latch-Up也是Planar IGBT得一大问题。IGBT有一寄生的Thyristor,当电流增大时或温度升高时,由于P-Base电阻的关系容易触发Latch-Up。因此Latch-Up对Planar IGBT可说是无法避免的。
如同DRAM与Power MOS的演进一样,IGBT也采用了Trench的结构。虽然Wafer的面积不断的增大,但面积依然有限。要增加空间只有往上或往下发展,往下就是Trench。这里所谓的Trench就是将原来IGBT水平方向的闸极改为垂直方向,向下深入Wafer内。Trench IGBT最显而易见的优点是消除了寄生的JFET的效应。因为MOS的Channel改为垂直方向,所以Depletion Region是往下扩展,而不会如Planar IGBT般的向两旁水平方向扩展。
相邻Cell的Depletion Region不会互相靠近,因此JFET效应得以消除。因为没有JFET效应,所以Cell可以靠的更近,因此增加了Channel的密度。这意味着在相同的偏压(VCE)下,Trench IGBT可以导通更大的电流。Trench IGBT另一个优点是,有效的抑制了Latch-Up的发生。在Trench IGBT中,由于电流的方向所致,会触发Latch-Up的区域就只剩下N+ Emitter往下延伸与P-Base接触的地方,也就是Latch-Up与N+ Emitter的深度有关。通常在N+ Emitter旁是P-Base的Contact,此区为P+,因此能造成的压降相当小。所以Trench IGBT对Latch-Up的抵抗力比Planar IGBT要好。
虽然Trench IGBT有许多优点,但不可讳言的,它也有一些缺点。最明显的一点是制程上的复杂性。平面式的制程到底是比立体式的制程来得容易。Trench IGBT需要引进另外的制程,因此增加制程的复杂度。再者,由于MOS的Channel是在Trench边上,而Trench是靠蚀刻而成。通常蚀刻的表面是不平整的,因此Channel的Mobility会降低,这会造成导通电阻的增大。
另一个问题是崩溃电压的降低。Trench IGBT有着近乎90度的角存在,这在Planar IGBT中是见不到的。因此在Trench的角落会有大的电场产生,而此处的Oxide质量通常也不好,所以崩溃电压会降低。虽然Trench IGBT的优异Latch-Up特性,使得其FBSOA及RBSOA变好,但也因为Trench IGBT可以导通更大的电流,使得其SCSOA较Planar为差,这是应该注意的。
市场分析
IGBT虽不是拥有最高产值的产品,可是其平均成长率为12.7%,在功率组件中拔得头筹,显示其受市场重视的程度,也表示IGBT在未来仍具有相当的发展潜力。表二为离散式组件前五大厂商的占有率。由表中可以看出,越是高功率的产品,其技术程度越高,独占性也就越强。前五大厂商就占有IGBT市场的71.1%,所以要进入功率组件的市场并不是很容易。但不可因为有门坎就放弃此一正日渐蓬勃的市场,应从人才培养,技术改良下手,以便在国内的功率组件市场占得先机。如果国内能拥有IGBT的制造技术,对去除垄断,降低下游产品生产成本有相当大的帮助。
结论
IGBT可说是现今功率组件市场上在中功率方面的主力,在讲求100%利用能源的今天,其重要性越来越不可忽视。IGBT已由初始的Planar结构演进至第四代的Trench结构。现在又有人提出第五代Thin Wafer制程的IGBT,来增进其性能。随着制程及设计的进步,IGBT的触角正逐渐的深入高频及高功率的领域,扩张其版图。可预见的,IGBT的性能将会继续改进,成为功率组件的主流。