近年来消费性电子产品的功能日益强大,但其内部元件的空间却逐渐缩小,为兼顾体积与效能,雷射成为半导体制程的重要技术。智慧型电子设备浪潮冲击半导体产业,在智慧化趋势下,无论是手机、平板电脑、笔记型电脑…,现在的电子产品的功能越来越强大,在此同时,设备的体积却渐趋轻薄短小,

| 林杰伦表示,雷射技术在这几年快速提升,已由2006年的Nano-Green一路进化到目前的Femto-second等级,同时晶圆等级的封装技术也越来越多,未来的晶圆会走向复合式切割模式,以雷射和电浆共用,让制程良率与效率同步并进。 |
|
也就是说,现在电子产品制造商必须在有限的空间中,置入效能更为强大的半导体元件,在此挑战下,雷射加工就成为近年来半导体产业的技术聚焦,根据Strategies Unlimited的最新市场研究报告指出,至2020年,全球雷射加工市场产值突破130亿美元,为协助台湾业者强化雷射技术在半导体的制程应用,SEMI台湾于4月下旬假新竹清华大学举办「SEMI雷射国际论坛」,邀请半导体产业指标性专家,深入剖析雷射技术在半导体制程应用趋势。...
在封装制程部分,矽品精密工业研发暨工程中心制程技术研究部经理陈培领,以「IC封装技术发展趋势及挑战分析」议题切入,他指出现在消费性电子产品发展最快速的,包括IoT /穿戴式装置、智慧手机、网通基础建设等3类,这3类产品对半导体的封装需求各有不同,例如IoT与穿戴式装置往往需更小的封装,智慧手机除了超薄封装外,高频宽I/O也是设计重点,至于网通基础建设则在高效能方面会有特定要求,例如高速I/O与更佳的散热设计。
他表示,就目前雷射技术在封装制程的趋势包括4个,首先是在低介电晶圆(Low k Wafer0)趋势下,金属脱层(Metal delam)解决方案的应用将逐渐成形,第二是指纹辨识已成智慧手机的主要功能,指纹辨识以玻璃为主要载板,因此未来半导体封装必须强化此部分,第三是凸块孔洞的制程改善,最后则是如何在更低的成本下,达到客户的需求考量。
善用雷射技术 架构先进制程
欣兴电子执行长室/新事业开发副部长简俊贤则针对雷射在IC载板与印刷电路板的应用趋势,提出相关看法,他指出,雷射技术可应用于IC载板与印刷电路板多种制程,包括钻孔、微影、曝光、修复、打字、切割、剥离、对位等,在各类雷射技术中,紫外线(UV)和CO2雷射是目前印刷电路板制程主要应用的雷射技术,而在消费性电子设备的小体积趋势下,未来电路板的布线和体积都会极具缩小,因此ps与fs等级脉宽的雷射技术,在此领域将成为必要工具。提供半导体产业切割、研磨制程设备的迪斯科高科技(DISCO),雷射应用资深工程师Kelly Chen在DBG+DAF、SDBG、WLCSP等半导体技术提出相关看法,他表示,随着晶圆越来越薄,
破片的比例随之提高,现在提升良率的做法是将雷射技术整合于DBG制程中,在扩片(Die Separator)制程前,先以雷射DAF进行切割,同时也可利用雷射DAF做特殊对位,在SDBG部分,由于现在晶圆体积越来越薄,SDBG利用雷射在材质内部形成SD层,先以隐形雷射切割,再进行研磨制程,SDBG可大幅缩减晶圆的切割道宽度,同时提升裸晶的强度,在WLCSP部分,目前一般的WLCSP作法,容易让晶片破损,Molded WLCSP作法则可在开槽区先行形成保护,提升制程良率。
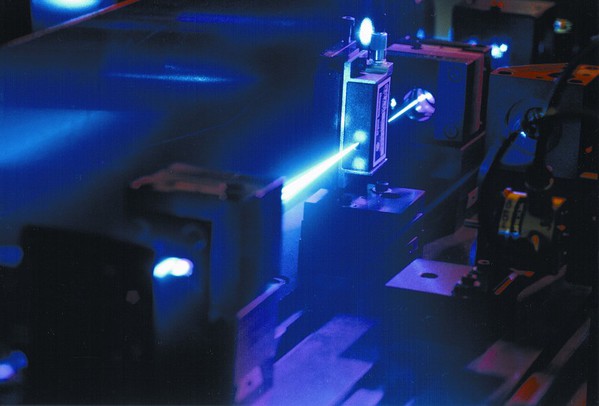
| 图一 : SEMI雷射国际论坛由半导体产业指标性专家分享雷射技术未来发展趋势。由左至右依序为SEMI台湾区副理林惠姿、迪思科高科技(DISCO)雷射技术应用部主任工程师陈冠宏、矽品精密工业研发暨工程中心制程技术研究部部经理陈培领、欣兴电子执行长室/ 新事业开发副部长简俊贤、钛升科技行销处长林杰伦、SEMI台湾区总监李敏华 |
|
技术不断进化 雷射应用前景看好...深耕雷射技术多年的钛升科技行销处长林杰伦,在「New Trend of Laser Micromachining in Semiconductor Packaging」议题中指出,雷射技术应用于IC封装的Marking已有一段时间,目前的Marking的新趋势,其字宽为22um、字深为1.
35um,涂层才采用金属材质,另外,软性印刷电路板(FPCB)与玻璃基板的切割,现也已有雷射应用,这两者使用的雷射技术主要为冷雷射(Cold Laser), FPCB是为了避免因高热造成电路板毁损,玻璃基板则可提升切割效率,每秒切割效率可接近100 mm长度,其厚度则为0.5mm。