波長250~350nm半導體紫外LD與紫外LED(Ultraviolet Light Emitting
Diodes)的應用備受期待。(圖一)是有關紫外LED與LD的應用市場發展藍圖(road
map),其中紫外LD的白光照明、殺菌、醫療、生化領域應用,可望開拓龐大
的市場規模。
主要原因是紫外LED激發,可以獲得高演色性白光照明,而且它得驅動電路非
常單純,一般認為紫外LED未來可望成為白光LED照明的主要光源。至於高密
度光資料儲存用光源與化學產業的應用,同樣備受全球高度期待,接著本文要探
討紫外LD與LED的技術動向。
發展經緯
如(圖二)是氮化物半導體的結晶格子定數與能隙(band gap),以及各紫
外氣體雷射的波長關係,由圖可知AlGaN具備3.46.2~eV紫外直接遷移發光波
長範圍,它幾乎含蓋所有氣體雷射的波長。
氮化物半導體材料具備以下特徵:
- (1)量子井的紫外高效率發光;
- (2)在寬廣能隙(band gap)領域,可以製作n型半導體;
- (3)氮化物半導體材料非常堅硬、長壽命;
- (4)無砒霜等有毒物質。
因此經常被當作紫外發光元件的材料使用。最近幾年紫外LED與LD不斷
朝短波長化、高效率化方向發展,(圖三)是氮化物UV-LED室溫動作時的外部量
子效率,由圖可知目前藍光LED的外部量子效率已經超過40%,波長365nm InGaN 系紫外LED,也達成1W高輸出目標,它的外部量子效率室溫CW動作時為26%,脈衝動作時為44%,不過波長低於360nm時,發光效率會急遽下降只有數%左右。
造成發光效率下降主要原因分別如下:
- (1)AlGaN發光層的發光強度,對貫穿轉位密度有很大依存性;
- (2)AlGaN的p型摻雜(Doping)非常困難;
- (3)為引發紫外吸收,無法使用GaN基板技術,高品質AlN單結晶基板,與低貫
- 穿轉位密度的AlGaN還停留在研發階段。
為實現波長比360nm更短的高效率氮化物發光元件,目前相關業者正開發全新的AlGaN元件技術取,試圖代傳統GaN /InGaN系術技術。
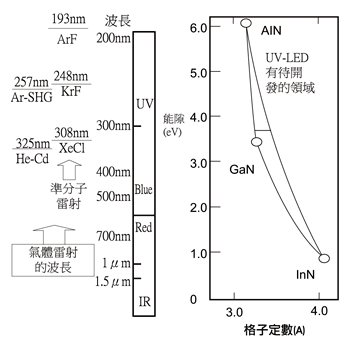
| 《圖二 氮化物半導體的結晶格子定數與能隙,以及各紫外氣體雷射的波長關係》 |
|
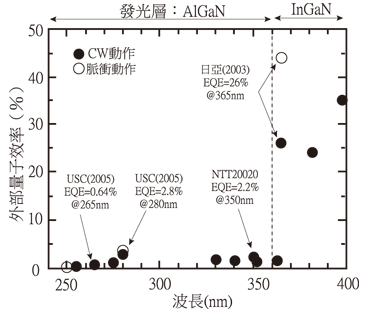
| 《圖三 氮化物UV-LED室溫動作時的外部量子效率》 |
|
在藍寶石基板上製作AlGaN緩衝層時,貫穿轉位密度高達109~1010 cm-2,如果在緩衝層上面製作AlGaN量子層,不易獲得高效率發光,換句話說製作AlGaN系發光層的紫外高效率LED時,必需將穿轉位密度抑制在1x107cm-2左右。
一般認為利用AlN單結晶基板或是ELO(Epitaxial Lateral Overgrowth)方法,製成高品質、低貫穿轉位密度AlGaN 緩衝層非常有效,不過這種方式卻有製作成本暴增之虞,它對紫外LD的重要性反而大於量產型紫外LED。
基於廣泛應用性考慮,實現低價、量產、高效率紫外LED,現階段即使AlGaN有貫穿轉位密度問題,不過它仍舊是紫外LED常用的發光材料,例如InAlGaN 4元混晶含有Al成份的寬能隙(wide band gap),根據研究報告顯示隨著高品質InAlGaN混晶的製作條件、量子井結構的不同,可以獲得280~380nm紫外高輝度發光,即使高貫穿轉位密度,同樣可以獲得40%以上的內部量子效率,製成波長305~370nm紫外LED。
波長為350nm的紫外LED,如果使用AlGaN可以獲得非常高的內部量子效率,由此可知InAlGaN對實現波長280~380nm量產型、高效率紫外LED具有決定性的影響。
氮化物LED短波長化時,會面臨不易實現p型AlGaN等問題,尤其是p型AlGaN的Al組成比一旦變高,acceptor的活性化能量也會隨著提高,其結果造成不易獲得高濃度p型化,雖然目前Al組成30~40%左右的Mg Dope AlGaN可以獲得p型化,不過更高的Al組成量測上非常困難。
低電洞(hole)濃度時,朝p型的電子溢流(overflow)會增加,朝發光層的電子效率則大幅降低,由於p層變成高阻抗導致sample過熱導致發光效率降低。
高品質AlGaN AlN / Template的製作技術
製作波長360nm以下紫外LED時,為避免紫外吸收造成輸出損失,大多採用無GaN結構,此時高品質藍寶石/AlN模板(Template),成為製作紫外LED重要元件。
雖然在藍寶石基板上可以製作低溫長膜AlN(Low Temperature- AlN ;LT-AIN)中間層與AlGaN緩衝層,不過最近研究結果顯示,使用高溫長膜AlN(High Temperature- AlN ;HT-AIN)進行XRC評鑑時,可以製作高品質緩衝層。因此研究人員在HT- AlN上方製作InAlGaN 4元混晶量子井與LED結構,依此進行特性評鑑。
上述結晶長膜使用臥式MOCVD與TMG、TMAl、TMIn Adduct等材料,AlGaN、InAlGaN的長膜溫度分別是1080~1150℃與780~880℃時,長膜速度大約是2μm/hour與0.12μm/hour。
根據以上條件依序在藍寶石(0001)(off角0.15度)製作0. 6μHT-AlN,接著在它的上方製作Si dope 2段AlGaN緩衝層(AI0.36Ga0.64N為1.3μm,AI0.2Ga0.8N為2μm )當作模板。
HT-AlN的長膜溫度為1270℃,長膜速度大約是4μm/hour,在模板上方製作Si dope Al0.2 Ga0.8N緩衝層1. 0μm之後,進行undoped InAlGaN緩衝層60nm,最後在它的上方製作InAlGaN量子井層,或是LED結構進行長膜評鑑。
如(圖四)是藍寶石基板上使HT-AlN長膜2.0μm時的AFM照片,根據照片顯示它可以獲得比較平坦的表面,以5×5μm大小進行AFM觀察時的RMS值大約是0.24nm,除此之外它還可以觀察到原子step。
如(圖五)是藍寶石/AlN模板的X線繞射(002)與(102)ω掃描同步曲線特性,由圖可知最小半值幅為(002)與(102)時,可以獲得36arcsec與1420arcsec等俯仰(tilt)成份非常良好的結果,至於扭轉(twist)成份今後必需透過長膜條件改善。
HT-AlN上方製作2段AlGaN緩衝層(第二段)的X線繞射(002)與(102)ω掃描同步曲線(scan locking curb)的半值幅大約是140arcsec與1410arcsec左右,它比以往LT-AlN上方的AlGaN緩衝層大幅改善,研究人員一致認為HT-AlN上方AlGaN對稱性(102)半值幅,在AlGaN的長膜條件的改善,可以獲得600arcsec的結果。

| 《圖五 藍寶石/AIN模板的X線繞射(002)與(102)ω掃描同步曲線特性》 |
|
如(圖六)是藍寶石/HT-AIN模板上製作InGaN量子井LED的斷面TEM照片,依此評鑑螺旋轉位加上混合轉位密度大約是7×108cm-2左右,若與使用LT-AlN與HT-AlN的情況比較,AlGaN緩衝層的貫穿轉位密度減少數倍以上。
依此證實使用HT-AlN模板,可以使InAlGaN 4元混晶量子井的發光強度增加三倍左右,而且更容易獲得Mg dope AlGaN層的p型化。

| 《圖六 藍寶石/HT-AIN模板上製成的InGaN量子井LED斷面TEM照片》 |
|
高效率紫外發光InAlGaN 4元混晶量子井技術
AlGaN混入數%的In造成貫穿轉位密度變高時,即使在室溫環境依舊可
以獲得紫外高發光效率,一般認為添加In的動作機制是透過In的組成變調,使電
子與電洞局部化(Localization),加上轉位結晶trap前發光再結合,因此即使轉
位密度變高,也能夠獲得高發光效率。
圖7是改變各材料的組成製成的InAlGaN 4元混晶,與InGaN量子井室溫時的發光(Photo Luminescence;PL)頻譜特性;(表一)是圖七(a)的InAlGaN與InGaN量子井的結構參數。
室溫時InAlGaN量子井會強發光,在280~380nm寬廣的紫外波長範圍,可以獲得高輝度發光,尤其是在320~350nm附近,它與InGaN 量子井產生的藍色發光效率幾乎相同,值得一提的是上述量子井與1×1010cm-2高貫穿轉位密度無關,在室溫同樣能夠高輝度發光。
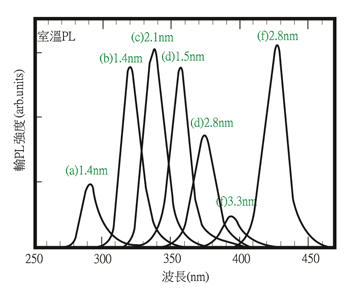
| 《圖七 InAlGaN與InGaN量子井室溫時的PL頻譜特性》 |
|
InAlGaN 4元混晶的In組成變調,可以透過陽極發光(Cathode Lumines
cence;CL)影像的發光空間性搖晃觀察,此外根據PL強度的溫度特性觀測,得知InAlGaN與InGaN量子井的PL強度,在室溫下反而比GaN與AlGaN量子井高1~2位數。
為達成高內部量子效率,研究人員在高品質AlGaN/AlN模板上製作InAlGaN 4元混晶量子井結構,利用RBS方法量測InAlGaN的In與Al組成,其結果分別如下:
- ●阻礙層(barrier)→IN=3.5%,Al =35%;
- ●井層領域→Al =25%,IN=5%。
上述量子井與阻礙層的寬度分別是2.5nm與7.0nm。(圖八)是測試溫度從18K變化至290K時,InAlGaN量子井的PL頻譜特性,如圖所示室溫時峰值波長為338nm,激發光源使用波長為257nm的Ar-SHG(Second Harmonics Generation)雷射,以500W/cm2激發電力密度進行量測,根據測試結果顯示從低溫一直到室溫,InAlGaN量子井可以維持338nm單一峰值特性。

| 《圖八 測試溫度從18K變化至290K時,InAlGaN量子井的PL頻譜特性》 |
|
如(圖九)是將圖八的頻譜積分後獲得的InAlGaN量子井發光積分強度-溫度特性,由圖可知在100K以下的低溫領域,發光積分強度幾乎維持一定,從低溫變成室溫時,發光積分強度會降低50%,此處假設低溫時的發光再結合率大於非發光再結合率,依此推測室溫時的內部量子效率大約是47%。
由於上述實驗是以實際LED動作時的效率估算為主要考量,因此激發光強度使用較高數據進行內部量子效率評鑑。
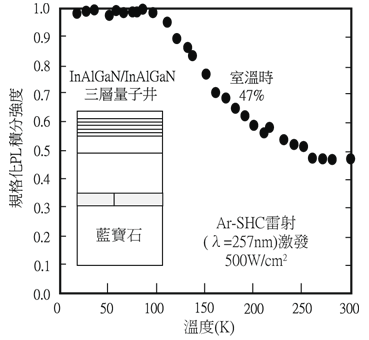
| 《圖九 InAlGaN量子井的發光積分強度溫度特性》 |
|
如(圖十)是波長低於280nm,以短波發光的InAlGaN量子井室溫發光(PL)頻譜特性,如圖所示波長低於300nm的短波,隨著AL組成比的增加,會促進TMAl與氨的氣相反應,其結果造成長膜條件的設定更加困難。
最近研究人員發現控制長膜壓力與流速,即使波長低於280nm的短波,也能夠
作室溫高輝度發光,以(圖十)為例它使用比一般更快的流速,同時改變長膜壓力
製作量子井時,反而比使用減壓方式(高流速)更容易獲得波長267nm的室溫發
光。
如(圖十一)是以波長265~338nm發光的InAlGaN量子井,估算的內部量子效率,黑圈是利用裡研的MOCVD設備,在HT-AlN/AlGaN上方製作的InAlGaN量子井內部量子效率,如圖所示波長338nm時為47%;白圈是利太陽日酸的MOCVD(SR-4000)設備,在藍寶石/GaN模板上方製作的InAlGaN量子井值。
SR-4000是藍光LED、LD量產用MOCVD,它可同時使三片2吋基板,或是一片4吋基板長膜。如(圖十一)所示使用SR-4000在2吋基板上製作InAlGaN量子井,可以獲得波長為336nm紫外高效率發光,它的內部量子效率幾乎與利用SR-4000製作的InGaN量子井相同。
根據上述實驗證實2吋基板能夠獲得均勻的量子井,這意味著今後InAlGaN紫外LD、LED,也可以順利進入量產階段。綜合以上結果,研究人員一致認為InAlGaN 4元混晶量子井,對波長為280~380nm的紫外發光元件非常有幫助。
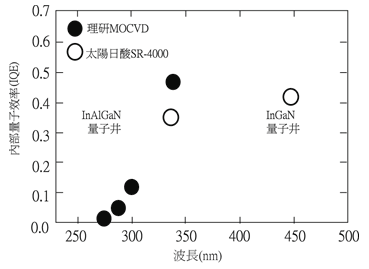
| 《圖十一 InAlGaN量子井的推估內部量子效率》 |
|
Al組成比30%左右Mg doped AlGaN,由於acceptor的活性化能量高達300meV
,電洞的活性化率則低至1%以下,因此不易獲得p型AlGaN。(圖十二)是量測Mg
doped AlGaN的Al組成比與電洞效果,獲得的電洞濃度特性,雖然透過最佳化
長膜條件,Al組成比32%左右的Mg doped AlGaN,可以獲得2 ×1018cm-3的電洞濃度,不過根據研究報告顯示,到目前為止Al組成比超過40%以上,還無法獲得2×1017cm-3的電洞濃度。
雖然高Al組成的P型AlGaN是製作短波長氮化物發光元件不可或缺的技術,不過至今尚未找到達成高Al組成、高電洞濃度有效對策方案。
研究人員曾經嘗試利用Mg doped AlGaN 超格子或是交互氣體供應法,製作Mg doped AlGaN 以及共摻雜(Co-Doping),不過始終無法獲得令人滿意的效果,因此未來必需開發高Al組成的p型AlGaN 技術。
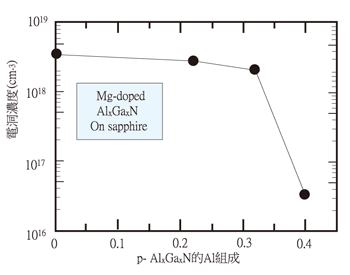
| 《圖十二 Mg doped AlGaN的Al組成與電洞濃度關係》 |
|
如(圖十三)是波長310nm、InAlGaN發光層紫外LED的結構與動作頻譜,LED的具體結構依序在藍寶石基板上製作;
- ●Al混晶比47%的n-AlGaN層;
- ●InAlGaN發光層;
- ●Al混晶比53%的p-AlGaN層;
- ●p-GaN接觸層。
上述p-AlGaN層使用交互氣體供應法長膜,它在高注入電流領域,可以獲得接近單峰值的發光。波長為308nm與314nm時的紫外LED輸出,分別是0.4mW與0.8mW,雖然目前該LED的外部量子效率只有0.1%,不過研究人員認為今後透過p層高濃度化與量子井發光層的設計,可望提高LED的外部量子效率。
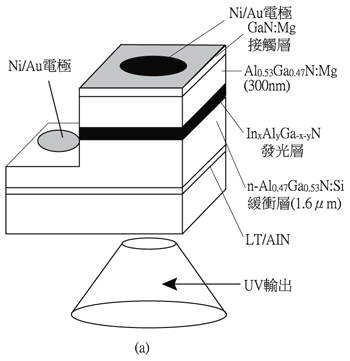
| 《圖十三 InAlGaN發光層波長310nm紫外LED的結構與動作頻譜》 |
|
如(圖十四)是為去除貫穿轉位的影響實現高效率LED,研究人員在GaN基
板上製作的InGaN量子井結構LED,與該LED的發光特徵;(圖十五)是該LED的
室溫CW頻譜與V-1特性。
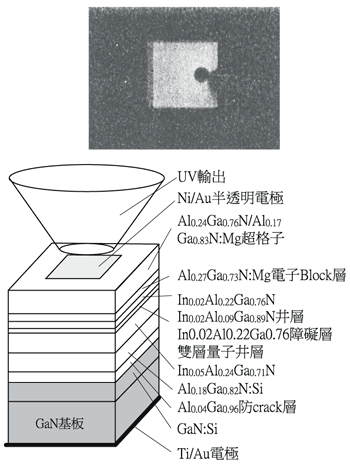
| 《圖十四 GaN基板上的InGaN量子井LED結構與發光特徵》 |
|
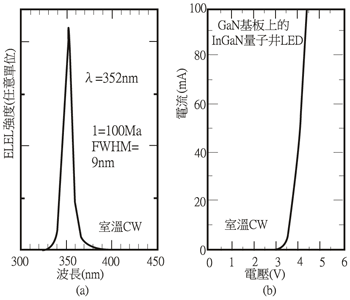
| 《圖十五 GaN基板上的InGaN量子井LED的室溫CW頻譜與V-I特性》 |
|
上述LED製作步驟是依序在GaN基板上製作:
- ●n-GaN層;
- ●InGaN包覆(clad)防止層;
- ●Al組成18%的n-AlGaN層;
- ●InAlGaN/InAlGaN雙層量子井發光層;
- ●Al組成28%的p-AlGaN電子block層;
- ●p-AlGaN/AlGaN超格子層。
接著在LED的表面製作Ni /Au半透明電極,在LED的背面製作Ti /Au電極。除此之外研究人員還利用Al組成18%的p-AlGaN bulk層取代AlGaN/AlGaN超格子層試作LED。
上述LED的基板使用住友開發的GaN基板(貫穿轉位密度低於1×106cm-2 ),LED的發光波長為352nm,發光半值幅為9nm,注入100mA時的施加電壓大約是4.4V左右。
如(圖十六)是上述LED的電流-光輸出( L I - )特性與外部量子效率,如圖所示注入400mA時的最大輸出大約是7.4mW左右;使用AlGaN AlGaN / 超格子層的LED,注入100mA時的最大輸出大約是3.9mW左右,該輸出值比GaN基板上製作AlGaN量子井,波長為350nm的LED,注入100mA時3.9mW最大輸出更高,至於外部量子效率,波長350nm的表面出射型LED,最高值大約是1.1%。
InAlGaN 4元混晶LED若與AlGaN系LED比較,前者的效率反而更優秀,依此再度證實即使高貫穿轉位密度,在GaN基板上製成的AlGaN系LED,同樣可以獲很高的外部量子效率。
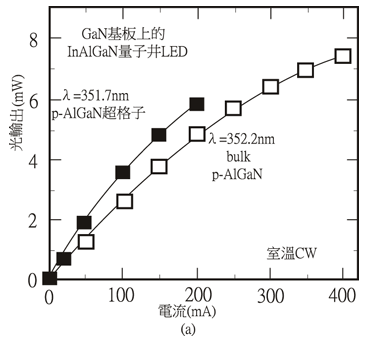
| 《圖十六 GaN基板上的InGaN量子井LED電流之光輸出(I-L)特性與外部量子效率》 |
|
上述LED的外部量子效率只有1.1%,主要原因是GaN層的紫外光吸收,使得光取出效率降低,加上p-AlGaN的電洞濃度很低,與電子溢流、元件加熱都會造成效率降低。
一般認為今後AlN/AlGaN高品質緩衝層的導入,利用散熱鰭片的晶粒固定(die bonding),以及藍寶石lift-off構成的縱型注入結構的導入,高效率元件與紫外光取出效率的改善,LED的外部量子效率可望獲得大幅提升。
結語
InAlGaN 4元混晶利用In混入效果,在280~380nm波長範圍可以獲得室溫高輝度發光。高品質GaN系基板的紫外LED,在350nm波長範圍可以獲得7.4mW室溫高輝度發
光,並實現上方出射350nm波長LED最高外部量子效率,依此證實InAlGaN系發光
層比AlGaN更優秀。由於InAlGaN即使高轉位密度,也能夠作高輝度發光,這意
味著量產型、低價紫外LED的發光層具備高利用價值。
__

