采用传统电浆灰化方式的光阻去除制程会导致低介电常数(low-k)材料特性的严重劣化,这包括介电常数的增加和微距(critical dimension)的改变。使用hexamethydisilazane(HMDS)之类silyating药剂的复原制程已被用来复原部份灰化薄膜的介电性质,然而这些制程并不能将介电常数复原至刚沉积完成时的低介电常数薄膜,这使得无损害性的光阻去除成为低介电常数材料整合的重大挑战。本文所探讨的晶圆表面处理技术,将介绍如何在批次型喷雾清洗设备的协助下,利用饱和臭氧含量的去离子水(DIO3)来处理化学气相沉积的有机矽玻璃(OSG)低介电常数薄膜,并且分析所得到的光阻去除结果;这项制程不会导致低介电常数性质或微距的改变,此外也证明利用腐蚀抑制剂,就能降低臭氧制程对铜腐蚀效应。
新一代非损害性清洗制程技术简介
要将多孔性材料整合至65奈米以下的先进制程,就必须发展非损害性蚀刻、灰化和清洗制程,采用氧化或还原化学的传统电浆灰化制程会攻击碳矽键(Si-C bond)和增加薄膜密度,进而对低介电常数材料造成重大损害。许多低介电常数复原制程会使用液相、气相或在超临界二氧化碳中做为hexamethyldisilazane(HMDS)的助溶剂,它们已证明可用来处理旋涂式多孔性methylsilsesquioxane(MSQ)薄膜[1]~ [3],这些制程能将介电常数部份复原,使其与刚沉积的材料相差不到10%,但国际半导体技术蓝图(International Technology Roadmap for Semiconductors;ITRS)的2003年发展蓝图却要求从90奈米制程开始,光阻去除和清洗制程所导致的介电常数改变幅度不能超过2.5%[4]。除此之外,虽然ITRS 2003年发展蓝图承认目前的清洗制程会对低介电常数薄膜造成损害,但该蓝图也指出非损害性清洗制程的发展对于未来制程技术的实现极为重要。
本文们将介绍HMDS复原制程对于极低介电常数(ULK)化学气相沉积OSG材料的处理效果。根据实验结果,此制程的复原能力会随着材料孔隙率的增加而改进(例如k=2.2的薄膜),但事实上在k=2.5的薄膜上并未看到任何改进。以下接着分析利用湿式化学品制程取代损害性电浆灰化制程的效果。
在此将介绍一种「全湿式」光阻去除制程,它采用饱和臭氧含量的去离子水,并由批次型喷雾清洗设备来进行喷洒。臭氧制程的化学品成本和有害废料产生量都远低于其他商业配方,而且对于刚完成沉积的薄膜,它也不会造成介电常数的任何改变。除此之外,从元件测试结果的电气特性参数可以看出,利用湿式光阻去除制程所处理的薄膜,其漏电流远小于电浆灰化制程所处理的薄膜。最后将说明如何在臭氧制程中添加化学抑制剂,以便降低光阻去除过程的铜腐蚀现象。
喷雾式清洗设备实验
(图一)为本实验所使用的喷雾式清洗设备的概要图(ZETA,FSI International),此一喷雾批次制程系统利用离心力来加强微粒去除和干燥效果。这套清洗设备可透过中央或两旁的喷嘴头来喷洒全新供应或再循环的制程化学品,这些化学药剂的储存和喷洒都是在氮气环境进行,使其化学性质衰退程度减至最小,而有效运作时间则延至最长。晶圆可以顺时针或反时针方向旋转,以得到最均匀的处理效果;除此之外,这套设备会同时以化学制剂加热器和制程反应容器(process bowl)监测化学制剂温度,以精确控制晶圆表面的化学制剂温度。
臭氧制程会加压让臭氧在去离子水中溶解,使其于室温下能达到120 ppm的浓度。这套清洗设备会透过中央喷嘴的底部将DIO3喷洒至旋转盘,然后将含有腐蚀抑制剂的高温去离子水混合溶液直接喷洒至晶圆表面,如图一(b),超饱和DIO3所排放的气体和臭氧会留在密闭的制程反应室内[5],使晶圆温度保持在70℃左右,每批8吋晶圆(100片)所需的臭氧喷洒时间还不到30分钟。
<图注:此处显示两个概要图:(a)批次型喷雾清洗设备的主要系统组件,其中有制程反应容器(process bowl)、喷嘴头以及再循环槽;(b)臭氧喷洒机制,它会将臭氧含量饱和的去离子水喷洒至旋转盘,同时将去离子水混合溶液直接喷洒至晶圆表面,并借此将晶圆加热。 >
首先使用矽基材沉积的毯覆式低介电常数薄膜,以它来代表低介电常数薄膜受到制程损害的情形。薄膜则是在电容放电装置中利用电浆辅助的氧气和有机矽烷混合气体来进行处理,使其得到大约6300A的厚度,接着利用电浆回火制程(plasma anneal)赶出薄膜中的porogens,同时将孔隙率降低。只要改变沉积处理后的电浆回火制程,进而改变薄膜孔隙率,就能得到k=2.2和2.5的低介电常数薄膜。为了模拟典型的蚀刻制程,所有的毯覆式薄膜都会接受部份蚀刻处理,使其厚度减至3700A左右。虽然毯覆式ULK薄膜的表面并未涂布任何光阻,此薄膜仍会接受用于将248奈米光阻除去4100A厚度的电浆去除制程,然后利用测试元件检视漏电流。这些测试元件包含约6300A的ULK层,它已完成测试元件线路,并利用CHF3/CF4/N2化学将它部份蚀刻至原厚度的50%左右,如(图二)。
铜损耗分析是使用最初平均厚度为950A左右的毯覆式铜晶圆,同时采用Thermo Noran的GXRS X射线萤光分析仪 (XRF)做为量测之用。
<图注:SEM影像显示:(a)DIO3处理前的光阻去除制程以及(b)DIO3处理后的光阻去除制程。臭氧去除制程会选择性的去除光阻,而且不会对低介电常数材料造成明显的攻击。 >
实验结果与讨论
毯覆式ULK化学气相沉积OSG薄膜会以三种方式处理:(1)蚀刻;(2)蚀刻+灰化;(3)蚀刻+灰化+HMDS+清洗+HMDS;所有样品都是在400℃下进行回火处理。 (表一)列出了k=2.2和k=2.5薄膜的厚度和介电常数,结果显示随着薄膜孔隙率增加,灰化制程会造成更严重的损害,尤其k=2.2和k=2.5薄膜的介电常数将分别增加为2.91和2.82。除了介电常数升高,薄膜厚度也显示明显的减少,其中k= 2.2薄膜为-28%,k=2.5薄膜为-12%。
清洗和HMDS复原制程可让k=2.2薄膜的介电常数减少9%,从2.91降为2.66;但对于密度较大的k=2.5薄膜,清洗和HMDS复原制程却未能将其介电常数值明显降低。

| 《表一 电浆灰化制程处理后的薄膜厚度和介电常数量测值》 |
|
为了减少光阻去除和清洗制程对于低介电常数材料的损害,一种不用电浆灰化处理,就能将部份光阻去除的湿式光阻去除制程已被研发出来,我们还在ULK化学气相沉积的OSG基材上利用光阻涂布出短制程测试结构(short-loop pattern)。图二是测试结构在臭氧处理前和处理后的SEM影像,从臭氧处理后的制程结果可以看出光阻全部被去除,而微距则没有任何的明显变化。
(表二)是薄膜在两种制程处理下所得到的厚度和介电常数,这两种制程是:(1)仅执行蚀刻处理以及(2)蚀刻+湿式光阻去除,两种薄膜都在400℃下进行回火处理,结果显示湿式光阻去除制程不会大幅减少薄膜厚度(≦2%)或是增加介电常数值(≦2%)。

| 《表二 湿式光阻去除制程处理后的薄膜厚度和介电常数量测值》 |
|
接着是测量元件测试结构的电气参数资料,(图三)显示相较于电浆灰化处理的薄膜,湿式光阻去除制程会得到较小的漏电流。
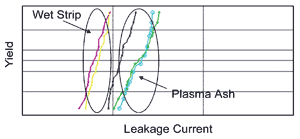
| 《图三 电浆灰化制程和湿式光阻去除制程的漏电流数据》 |
|
<图注:以上两种制程都能将漏电流严密控制在一定范围内,但是湿式光阻去除制程的漏电流较小。 >
电路测试结构并未将铜金属曝露在外,所以我们用毯覆式铜晶圆来评估DIO3制程的铜氧化情形。铜和氧化铜系统在水中的Pourbaix图显示氧化铜会溶解于酸性混合液[6],DIO3制程则是略带酸性的制程,因为它会透过两种机制产生碳酸:
- (1)为了让臭氧在溶液的寿命时间最长而于DIO3混合液中添加二氧化碳做为强效净化剂;
- (2)臭氧与光阻发生反应并产生二氧化碳做为副产品。
受到以上两种机制的影响,使用臭氧可能会造成铜氧化,进而溶解在酸性溶液中;为了降低此影响,可在直接喷洒至晶圆的去离子水混合液中添加两种腐蚀抑制剂。 (表三)是添加和未添加化学抑制剂后,去离子水臭氧制程的铜损耗和目视检视结果。未添加化学抑制剂的去离子水臭氧制程会产生明显的表面氧化现象,铜损耗的量测值则为33.5A,抑制剂A会将铜损耗减少68%成为10.7A。接着我们又将抑制剂B加入去离子水混合液,进一步强化晶圆表面的铜元素键结,减少铜元素与臭氧产生氧化反应的现象,使用抑制剂A和B的去离子水混合液会将铜损耗减少97%而成为1.0A。晶圆在经过添加抑制剂的去离子水制程处理后,其表面会出现一层很薄的物质,我们认为它是表面氧化层。此时只要利用稀释后的氢氟酸(HF)或是去除残留物的商用化学药剂,很容易就能去除这个表面氧化层。

| 《表三 添加和未添加腐蚀抑制剂时,湿式光阻去除制程的铜损耗量测值》 |
|
结论
从以上实验中可以们观察到,随着低介电常数材料的孔隙率增加,电浆灰化制程有可能导致材料受到相当损害,使得薄膜密度增加,其结果则是介电特性的劣化。清洗和HMDS复原制程虽能大幅改善各种多孔性薄膜(例如k=2.2)的介电常数,但是薄膜密度的增加却无法逆转,所以无法将介电常数恢复到刚完成沉积时的数值。而目前已经有一种非损害性的湿式光阻去除制程,能选择性的去除部份光阻,不会导致低介电常数材料的性质劣化,也不会造成明显的铜腐蚀现象。 (作者任职于FSI International)
<参考资料:
[1] P. G. Clark, et.al, "Cleaning and Restoring k-Value of Porous MSQ films", Semiconductor International, August 2003.
[2] P.G. Clark, et.al, "Post Ash Residue Removal and Surface Treatment Process for Porous MSQ", International Sematech Wafer Clean & Surface Prep Workshop, May 2003.
[3] G.B. Jacobson, et.al, "Cleaning of Photoresist and Etch Residue from Dielectrics using Supercritical CO2", International Sematech Wafer Clean & Surface Prep Workshop, May 2003.
[4] Table 83a, "Interconnect Surface Preparation Technology Requirements" in the Interconnect Chapter of the 2003 ITRS Roadmap. The ITRS 2003 Roadmap is available at http://public.itrs.net/Files/2003ITRS/Home2003.htm.
[5] S. Nelson, "Reducing Environmental Impact with Ozone Based Processes," Environmental Issues in the Electronics and Semiconductor Industries, ed. L. Mendicino (Electrochemical Society, 2001) pp.126-133.
"[6] Atlas of Electrochemical Equilibria in Aqueous Solutions, edM. Pourbaix (National Association of Corrosion Engineers, 1974), pp.389-390.
|
|
 |
专长于晶圆表面清洗相关技术的设备业者FSI与宣布与Novellus Systems签订合作协议,加入多家半导体设备厂商所组成的Damascus Alliance,共同推动铜质双镶崁(Dual Damascene)导线制程的整合以支援先进元件制造。相关介绍请见「Novellus客户整合中心将采用FSI晶圆清洗设备」一文。 |
 |
自从奈米制程依照摩尔定律的规范一如预期地诞生于半导体工业之后,能与之匹配的处理技术就必须应运而生。你可在「奈米世纪骤然来袭 表面处理技术升级」一文中得到进一步的介绍。 |
 |
由于无线区域网路语音(VoWLAN)通讯系统的设计在世界上还处于起步阶段,有些关键技术尚未有标准的解决方案。本文将从下至上介绍VoWLAN系统设计时在实体层、媒体接取层和IP层遇到的关键问题,并就其中的部份问题提出了解决方案。在「应材CVD系统广受全球12吋晶圆厂采用」一文为你做了相关的评析。 |
|
|
 |

