由于Si/SiGe/Si所具有的异质性接口特性,以及与主流Si-技术制程的兼容性,将开启新一代微电子技术潮流,其组件应用主要可分为两大类:一.Heterojunction Field Effect Transistor(HFET);二.Heterojunction Bipolar Transistor(HBT)。其中HBT首先验证于1988,之后就有快速进展,截止频率从开始的30GHz推到目前130GHz,直逼GaAs特性。今天SiGe HBT已渐属发展成熟技术,正导入量产阶段。
随着无线通信蓬勃发展,其相关RF ICs需求日益殷切,找寻低成本、高效益、高集积度的制程技术来配合IC设计更是急迫。具有优异高频特性,以及易与CMOS整合成BiCMOS的SiGe技术,无疑将是最佳选择,而且预估可涵盖到更高频的MMICs,以及高速模拟/数字混合式ICs上,目前全世界各大半导体厂商无不开始积极研发或列入下一世代重点技术;亦有相当多研究机构进一步将各式高频/高速主动组件和被动组件与SiGe HBT整合,应用在Millimeter Wave Sensor、Communication上,以及利用SiGe/Si异质性结构制作Optoelectronics组件,应用在OEICs产品上;可说是一种甚具实用性与前瞻性的技术。
本文首先扼要阐述SiGe HBT组件物理与特性,据此与其它技术的组件如CMOS、Bipolar、GaAs(MESFET、HBT)作一广泛的比较,以了解各种技术应用在高频/高速ICs的利基所在。接着讨论SiGe HBT的关键制程技术,包括各式SiGe薄膜成长技术、不同组件结构、和SiGe BiCMOS整合技术。
之后两个章节则分别讨论SiGe HBT/BiCMOS的量产问题及其产品应用,前者主要是依据IBM近年来多次所发表的数据来说明;后者则以SiGe HBT组件的高频特性,来推测其产品应用范围及市场,并以各家公司在网络上所张贴的产品网站为左证。最后对国内产、官、学对SiGe技术研发作一扼要描述,期望为国内半导体业再开创另一新的局面。
SiGe HBT组件特性与技术比较
基本上,SiGe HBT利用射极(Poly-Si)与基极(SiGe)的能带间隙差异(7.4 mV/% Ge Content),来提高射极的注入,因此可降低射极搀杂浓度和提高基极搀杂浓度。在可避免射-基极间的隧穿(Tunneling)效应下,来提高射-集极间的穿透崩溃电压(Punchthrough)。且可同时降低基极宽度和电阻,达到优异高频特性,如高截止频率、低噪声。
以上基极SiGe层的Ge含量为箱形分布(Box Profile),例如Ge含量增加所引起接口能带间隙差异,将等效提高基极之QB值(宽度x浓度),如此可增加组件设计的弹性;或祇增加基极浓度以大幅降低基极电阻;或增加基极浓度且缩短基极宽度,在降低基极电阻的同时可提高组件截止频率。
另一种作法则是SiGe层的Ge含量属渐升式分布(Graded Profile),其在射-基极接口Ge含量从零渐升到基-集极接口的适量值(如15%),因随着Ge含量的渐变在基极区内的能带亦随着渐变,如此将在此区内造成内建电场,加速注入载子移动速率,达到降低注入载子的延迟时间。组件设计上可由Ge含量分布的调变来改变内建电场大小,再适当提高基极浓度,以同时达到低基极电阻和高截止频率的目标。
其对于接口Band Diagram和组件特性的影响可用(图一)表示。在射-基极接口因Ge含量造成有一能带间隙位能差,△Eo,有利于射极载子注入及提高电流增益;在基极区内由于Ge搀杂量渐增,能带间隙渐窄,将内建一电场加速注入少数载子的传导,而减低传导延迟时间及提高截止频率;另外由于射极注入效率提高,可相对提高基极浓度,可减少集极电压对基极宽度的调变,即减少集极电流对集极电压的变化而提高其VA电压(Early Voltage),加上由前一项电流增益提高,两者乘积,GainxVA,将大幅提升极有利于模拟电路的设计。
Bipolar/CMOS/GaAs技术比较
选择适用于无线通信产品的IC制程技术,一直有很大争论,尤其在所谓的RF CMOS加入战局之后;过去几年以来RF ICs零组件有各种方式被提出,包括Bipolar(Si/SiGe HBT、BiCMOS)、CMOS、GaAs MESFET和HBT。虽然最终的考虑应是经济因素,能以最低成本和最快时间将产品推出市场的将是最大赢家;但各种制程技术的高频特性,无疑是开发阶段中作为评估的重要依据。
基本上GaAs(MESFET、HBT)其高频特性是优于Si BJT(CMOS),但在Si BJT(CMOS)不断降低尺寸、提升效能情势下,GaAs已无法像CMOS在数字IC技术中一样一直占有主流地位,如果Si BJT(CMOS)高频特性能进一步满足电路规格要求,在成本和整合性的考虑之下,无疑将渐渐取代GaAs。如果将电流损耗、被动组件整合性、制造复杂度考虑进来,理想RF ICs制程技术应该同时能达到低噪声、高线性、低电流损耗、高度整合性、低制造成本的要求。
将各种制程技术不同特性比较整理如(表一),可发现SiGe HBT/BiCMOS可提供极佳选择;其中RF CMOS最近虽一直有很多进展,分别从组件布局设计、多晶硅闸极电阻降低,显示在0.15um以下CMOS组件其高频特性甚至可超越Bipolar组件;以Toshiba的0.15um RF CMOS为例,可达到fT=42 GHz、NFmin=1.4dB(at 2GHz)。但MOSFET有一先天限制,其Noise Figure反比于Transconductance(gm),在低汲极电流时gm甚小,造成其NFmin远大于最低值;相对于Bipolar组件要达到相同的Noise Figure,CMOS需要更高电流或更大面积来达成,对讲究低耗电的可携型无线电终端产品来说并不利,仍需时间加以克服。
SiGe HBT/BiCMOS整合制程技术
SiGe HBT制作
SiGe HBT制程技术除需要另外成长SiGe薄膜当作基极外,并需与传统Si-Bipolar完全兼容,因此在SiGe HBT研发过程中SiGe薄膜的成长无疑将是成功与否的关键。(图二)简要显示SiGe HBT不同的SiGe薄膜磊晶成长和组件结构,以及相关制程流程和代表厂商。
SiGe薄膜磊晶成长技术包括有Blanket、Differential、Selective三种成长方式,和MBE(Molecular Beam Epitaxy)、RTCVD(Rapid Thermal Chemical Vapor Deposition)属广义的称呼,另外包含有LRP(Limited Reaction Processing)、AP(Atmospheric Pressure)、LP(Low Pressure)成长型式、UHV/CVD(Ultra High Vacuum Chemical Vapor Deposition)三种成长制程设备,其中MBE属研究性质较不适合用来制造生产,另外两种技术则广为半导体业界所采用。
组件结构则分别有Mesa-Type、Single-Poly Quasi-Self-Aligned,Double-Poly Self-Aligned三种型式,其中Mesa-Type不易整合成ICs;以不同机台的适用性来考虑,目前以MBE Mesa-Type(Blanket)、UHV/CVDSP(Differential)、RTCVDDP(Selective)为较佳组合,MBE因较不适合量产将不作进一步讨论。
在未进一步讨论HBT制作之前,有必要先对SiGe Strained Layer特性作一番探讨;Ge原子晶格常数略大于Si原子,在Si基材上所成长的SiGe薄膜属形变层(Strained Layer),其质量与成长环境、温度、Ge搀杂量有密切关系,易有缺陷产生而影响组件特性;因此SiGe薄膜的成长条件、和后续制程整合的配合都需详加考虑。
◆RTCVDDP(Selective)
基本上延续传统Si-Bipolar的双层复晶自我对准结构,主要差别在于HBT其基极改由SiGe薄膜磊晶形成,主要发展厂商有Philips、Siemens、NEC、Hitachi。硅化锗薄膜磊晶属RTCVD成长方式,具有寄生电阻、电容低,和与现有Bipolar制程兼容的优点。但此硅化锗薄膜是在默认的射极窗以选择性磊晶长成的,其过程不易掌控,除易在其它非晶系区域Nucleated,和有严重Micro-Loading效应外,亦易由侧边的基极复晶层形成一不同于由射极窗往上成长的晶面,成为射-基极间主要漏电来源,皆为此种结构进一步要解决的课题。
◆UHV/CVDSP(Differential)
此方法为IBM所专利的作法,其SiGe层同时在晶系与非晶系区成长,祇是在晶系区长成单晶的内在基极层,而在非晶系区则长成复晶的外在基极层层,将作为后续基极拉线接触之。SiGe层长好之后,后续制程除需要一高质量低温氧化层成长外,类似于传统单层复晶的Si-Bipolar。此种作法虽然射-基极区非自我对准,但在制程能力愈精细情况下其结果将与前述双层复晶自我对准相同,且制程易与CMOS结合形成BiCMOS,将为下一节SiGe BiCMOS讨论重点。
SiGe BiCMOS制程整合
SiGe BiCMOS的制程也是与Bipolar一样的分为Single-Poly与Double-Poly两种制程,其中Single-Poly BiCMOS的制程是以IBM公司所提出的制程最具代表性。此制程是最具关键之处是利用在沉积SiGe基极时一同制作复晶闸极层,亦即在SiGe Base层沉积之前会先成长闸氧化层,然后接着进行SiGe层成长。
此沉积过程不仅是在晶系区成长单晶的内在基极层,也可以于场氧化层之上沉积外在基极层,并于闸氧化层之上制作出复晶闸极层,然后再制作射极复晶结构。至此Bipolar的部份制作完成,接着进行复晶闸层的蚀刻、LDD离子植入、Spacer的制作、源极和汲极的离子植入、热退火制程,以及后段的金属化制程后,即完成Single-Poly SiGe BiCMOS的制作。
SiGe HBT/BiCMOS产性与可靠性
新技术的开发最后要能达到应用的阶段,需要通过可量产特性的验证,包括制程再制性、良率,及可靠性的试验。IBM在1997年以超过17 Wafer Runs,总共200片SiGe用UHV/CVD成长的的200mm芯片,来检证HBT组件关键制程参数-基极片电阻(Rpb,Pinch Base Sheet Resistance,(Ω/sq)的均匀性,显示每片Site-to-Site偏离该片平均值的偏差量小于8%,而Wafer-to-Wafer偏离全平均值的偏差量(3-Sigma)则小于39%,再制性结果优于一般传统Bipolar组件和III-V技术。
主要原因应来自于SiGe HBT的磊晶型基极浓度峰值位于射基极接口之下,有别于传统植入型基极其浓度峰值会在射极搀杂离子推入时被消耗掉,造成双载子晶体管特性的均匀性不佳,尤其是频率要求更高时制程将会更难掌控。
其次,晶体管良率可由串联4000个HBT(AE=0.5(2.5um2)组件的Test Chains来估算,其Failure Mode属射-集极之Piping造成集极电流漏电。而在整个200 mm芯片上则有9个Fail Dies,依此推算其良率为87%,进一步推算Single Transistor的良率可达到99.994%,如此高的良率已达到可作LSI整合的程度。
德国IHP(Institut fur Halbleiterphysik)亦在1998年利用RTCVD成长SiGe Base来验证SiGe HBT的可量产性,结果显示在射极面积为104 um2(相当于8000个射极面积为0.5(2.5um2的组件)良率为90%,其样本空间为100mm的芯片600片,对应于IBM两者有相当类似的结果。另外亦将具有1.8 M Transistors CMOS ASIC 芯片以SiGe BiCMOS制程制作,其产品特性完全不受影响,表示其制程整合良好,不影响CMOS特性,可具量产能力。
此外,SiGe HBT组件经过反向电压试炼(Stress),所造成劣化(Degradation)程度优于一般硅双载子晶体管,可部份归因于射基极接口之Ge元素有降低其接口间电场之作用,而有效改善组件可靠度。IBM亦同样证实组件在125℃环境温度下经过1mA/um2电流密度试炼下,其Mean-Time-to-Failure(MTTF)可超过1E7 hrs。
SiGe HBT/BiCMOS应用及市场
根据1998BCTM研讨会上,Daimler-Benz的Konig推测在2~30GHz操作频率范围内SiGe将可逐渐取代GaAs成为主要通讯IC制程技术;SiGe Microsystems公司如(图三)更明确指出SiGe技术应用频段范围,主要可分为三大应用范围:

| 《图三 SiGe HBT/BiCMOS在各个频段应用机会》 |
|
◆ Wireless Communications
◆ Navigation/aerospace
◆ Automotive Applications
另外还包括High-Speed A/D & D/A。不过由图三亦显示出三种技术(Si CMOS/Bipolar、SiGe HBT/BiCMOS、GaAs FET/HBT)彼此之间的消长,在5.0GHz频段范围以下,成本仅比Si技术高出10 %的SiGe技术,在Performance考虑之下应会被优先采用;而在较高频段(20GHz)以上,虽Performance逊于GaAs,但因其成本远低于GaAs技术,且具有高整合度,无疑地SiGe技术仍有其广大发展空间。
IBM从1994年以来不断有以SiGe HBT技术来设计的验证电路发表,举其要者整理如下(表二)。
从1998年10月,IBM首先推出第一颗商品化产品,到最近已有多家厂商陆续发表SiGe相关产品,如Atmel的PA(GSM)、DSP的RF chip(PDC)、Maxim的LNA/Mixer(GSM);尤其IBM更是与Alcatel、AMCC、Harris、Hughes Electronics、National Semiconductor、Nortel、Tektronix策略联盟,采取IBM’s SiGe HBT/BiCMOS技术技术来开发众多高速IC,分别应用在Wireless、Network、和Test-Instrument上。其相关产品特性规格型号整理成如(表三)所示。

| 《表三 发表SiGe HBT/BiCMOS产品型号/规格》 |
|
现阶段SiGe产品虽然种类不多、量亦少,但一般推测其未来将有很大发展空间,据Strategies Unlimited公司预估未来潜在市场,单SiGe RFICs可从去年US$15M快速成长到2005年的US$1.9B,约占RF ICs市场总值10%以上,极具市场潜力。
WW SiGe HBT/BiCMOS发展现况
至今全世界至少有30家厂商投入SiGe ICs制程与电路的研发,举其要者除了北美的IBM、AMCC、AMP、M/A-Com、Analog Devices、Harris、Hughes Electronics、Lucent、Maxim、Motorala、National Semiconductor、Nortel、SiGe Microsystem,还包括欧洲的Daimler-Benz AG(Temic)、Philips、Siemens、GEC Plessey、SGS-Thomoson和日本的Hitachi、NEC、NTT。
其中AMCC、AMP、M/A-Com、Analog Devices、Harris属设计公司与IBM策略联盟,利用IBM的制程技术共同开发高频/高速相关集成电路;而上面欧洲五家主要半导体厂则组成TIBIA协会(Technology Initiative in BiCMOS for Application),成立Esprit Project 8001计划来推动SiGe HBT技术开发,并已有优越成果,在1995年IEDM研讨会中发表多篇论文,于”Advanced Bipolar Device”章节中占了几乎一半的文章。
将这几年来各家所发表的SiGe HBT/BiCMOS技术整理成(图四),以其组件的截止频率(fT)作一参考指针,可发现HBT从一开始的30 GHz快速推展到目前130GHz,如果另外考虑BVceo需要达到目前一般操作电压3.2伏特的限制,则fT快接近100GHz可达90GHz左右,其可应用范围大幅提高,如上一节所述。在技术研发上最近有几个讯息值得注意:
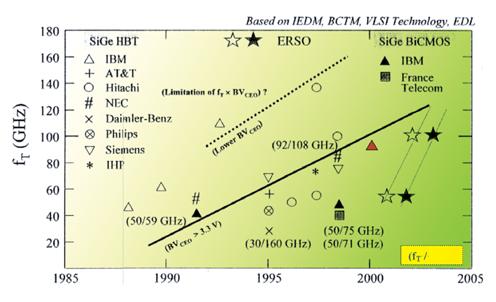
| 《图四 各家厂商SiGe HBT/BiCMOS技术发展趋势》 |
|
◆一.Motorala与IHP合作研发SiGeC技术:
去年5月通讯大厂Motorala与德国研究机构IHP(Institut fur Halbleiter Physik)合作开发SiGeC技术,将利用Motorala’s CMOS厂建立IHP’s SiGeC HBT技术和SiGeC BiCMOS技术,以开发下一代无线通信产品;所代表的意义有二,一为通讯大厂体认到SiGe技术应用于高阶但成本远低于GaAs产品的时代已来临,一为搀有C原子以提高SiGe薄膜稳定性及降低p型基极B原子扩散的SiGeC技术,已通过验证将达量产阶段。
◆二.高速SONET产品相继推出:
分别有IBM、Lucent、AMCC、Siemens推出,其中AMCC与IBM结盟利用IBM’s SiGe BiCMOS技术来设计,Siemens则开发其第七代高频双载子晶体管制程(SiGe:B7HF),来设计其高阶Gate-Array-Based Clock/Data Recovery Circuit;其代表的意义是SiGe技术不祇应用于RF ICs上,高速传输的接口ICs亦是一可大大发挥的应用领域,其速度可推到40Gbps以上。
以上讨论偏向厂商的发展,其实欧、美、日凡与微电子研究有关的主要大学/研究机构,几乎都有在从事SiGe这方面的研究,涵盖范围极广,举凡薄模成长(SiGe/SiGeC;MBE/RTCVD/UHV CVD)、组件开发(SiGe HBT/MODFET/MOSFET;Optoelectronics)、电路应用(RF ICs/OEICs/High Speed IC)。
SiGe/Si异质性接口结构除了在HBT应用上有快速进展外,另外在HFET、Optoelectonics亦不断有人研究,预期将开创新的应用领域。以下分别依其组件结构/特性、制程技术、研究机构作简要说明:
◆HFET(Heterojunction Field Effect Transistor):
分有MODFET和QW MOSFET两种结构,其间主要差别在于后者需要有类似Si-MOSFET的Gate Oxide,两者皆利用Si/SiGe/Si/SiGe等多层异质接口结构,以形成量子井(Quantum Well)提高载子传导速率,理论上在常温下可增加2~3倍,极适合在低压、高速系统应用;基本上QW MOSFET与CMOS制程比较匹配,祇另需要一高质量低温成长的氧化层,但目前实验结果特性尚不理想,MODFET组件倒有较好结果;在此领域已获具体成果的机构有IBM、Daimler-Benz、DRL/UCLA、Cavendish Lab.。
◆Optoelectonics Device:
同样也是利用Si/SiGe/Si/SiGe等多层异质接口结构,已开发出各式SiGe-Based光电组件,如Optical Wavequide、Electrooptic Modulator、Photodetector for 1.3~1.6 um、Optical Switches;主要研究机构包括Rome Lab.(AFRL)、DRL/UCLA、Cavendish Lab.
最后,以整合成Si-Based OEICs为理想,其中包含不少SiGe关键组件,英国剑桥大学的Cavendish Lab.描绘出未来篮图如下(图五)。
结语
SiGe技术经过这十几年的研究发展,最近几年来已渐渐开花结果,除了研发厂商家数逐渐增加外,也陆续有不少商品化产品推出,并且应用范围日益扩大,不祇应用的频率愈高、速度愈快,亦利用异质接口特性开发出光电组件,并朝OEICs领域迈进。
综观国内半导业界长久以来,在考虑市场需求下几乎集中于数字CMOS制程技术及相关ICs设计上,相对于高频/高速/模拟的就着力少了许多,造成无线通信蓬勃发展的今日在这方面的制程与设计却两者皆缺失的窘境,而且此情况在未来整合度要求越来越高的3C时代,将日益严重,亦即对高频/高速/模拟的制程与设计需求将日益殷切。
由于国际上SiGe技术目前正属急速发展阶段,国内之切入刻不容缓,以求得掌握关键技术并加以创新。过去工研院电子所三、四年来累积不少Si-Bipolar的研发经验,并于今年度首先建立SiGe薄膜磊晶量产机台,开始SiGe技术的研究与开发,包括有SiGe HBT、SiGe Photodetector、SiGe HFET;另外几个国内半导体大厂亦陆续宣布投入SiGe HBT技术开发,再加上国内学术界包括交大、台大多年来有关SiGe技术的基础研究,未来产、官、学三方面的密切结合,将可再为国内蓬勃发展的半导体业再开创另一新局。

