瀏覽人次:【34435】
無線通訊模組設計穩紮穩打
市場對於行動裝置在無線通訊和行動上網等應用需求越來越高,對於整合多樣無線通訊功能的模組設計也越來越重視。在行動裝置講究輕薄短小的設計趨勢下,無線通訊模組設計風潮持續穩紮穩打,如何繼續順應符合市場潮流,更成為系統廠商、模組製程封裝業者和半導體設計大廠不約而同關注的焦點。
行動元件模組化設計應用廣泛
環隆電氣工程總處資深處長王垂堂博士表示,模組化設計應用在手機領域經常出現,其方法也相當多元,從LCD、攝影鏡頭、處理器/基頻/數位訊號處理、內建記憶體、記憶卡、收發器和功率放大器、嵌入式天線以及各項無線通訊應用模組等。但射頻RF模組所牽涉技術問題較複雜,因此模組化設計腳步不若其他元件來得快。而RF SiP模組的市場驅動力在於整合更多元化功能、降低功耗提升電池效能、裝置尺寸輕薄短小、價格合理、效能提升等要求。
從全球技術發展趨勢來看,SiP可廣泛應用在醫療、航太、汽車電子、消費電子、電腦和通訊領域,套用市調機構TechSearch總裁E. Jan Vardaman的說法:「SiP雖然是個舊技術,但未來發展前景不可限量」!
《圖一 行動裝置高整合度無線模組應用趨勢示意圖 》
 資料來源:環隆電氣(USI)
|
SiP模組化設計方向與市場趨勢互為表裡
海華科技無線通訊研發處經理廖志豪博士則表示,無線通訊模組已成為各類行動裝置基本且重要的元件,一方面要能滿足行動裝置差異化多樣性的設計需求,一方面要提供支援各類無線聯網多功能應用,包括社群網路、瀏覽網頁、導航定位和LBS(Location-based Service)等,同時並兼顧行動裝置輕薄短小的尺寸規格需求。此外,無線通訊模組不僅要順應技術應用設計要求,並且也要掌握縮短上市時程。反過來看,行動裝置市場快速變遷的發展趨勢,亦進一步帶動無線通訊模組化的設計內容,無線通訊模組化設計也才能滿足行動裝置市場的需求。因此,無線通訊晶片系統封裝(Wireless SiP)會在這股趨勢下備受矚目,自然有大環境因素推動使然。
變化多端的SiP定義其實是常態
工研院電光所構裝組組長駱韋仲博士進一步表示,晶片系統封裝SiP的定義相當多元,不同技術材質也各擁有一片天,例如NXP對於SiP的定義就以晶圓級3D SiP技術平台為核心,以晶片製程內嵌電容元件。廣義的SiP應包含各不同象限應用領域的SiP架構,其中主要包括WLCSP、3D堆疊、LTCC、MCM、Embedded Passives等模組化技術和基板(substrate)材質。
《圖二 環隆電氣工程總處資深處長王垂堂博士表示,業者必須深知自己在SiP供應鏈的價值為何,並在供應鏈內與客戶維持健全的合作關係,取得有力的供應位置,才能獲得有利的價值》  |
海華科技研發處經理廖志豪則認為,在架構上和內容上,SiP可說是模組化的晶片(Module IC);晶片在基板多層系統整合的架構設計,以及SiP包含那些主被動元件的規劃,都是讓SiP呈現百花齊放樣貌的主要原因。環隆電氣資深處長王垂堂則指出,無線通訊模組功能會因為市場需求而不斷改變,因此SiP模組化設計便需要順勢調整,在IC設計、封裝還是基板材質等,經常多變且多元化的SiP模組化架構其實是常態。
《圖三 各種SiP封裝解決方案示意圖 》
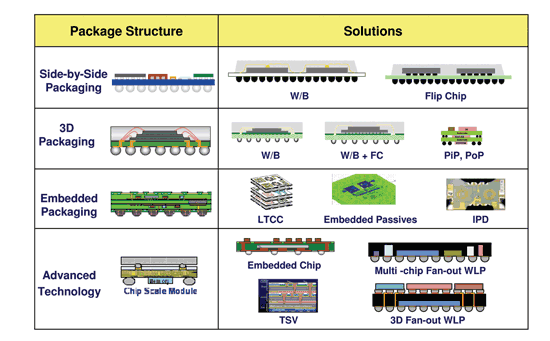 資料來源:環隆電氣(USI)
|
無線通訊SiP模組設計封裝考量重點
SiP需具備各領域整合能力
駱韋仲則說明指出,SiP基板技術應用涵蓋設計、製造和材料三大層面,複雜程度不可謂不低。廖志豪也認為,業者若要投入SiP模組化設計,需具備結合從設計到量產的先進封裝技術、以及擁有單一封裝的製程能力、並且掌握能夠符合行動裝置需求的解決方案。業者需具備IC設計、先進模組化製程、軟硬體系統整合、與量測廠商合作測試這四大整合能力,才能有效產出無線通訊模組化產品。
Module IC設計流程
廖志豪進一步深入說明指出,模組化晶片(Module IC)的設計流程大概包括以下幾項:
●產品定義:透過市場分析與掌握市場趨勢配合公司發展策略定義模組化產品;
●選擇方案:經由IC規格、設計方案、物料成本、市佔率預估、以及IC供應商合作關係等層面的整體規劃後,選擇最具市場競爭力的Module IC方案;
●定義規格:定義模組面積尺寸、介面、腳位、輸出/入電壓、整合元件數、基板材質等;
●電路設計(Schematic Design):這裡包括元件選擇、de-cap設計、電源拓墣設計、評估板EVB設計、除錯選項設計、RF並存設計等。值得注意的是,此時EVT流程要同時進行;
●繪圖設計(Layout Design):這包括需考量和模擬PI/SI、散熱模擬和規劃、訊號耦合(signal coupling)和訊號干擾、評估板EVB規劃、pin腳位置等;此時DVT流程應同時進行。
《圖四 Module IC設計流程示意圖 》  資料來源:海華科技(AzureWave) |
從定義規格到繪圖設計是需要不斷反覆的過程。當最後繪圖設計完成後,便可進入模組化設計的EVT、DVT、PVT和MP等標準流程。需要注意的是,模組化晶片在高整合度和微型尺寸之間並不容易兼得,因此不是要增加模組尺寸,就是要增加基板層數或是減少整合元件數,而腳位和設計彈性之間也往往需要權衡利弊。因此SiP模組化晶片設計流程需要與IC供應商維持緊密的合作關係以確保晶片效能。
《圖五 海華科技無線通訊研發處經理廖志豪博士表示,在架構上和內容上,SiP可說是模組化的晶片(Module IC),業者需具備IC設計、先進模組化製程、軟硬體系統整合、與量測廠商合作測試這四大整合能力》  |
產品設計架構考量重點
因此從先進模組設計相關參數架構的角度來看,王垂堂博士進一步強調,價格、效能和尺寸是無線通訊SiP產品首要考量重點,在經過產品規格定義(P-Spec)程序後,SiP模組化設計架構應該便包含晶片設計、基板和嵌入式內藏被動元件(Embedded Passives)、封裝整合、製程和測試方法學這四大參數要點。SiP模組化晶片設計要跟IC供應商維持密切關係在於,各家廠商在晶片封裝、電源管理、收發器效能都擁有各自專屬的know-how,功夫也不盡相同,同時在作業系統和驅動軟體支援上,需按照客戶不同的客製化需求。
《圖六 模組化晶片Module IC所需具備能力示意圖 》
 資料來源:海華科技(AzureWave)
|
無線通訊SiP模組開發挑戰
王垂堂並指出,散熱規劃和移除EMI干擾是無線模組SiP開發會面臨的兩大基本挑戰。SiP的散熱解決方案主要可以兩種熱流路徑來表示,其一是由晶片表面至環境之熱對流及輻射;其二是晶片由Bump及Underfill傳至基板,再傳至客戶端的PCB板,再經由基板及PCB板藉由輻射和對流傳至環境。熱流模擬與規劃對於SiP來說非常重要,因此熱流與環境關係的測試和模擬、例如散熱效能和風速關係,要從系統端的產品層次來考量。
《圖七 無線SiP散熱解決方案示意圖 》 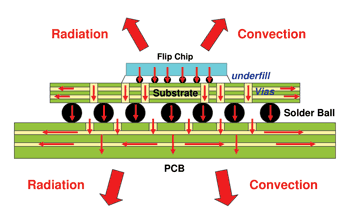 資料來源:環隆電氣(USI) |
無線通訊SiP模組化設計系統整合考量要點
SiP模組化設計的系統整合考量就包括EMI干擾、應力和性能等,王垂堂特別強調指出,各類無線通訊天線如何有效整合,就是Wireless SiP最主要的挑戰,這包括如何用最少天線達到最佳效能、提升頻率互不干擾的隔離度(isolation)、模擬測試有效發揮設計經驗值等等。這些在模組化設計階段就要一併與系統端客戶同時考量,並預先降低系統端客戶的疑慮。一般而言模組化設計下,天線互不干擾的隔離度標準最起碼要超過20dB,而消除EMI的方法有以下幾種可參考:
●Shielding
●Grounding
●Balancing
●Filtering
●Isolation
●Seperation & Orientation
●Circuit Impedance Level Control
●Cable Design
●Cancellation Technologies(Frequency or Time-Domain)
因此,模組化設計業者在射頻天線調校測試的能力與經驗就非常重要,與系統廠商彼此間的責任歸屬也要相當清楚。
《圖八 無線模組系統整合挑戰示意圖 》 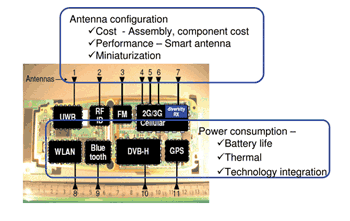 資料來源:環隆電氣(USI) |
此外,SiP模組化設計的系統整合還需注意以熱循環負載作用下測試評估模組元件的焊點可靠度(Solder Joint Reliability),包括模組尺寸、PCB厚度、被動元件尺寸、underfill等結構,分析在各種溫度散熱條件下的數據,來進一步預估SiP模組的疲勞壽命界線。再者,SiP系統整合還需一併考量SiP模組在回流(reflow)焊接過程中有無翹曲(warpage)現象,調整元件擺放位置和方式、選擇適合基板材質和構裝製程等,來降低翹曲和內殘留應力(internal residual stresses)。
無線通訊SiP模組化設計優勢
廖志豪進一步表示,在縮小面積、高整合度和大規模量產上,無線通訊模組化設計(Wireless Module IC)自有其優勢。Wireless Module IC on Board相較於Chip on Board的優勢在於,相同的無線模組設計可以應用在不同的行動裝置內,且無線模組能夠明顯縮短上市時程,以Wi-Fi整合藍牙模組設計為例,上市時程可以縮短大約3個月。更重要的是,設計上若有瑕疵,Chip on Board會導致整個PCB設計流程重新調整,進而加重研發成本及設計負擔;Chip on Board設計的PCB層數也增加,成本因此提高。
而Wireless Module IC on Board架構則是已經將相關射頻和XTAL元件模組化與周邊電路的效能調校過,無須大幅改變和重新調校,可降低研發設計負擔,並彈性因應提升良率的經常費用開支,不用昂貴的PCB製程。Module IC內的射頻RF元件效能在出貨前已經測試過,這可減少系統客戶在產品的測試成本和量測儀器設備的支出。
《圖九 工研院電光所構裝組組長駱韋仲博士表示,晶片系統封裝SiP的定義相當多元,不同技術材質也各擁有一片天,SiP基板技術應用涵蓋設計、製造和材料三大層面,複雜程度不可謂不低》  |
高速藍牙和WLAN已成無線SiP技術應用熱門
駱韋仲說明表示,現在SiP基板技術已經應用在許多層面。例如2.4GHz藍牙模組、GSM手機的PCB基板優化設計、功率放大器(PA)輸出設計、802.11a/b/g和802.11n WLAN模組等。工研院則利用SiP基板技術開發2.4GHz無線網路的功率放大器、藍牙模組、WLAN模組,以及5GHz無線網路的開關元件Switch、低噪放大器和功率放大器和WiMAX前端模組。廖志豪進一步認為,無線通訊SiP模組的新應用領域,可擴及到Android、高速Bluetooth3.0、Wi-Fi為基礎的SoftAP和AGPS等四大區塊。以高速藍牙3.0結合WLAN MAC/PHY和alternate MAC/PHY(AMP)技術為例,可利用802.11 PAL(Protocol Adaptation Layer)傳輸資料,因此傳輸速度相較於藍牙2.1+EDR版本快上10倍,高速藍牙3.0結合Wi-Fi的無線通訊模組化設計已經是各家大廠積極介入的熱門領域。
SiP基板封裝技術大要
SiP基板材質選項非常關鍵
王垂堂指出,SiP封裝架構會因為不同的商業模式,呈現百花齊放的面貌。基板材質對於SiP來說非常重要,因為其會影響整體封裝型態,同時基板材質也與內藏被動元件的整合度息息相關。目前以傳統的side-by-side封裝、整合射頻和記憶體應用為主的3D封裝、嵌入式封裝和其他先進封裝技術四大類為主。其中嵌入式封裝技術包含LTCC、Embedded Passives、IPD等,先進的封裝技術則包括TSV、3D Fan-out WLP、Multi-chip Fan-out WLP、Embedded chip等。
《圖十 工研院所開發的嵌入式IC內藏基板技術示意圖 》
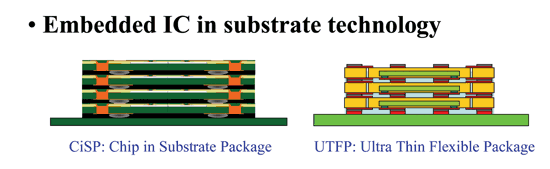 資料來源:工研院(ITRI)
|
廖志豪表示,LTCC的好處在於因為層數較多,可以內藏整合較多的元件數,LTCC也是Embedded Passives最大的競爭對手。不過LTCC成本較高,這也是Embedded Passives具備市場競爭力的關鍵。王垂堂進一步表示,Embedded Passives技術其實是從傳統的厚膜技術衍生出來的新技術,SiP架構能讓以往的技術有更多嶄新的發揮空間。駱韋仲則表示,雖然SiP基板技術的材料成本較高,不過製程成本卻能有效調降,因此整體SiP基板技術應用的成本與傳統設計相差不遠,而相關射頻品質也能有效展現。
不過RF晶片較不適合採取直接埋到基板內的技術,因為射頻RF晶片在進行訊號搜集時,容易受到熱流的干擾,天線的增益效果也較無法完整展現。因此駱韋仲指出,在設計上可採用2D-SiP或是3D-SiP技術的平面架構(planar structure),將數位訊號和RF訊號晶片以平面方式埋在同一顆封裝中。
Embedded Passives基板封裝技術
工研院目前在3D SiP技術內容包括將IC嵌入基板的CiSP(Chip in Substrate Package)和UTFP(Ultra Thin Flexible Package)技術,以及3D Interconnect by through Si技術。而針對行動裝置應用所設計的3D SiP,結合嵌入式內藏被動元件基板技術(Embedded Passives),可把被動元件薄膜材料直接整合於基板中,能提高無線SiP的射頻晶片品質。SiP基板技術中的電容和電阻材料就有許多大廠提供。但因為材料和其他因素,大電容和電阻元件若要能有效藉由SiP技術內藏於基板內,還有一些問題有待克服。
《圖十一 針對行動裝置應用,結合Embedded Passives技術所設計的3D SiP架構示意圖 》 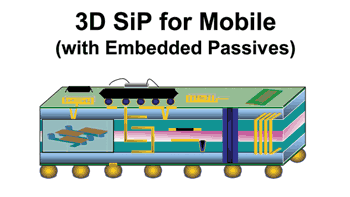 資料來源:工研院 |
離散被動元件多
Embedded Passives的重要性在於行動裝置內各種離散元件數越來越多,特別是在電阻、電感、電容三大被動元件部分。但市場對於行動裝置輕薄短小的設計要求也越來越高,以Nokia N90智慧型手機為例,其中的電阻(74)電感(16)電容(221)元件數,就佔整體被動元件數(323)的68.4%。
因此,大電容元件可藉由嵌入基板技術加以縮小尺寸空間。這個從晶片到封裝到PCB基板的共構設計(concurrent design)架構,更需要兼顧電氣、熱流、壓力等參數,Embedded Passives的基板組織架構分類也必須很清楚,才能夠有效利用空間。
能有效縮小元件空間
駱韋仲指出,工研院所開發的Embedded Passives模組化設計,以IEEE 802.11a/b/g 2.4/6GHz WLAN模組為例,可將內藏元件取代比例提高到50.4%(58/115),面積可縮小約19.7%。而WLAN三模雙頻無線網路CardBus adapter,則可藉由Embedded Passives技術,可減少44.3%的元件數。但有些電容和電感元件尚無法內藏於基板,這時需要將電容值調降至0.1~1μF之間,且電容和電感材料的整合也因為廠商之間不同的技術而相當複雜。
3D IC構裝流程要點
駱韋仲在介紹3D IC技術時表示,行動裝置的系統設計整合趨勢在於更小的微型尺寸、低功耗和低成本。以影像感測模組為例,若要設計出3D IC CIS模組,3D IC的矽通孔TSV(Through Silicon Vias)技術便非常重要,可滿足高頻寬和高密度I/O介面的微型化設計需求。3D IC系統設計需要搭配新的測試系統,IC設計、封裝、晶圓製程和測試之間的分工也需清楚。目前工研院已成立8吋和12吋晶圓的3D-IC實驗室,將3D-ID製程的黃光、蝕刻、薄膜、電鍍流程和電路設計等建立起來,整合工研院系統晶片科技中心在3D-IC的設計成果,並搭配相關封裝製程,可提供3D-IC較為完整的TSV技術架構。
《圖十二 工研院3D SiP平台架構示意圖 》
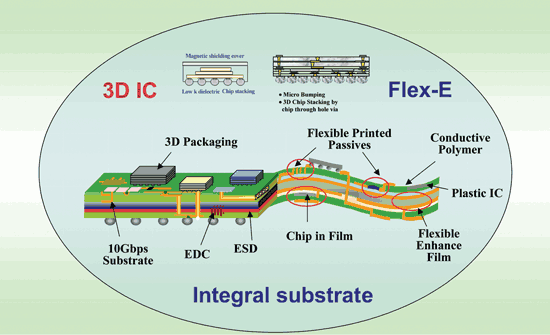 資料來源:工研院
|
SiP產業鏈整合度尚待克服
SiP模組化設計和流程需不斷因應市場變化多端的應用需求。在推廣上,如何進一步垂直整合IC設計、封裝和基板業者的相關技術,打破產業鏈既有分工的侷限,突破設計、製程、材料介面的技術挑戰,提升錯誤分析效率和可靠度,進一步整合歧異的SiP測試規格與設計規範,是目前亟需克服的難題。
王垂堂指出,一方面,SiP模組可提供半導體封裝廠不同於既有單顆封裝的獲利模式,封裝廠也可直接與系統廠商聯繫,而IC設計廠商則可直接提供軟體支援給系統廠商。不過另一方面,以嵌入式封裝為核心的的SiP產業鏈整合難度高,供應鏈條件也尚未成熟,廠商各有其技術上的堅持,藩籬與鴻溝必須進一步破除,SiP產業鏈才有辦法進一步整合。
王垂堂進一步深入指出,模組業者和IC設計廠商之間能否順暢合作,其實難度也不低,因為模組廠商和IC設計廠商的毛利結構也不相同,兩種商業模式混在一起,也不符合既有產業條件,因此IC設計業者和模組廠商的合作,從一開始就有現實的鴻溝有待突破。於是系統廠商有時會直接越過模組廠商,直接和無線通訊晶片設計大廠聯繫合作。
廖志豪則表示,現今無線通訊模組化設計能否持續發展,要看業者願不願意投入支援設計Andorid手機平台的藍牙模組,況且不同的晶片組供應商對於高速藍牙3.0功能的合作度還不夠,客戶也不是單單購買單一模組產品而已,還包括背後的各項軟硬體支援,相關解決方案的配套設計也會影響業者在無線模組化設計市場競爭力的強弱。王垂堂也認為,模組化IC整合度越高,外部元件就越少,這時軟體取代硬體在價值服務上的重要性也更凸顯出來。業者必須深知自己在SiP供應鏈的價值為何,並在供應鏈內與客戶維持健全的合作關係,取得有力的供應位置,才能獲得有利的價值。這也才能因應無線通訊模組功能不斷因市場需求變化、進而順勢調整的現實。
因此,模組廠商要進入相關SiP供應鏈找到適合的樞紐角色,對台灣發展SiP產業而言非常關鍵。而模組廠商本身也不易成為諸如SiP相關產業鏈的發動機,還是要靠系統品牌大廠或是具有專利龍頭地位的半導體業者帶頭方能成事。
|